《光电共封装(CPO)技术及市场-2026版》
2025-12-04 21:00:22 来源:麦姆斯咨询 评论:0 点击:
Co-Packaged Optics (CPO) 2026-2036: Technologies, Market, and Forecasts
光电共封装(CPO)的兴起
据麦姆斯咨询介绍,近些年,光收发器技术正稳步朝着将光器件更靠近专用集成电路(ASIC)芯片的方向发展。传统上,插入交换机前面板的可插拔模块位于印刷电路板(PCB)的边缘,长期以来一直是数据中心连接交换机和服务器的标准解决方案。它们凭借灵活性、易于更换以及扩展简单而广受欢迎;然而,它们面临着日益增长的挑战,特别是功耗不断上升,以及单位前面板面积可传输的带宽有限。
为了克服这些限制,业界开始将光学引擎迁移至更靠近交换机ASIC芯片的位置,以缩短用于电信号传输的铜线连接。尽管这些近封装光学(NPO)方案改善了电气性能,但它们仍偏离了成熟的可插拔生态系统,并且关键限制依然存在。因此,业内预计,这一转型将直接朝着“光电共封装”完全集成的解决方案推进。
英国知名研究公司IDTechEx在这份最新发布的报告中详细分析了这一转变,总览了光电共封装技术的最新进展,追踪了新兴的封装方法,评估了领先企业的战略,并提供了长期市场预测数据。本报告着重指出,未来十年光电共封装技术的采用将如何重塑数据中心基础设施。
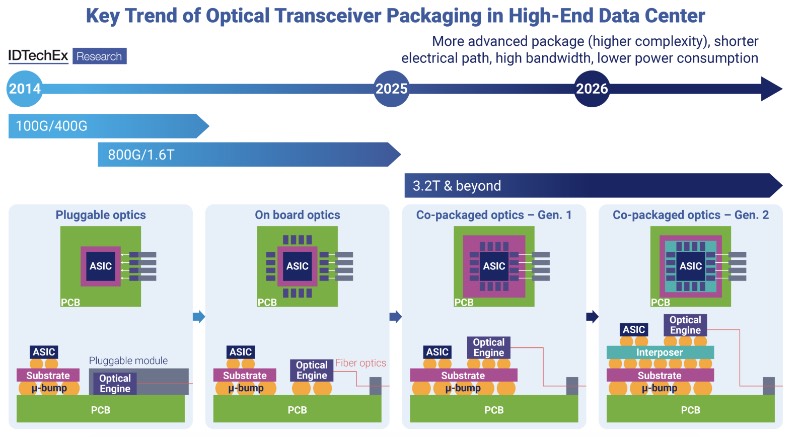
高端数据中心的光收发器封装技术主要趋势
先进半导体封装对于光电共封装的重要性
传统的可插拔光模块正日益受限于信号损耗、功耗及延迟,因为它们需要在交换机ASIC芯片和光引擎之间铺设较长的电线。光电共封装技术通过将光引擎放置在更靠近ASIC芯片的位置,克服了这些限制。其成功取决于先进的半导体封装技术,这些技术能够实现集成光路和集成电路的高密度集成,以及光引擎与交换机ASIC或XPU的无缝连接。这需要一系列先进封装方法,包括2.5D中介层、硅通孔(TSV)、扇出型晶圆级封装,以及最近兴起的由混合键合支持的3D集成。
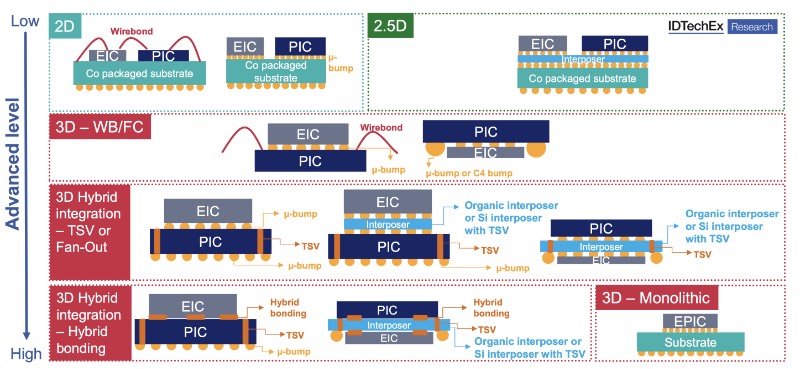
先进半导体封装技术
在2025年NVIDIA GTC大会上,英伟达推出了两款新的网络交换机平台——Spectrum X Photonics和Quantum X Photonics,两者均基于光电共封装技术打造。这些平台的核心是台积电(TSMC)的系统级集成芯片(SoIC)技术,该技术为英伟达的设计提供了3D集成架构。台积电的先进无凸点混合键合工艺SoIC X变体,能够以小于10微米的间距实现逻辑芯片和其它异构组件的垂直堆叠。这显著缩短了互连长度,降低了电阻和延迟。
包括博通(Broadcom)在内的其它主要厂商也采用了台积电的紧凑型通用光子引擎(Compact Universal Photonic Engine,COUPE)平台,凸显了3D集成和混合键合在光电共封装中日益增长的重要性。
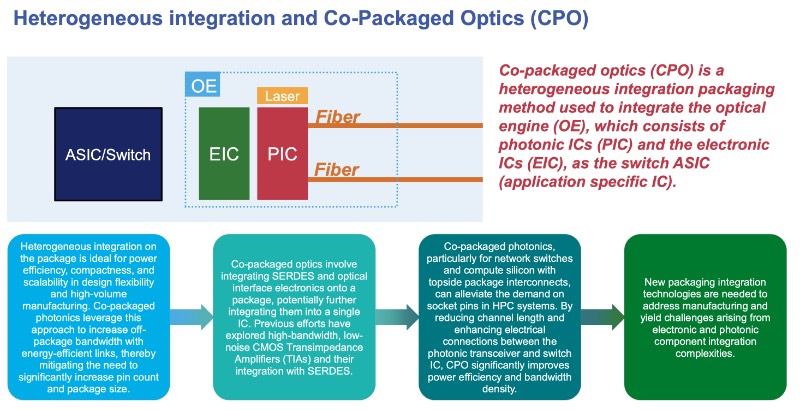
异质集成和光电共封装
光电共封装市场趋势
据IDTechEx预测,到2036年,光电共封装市场规模将超过200亿美元,2026年至2036年期间的复合年增长率(CAGR)将达到强劲的37%。基于光电共封装技术的网络交换机预计将在营收方面占据主导地位,每个交换机可能会集成多达16个光电共封装集成光路(PIC)。人工智能(AI)系统的光互连将占总体市场的约10%,每个人工智能加速器通常会使用一个光互连集成光路,以满足先进计算应用中对高速数据处理和通信日益增长的需求。

中短期AI架构预测
本报告对光电共封装技术的最新进展进行了广泛探讨,深入研究了光电共封装关键技术创新和封装趋势,并对整个价值链进行了全面分析。本报告还详细评估了业内主要厂商的动态,并提供了详尽的市场预测,展望了光电共封装应用将如何重塑未来数据中心架构的格局。
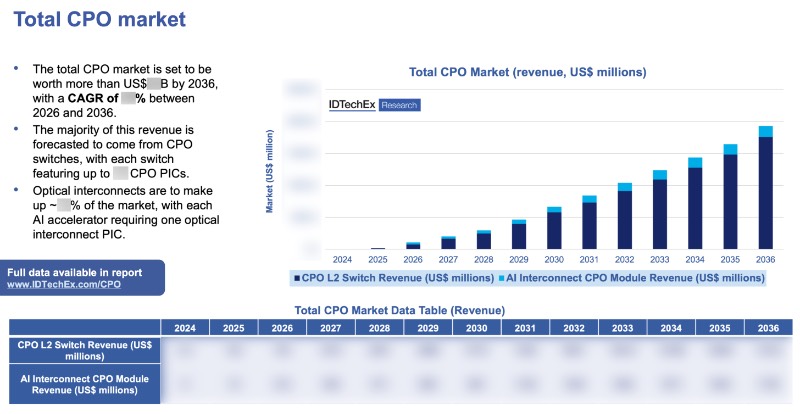
光电共封装市场预测
本报告将先进半导体封装视为光电共封装的基石。IDTechEx着重强调要理解各种半导体封装技术在光电共封装领域可能发挥的潜在作用。
如果您希望购买《光电共封装(CPO)技术及市场-2026版》报告,请联系麦姆斯咨询王懿,邮箱:wangyi#memsconsulting.com(#换成@);电话:17898818163。
上一篇:《先进封装产业现状-2025版》
下一篇:最后一页
