《先进半导体封装技术及市场-2022版》
2022-07-23 20:26:41 来源:麦姆斯咨询 评论:0 点击:
Advanced Semiconductor Packaging 2023-2033
购买该报告请联系:
麦姆斯咨询 王懿
电话:17898818163
电子邮箱:wangyi#memsconsulting.com(#换成@)

如果用一句话来形容我们的未来,那应该会是“以数据为核心”。
如今,几乎每个行业的所有层面都出现了数据爆炸式增长。每秒钟,我们的数字世界就会产生4,000 TB的数据,而这一数据量在未来即使不再大幅增长,总体趋势也不会改变。
机器学习(ML)和人工智能(AI)等产生大量数据的应用,是数据中心、5G、自动驾驶等关键领域的重要赋能者。要运行这些应用,需要功能强大的处理器,而其基础是基于硅的集成电路(IC)。
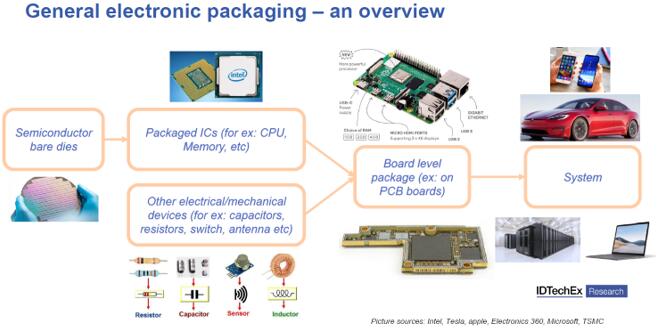
电子封装概览
几十年来,像英特尔这样的IC供应商致力于设计一种在同一颗芯片上集成所有功能的芯片,然而,随着业界共识的摩尔定律放缓(芯片密度不再每两年翻一番),扩展单片IC正变得越来越困难,成本也越来越高。这促使IC供应商走向“先进半导体封装”。
什么是先进半导体封装?

半导体封装技术概览
一般来说,半导体封装是制造半导体器件然后进行测试的最后两个步骤。以封装IC为例,在封装过程中,IC裸芯片被封装在带有电触点的支撑壳中。这样,外壳保护IC裸芯片免受物理伤害和腐蚀,并将IC连接到PCB板和其他设备。半导体封装已经存在了几十年,第一次大规模生产半导体封装是在20世纪70年代初。那么,该领域有哪些新趋势?
如前所述,由于摩尔定律的放缓和单片IC制造成本的显著增加,IC供应商需要新的方法来设计处理器,以实现高性能,同时保持成本效益。一种被称为“芯粒(chiplet)”的新设计是未来的重要趋势。
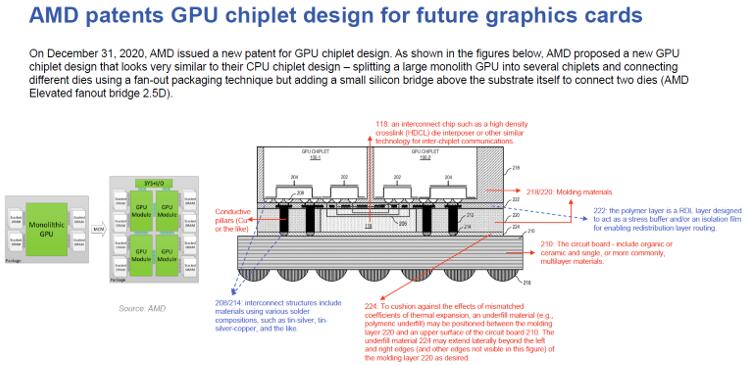
AMD未来显卡GPU芯粒(chiplet)设计专利
芯粒(chiplet)背后的理念是将单片IC“拆分”为多个功能块,再将功能块重组为单独的芯粒(chiplet),然后在封装级别“重新组装”。理想情况下,基于芯粒(chiplet)设计的处理器应具有与单片IC相同或更高的性能,但总生产成本较低。封装方法,特别是那些用于连接多个芯粒(chiplet)的方法,在芯粒(chiplet)设计中起着至关重要的作用,因为它将影响整个系统的性能。

英特尔Ponte Vecchio封装详解
包括2.5D IC、3D IC和高密度扇出晶圆级封装等封装技术,被归类为“先进半导体封装”,这些都是本报告研究的主题。它们可以在单个基板上的不同工艺节点合并多个芯粒(chiplet),它们具有较小的凸点尺寸,以实现更高的互连密度和更高的集成能力。
这份报告提供哪些有价值的内容?
据麦姆斯咨询介绍,英国知名研究公司IDTechEx在本报告中详细介绍了先进半导体封装技术的最新创新、关键技术趋势、价值链分析、主要厂商分析和细分市场预测。此外,报告还综合评估了整个半导体行业。
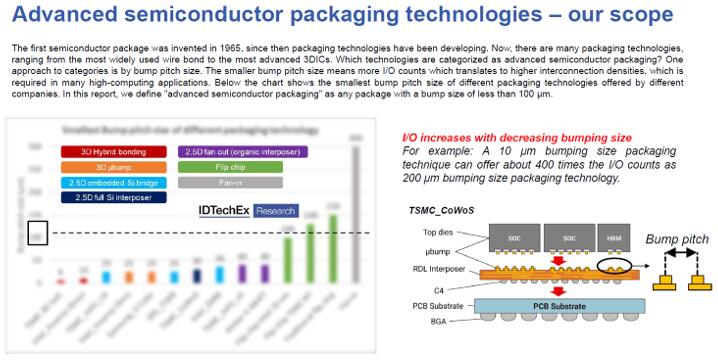
本报告研究的先进半导体封装技术(样刊模糊化)
先进半导体封装是下一代IC的关键基础,未来将主要面向四大关键市场:数据中心、5G、自动驾驶和消费电子产品。IDTechEx利用在这些领域积累的专业知识,通过本报告让读者全面了解先进半导体封装对这些领域的影响以及未来的发展趋势。
本报告包含的主要内容:
技术趋势和制造商分析
- 硅基IC产业详细概述,包括技术路线图和厂商动态;
- 半导体IC行业的供应链和商业模式分析;
- 各种半导体封装技术分析;
- 深入分析主要厂商的先进半导体封装技术,包括最先进的技术和未来的研究进展;
- 先进半导体封装关键市场的详细概述,包括高性能计算、自动驾驶、5G和消费电子产品;
- 通过大量案例研究,展示了先进半导体封装在各领域的应用。
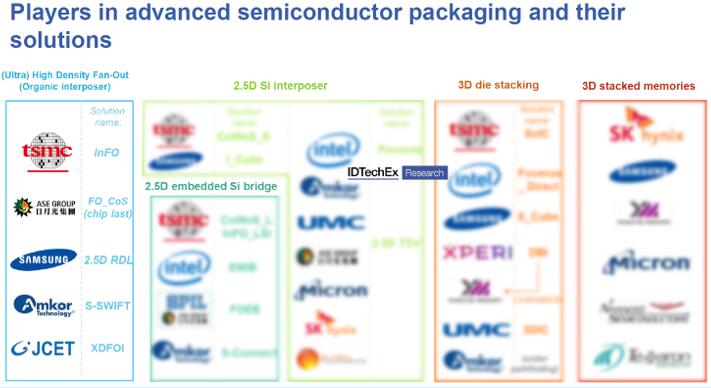
先进半导体封装厂商及其解决方案(样刊模糊化)
在本报告中,IDTechEx还考察了四个主要市场(数据中心、自动驾驶、5G、消费电子)中关键先进半导体封装技术(包括2.5D embedded Si、2.5 Si interposer、2.5D(超)高密度扇出以及3D芯片堆叠等)的市场扩展趋势。基于这些信息和研究,IDTechEx提供了未来十年期的细分市场预测和分析。
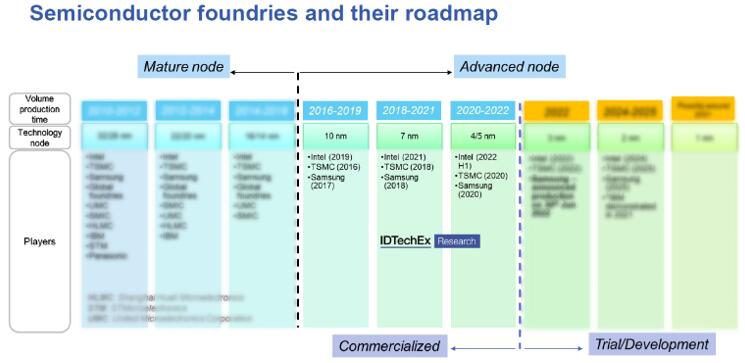
半导体封装厂及其路线图(样刊模糊化)
十年期先进半导体封装细分市场预测和分析
- 数据中心服务器领域:2022-2033年出货量预测
- 数据中心CPU领域:2022-2033年先进半导体封装出货量预测
- 数据中心加速器领域:2022-2033年先进半导体封装出货量预测
- 自动驾驶领域:2022-2045年2.5D先进半导体封装销售量预测
- 自动驾领域驶:2022-2045年3D先进半导体封装销售量预测
- 智能手机/平板电脑/智能手表/AR/VR/MR等消费电子领域:2022-2033年销售量预测
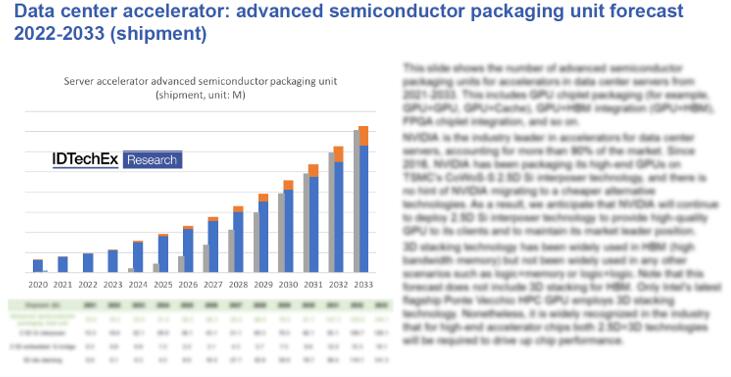
数据中心加速器:2022-2033年先进半导体封装出货量预测(样刊模糊化)
若需要《先进半导体封装技术及市场-2022版》报告样刊,请发E-mail:wangyi#memsconsulting.com(#换成@)。
上一篇:《气密封装市场-2016版》
下一篇:《先进半导体封装技术及市场-2023版》
