《先进半导体封装技术及市场-2023版》
2023-12-20 17:42:57 来源:麦姆斯咨询 评论:0 点击:
Advanced Semiconductor Packaging 2024-2034

探索先进半导体封装技术:2.5D和3D封装
半导体封装已经从1D PCB发展到晶圆级先进3D混合键合,实现了个位数微米互连间距和高能效1000 GB/s带宽。指引这一演变的四个关键参数包括:功率,优化效率;性能,提高带宽,缩短通信长度;面积,高性能计算芯片需要更大的空间,3D集成需要更小的元件高度;成本,通过材料替代和制造效率提升不断降低成本。

半导体封装技术发展路线图
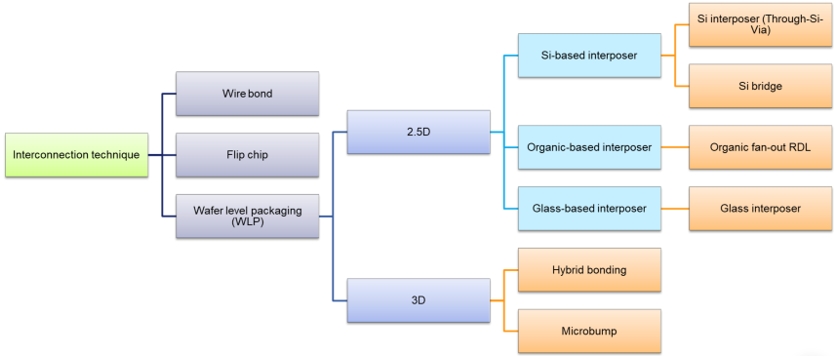
2.5D和3D封装技术
2.5D和3D封装包括了多种先进封装技术。在2.5D封装中,根据中介层材料的选择可将其分为硅基、有机基和玻璃基中介层,如上图所示。同时,在3D封装中,微凸块(microbump)技术的发展旨在实现更小的间距。如今通过采用混合键合技术(一种直接连接Cu-Cu的方法)实现了个位数微米互连间距,这标志着该领域的重大进步。
2.5D封装
硅基:此类别中有两种替代方案:(1)硅中介层,利用全无源硅晶圆;(2)硅桥,在扇出模塑料中或具有空腔的衬底中采取局部硅桥的形式。硅中介层通常用于高性能计算集成的2.5D封装,与有机材料等替代品相比,它在材料和制造方面都面临着成本方面的挑战,以及封装面积的限制。为了解决这一问题,局部硅桥的形式越来越受到重视,在超细间距至关重要的应用中战略性地利用硅。硅桥结构的应用预计将会进一步提高,特别是硅中介层面临面积限制的情况。

2.5D硅基封装解决方案示例(样刊模糊化)
有机基:在本报告中,IDTechEx考量了使用扇出模塑料而不是有机衬底的有机封装。有机材料能够将其介电常数调整到低于硅,有助于降低封装中的RC延迟。此外,这些材料是相比硅更具成本效益的替代品。这些优势推动了有机基2.5D封装的兴起。然而,其关键缺点在于实现与硅基封装相同水平精细互连所面临的挑战,这限制了其在高性能计算中的应用。

2.5D封装技术发展趋势
玻璃基:今年早些时候,芯片制造商英特尔公司宣布,在用于下一代先进封装的玻璃基板开发方面取得重大突破,由此,基于玻璃的方案引起了人们的极大兴趣。玻璃具有很多有利的特性,包括可调的热膨胀系数(CTE)、高尺寸稳定性和光滑平坦的表面等。这些特性使玻璃成为一种很有前途的中介层候选材料,其布线特性有可能与硅相媲美。然而,玻璃的主要缺点在于其生态系统不成熟,封装行业目前缺乏大批量生产能力。尽管如此,随着生态系统的成熟和生产能力的提高,玻璃基技术在半导体封装中的应用有望在未来进一步增长。
3D封装
微凸块:基于热压键合(TCB)工艺的成熟微凸块技术,已经在各种产品中拥有长期应用。其技术路线图包括不断缩小的凸块间距。然而,一个关键挑战出现了,因为在这个过程中较小的焊球尺寸会导致金属间化合物(IMC)形成、导电性和机械性能降低。此外,紧密的接点间隙可能导致焊球桥接,在回流焊期间存在芯片故障的风险。由于焊料和IMC表现出比铜更高的电阻率,因而其在高性能组件封装中的应用面临限制。
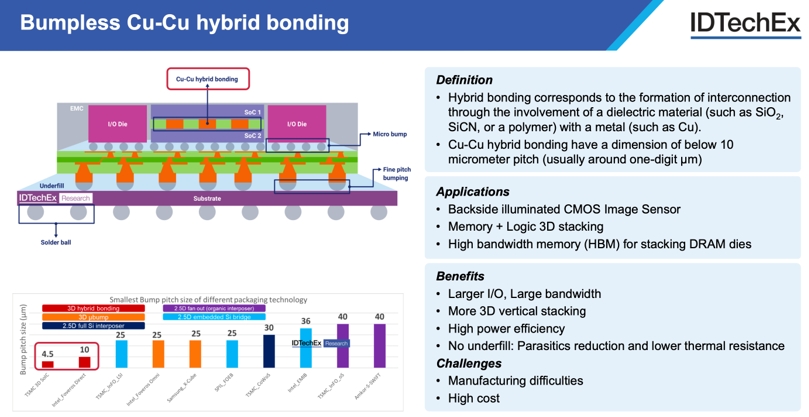
无凸块Cu-Cu混合键合
混合键合:混合键合包括通过将介电材料(SiO2)与嵌入金属(Cu)结合来构建永久互连。由于Cu-Cu混合键合的间距低于10微米(通常约为个位数),其优点包括扩展的I/O、增加的带宽、增强的3D垂直堆叠、提高的功率效率以及由于没有底部填充而减少的寄生和热阻。其挑战包括与这种先进技术相关的制造复杂性以及更高的成本。
本报告覆盖的关键内容:
据麦姆斯咨询介绍,英国知名研究公司IDTechEx在本报告中深入探讨了半导体封装技术的最新创新、关键技术趋势、价值链、主要厂商,并提供了详细的市场预测。
先进半导体封装是下一代集成电路的关键基础,IDTechEx在本报告中重点研究了其在人工智能和数据中心、5G、自动驾驶以及消费电子等关键领域的应用。IDTechEx利用在这些领域积累的专业知识,通过本报告让读者全面了解先进半导体封装对这些领域的影响以及未来的发展趋势。
先进半导体封装技术趋势和主要制造商:
- 探索先进半导体封装发展趋势,应对晶体管IC挑战。
- 芯粒概念和异构集成如何推动先进封装应用。
- 封装技术分析:按中介层材料(硅基、玻璃基、有机基)细分,涵盖路线图、对比分析、应用、制造商和制造挑战。
- 厂商分析:深入调研关键厂商,评估其解决方案、客户、应用和技术路线图。
- 关键市场:提供关键市场详细概述,包括高性能计算、自动驾驶、5G和消费电子产品。
- 案例研究:展示先进半导体封装的各种行业应用。
- 供应链与模型:在不断发展的市场环境中分析供应链动态和商业模式。
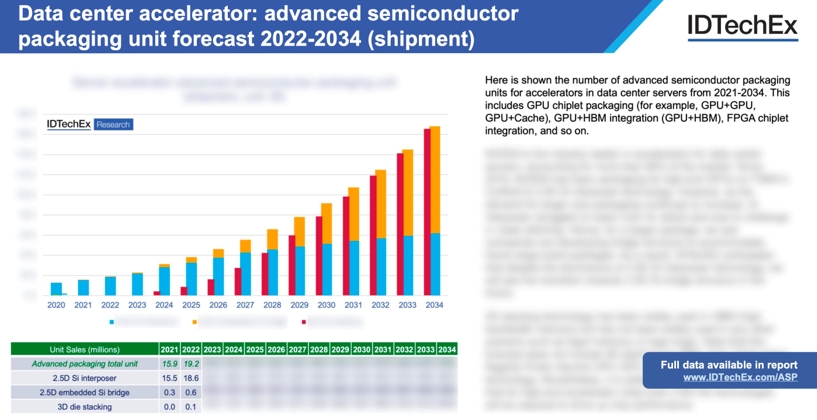
数据中心加速器领域:2023-2034年先进半导体封装出货量预测(样刊模糊化)
10年期先进半导体封装细分市场预测和分析:
- 数据中心服务器领域:2023-2034年先进半导体封装出货量预测
- 数据中心CPU领域:2023-2034年先进半导体封装出货量预测
- 数据中心加速器领域:2023-2034年先进半导体封装出货量预测
- 自动驾驶(L4+):2023-2045年2.5D先进半导体封装销售量预测
- 自动驾领(L4+):2023-2045年3D先进半导体封装销售量预测
- 智能手机/平板电脑/智能手表/AR/VR/MR等消费电子领域:2023-2034年销售量预测
- 全球PC出货量预测,2023-2034年PC中先进半导体封装预测
- 2023-2034年5G RAN网络先进半导体封装预测
若需要《先进半导体封装技术及市场-2023版》报告样刊,请联系麦姆斯咨询王懿,邮箱:wangyi#memsconsulting.com(#换成@);电话:17898818163。
