《先进封装聚合物材料-2025版》
2025-11-16 09:52:28 来源:麦姆斯咨询 评论:0 点击:
Polymeric Materials for Advanced Packaging 2025
生成式人工智能(AI)以及不含全氟和多氟化合物(PFAS)的创新,正在推动先进封装聚合物材料的发展。
先进封装聚合物材料市场规模在2024年达到16亿美元,预计2024-2030年期间的复合年增长率可达13%
汽车高级驾驶辅助系统(ADAS)、高性能计算(HPC)、生成式AI、增强现实/虚拟现实(AR/VR)、移动及边缘AI以及物联网(IoT)等半导体行业大趋势正在重塑先进封装,对高性能器件持续提出更苛刻的材料要求。
介电材料、模塑料、底部填充料和临时键合材料等先进封装聚合物材料在2024年的市场规模接近16亿美元,预计未来五年内将增长至约33亿美元,复合年增长率(CAGR)可达13.2%。移动及消费电子领域在出货量和营收规模方面均引领市场,但电信和基础设施领域增长最快,这主要得益于高性能计算和生成式AI的高性能封装。系统级封装(SiP)仍然是聚合物材料的主导平台,而2.5D和3D封装是增长最快的细分市场,在2024-2030年期间,其出货量的复合年增长率预计将达35%,营收复合年增长率将达28%。
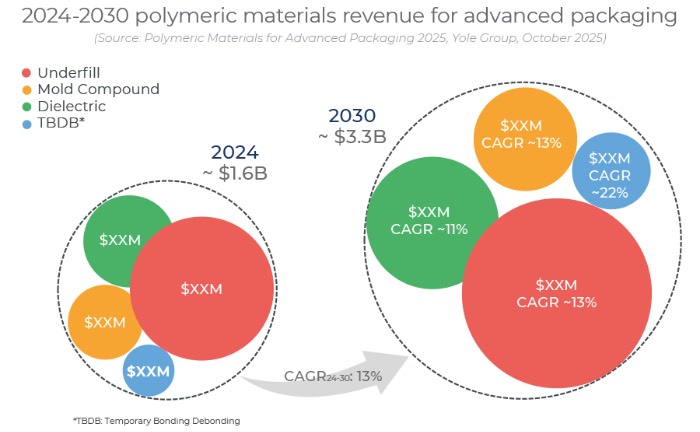
2024~2030年先进封装聚合物材料市场营收预测
先进聚合物材料实现更细间距、更高可靠性和可持续封装
数据中心AI浪潮正在重塑半导体和先进封装技术,推动行业对更高算力、更快I/O、更高功率效率以及更优热管理的追求。封装材料现在必须具备更好的机械性能和更高的可靠性,同时还要具备优异的热导率、热稳定性,以及与更大芯片/芯粒的兼容性,以实现更严格的应力/翘曲控制、更精细的光刻图案化以及更密集的互连(通过RDL、中介层和混合键合)。
聚酰亚胺(PI)、聚对苯撑苯并二噁唑(PBO)、苯并环丁烯(BCB)、环氧树脂和丙烯酸树脂复合体系、热塑性聚合物等关键材料被广泛应用于先进封装,作为介电材料、模塑料、底部填充材料和临时键合材料。这些材料面临的核心挑战包括降低热膨胀系数(CTE)失配,因为聚合物比硅的膨胀率大得多,易产生应力、翘曲和缺陷。
然而,由于没有单一配方能满足所有目标,有效的解决方案包括针对每个客户和封装架构的特定应用定制化配方,以平衡性能的权衡。

先进封装对聚合物材料提出的要求
全球领导者、细分领域专业厂商以及不含PFAS的创新浪潮
先进封装聚合物材料市场具有多元化但又集中化的供应链,全球前五大厂商(Resonac、Henkel、Panasonic、Sumitomo和HD Microsystems)合计占据了50%以上的市场份额。
尽管先进封装聚合物材料供应商众多,但市场仍由日本主导,日本厂商在电介质材料、模塑料、底部填充料和临时键合解决方案等领域共占约80%的全球营收。德国紧随其后,市场份额约为10%,主要受Henkel推动。而美国约占5%,由3M(临时键合)和Qnity(杜邦旗下,介电材料)引领。中国约占4%,主要依托华海诚科在模塑料领域和化讯半导体在临时键合材料领域的支撑。
在所有细分市场中,供应商都在调整产品组合,以顺应AI/高性能计算驱动的封装需求,同时满足不含PFAS材料的要求。聚合物材料、器件和封装供应商的跨界协作,对于推动先进半导体封装领域的创新至关重要。

先进封装聚合物材料生态系统
如果您希望购买《先进封装聚合物材料-2025版》报告,请联系麦姆斯咨询王懿,邮箱:wangyi#memsconsulting.com(#换成@);电话:17898818163。
上一篇:《半导体中的玻璃应用、技术及市场-2026版》
下一篇:最后一页
