AlN压电MEMS器件噪声的建模与测量
2026-02-01 21:01:27 来源:麦姆斯咨询 评论:0 点击:
微机电系统(MEMS)是一种在微尺度上将机械域与电气域集成的多功能技术平台。其中,压电MEMS(piezo-MEMS)因其固有的高灵敏度和高能效特性而日益受到关注。这些特性使得压电MEMS非常适用于下一代精密传感、执行以及信号转换等应用,覆盖多种新兴技术领域。然而,这类MEMS器件的性能往往受到噪声存在的限制,噪声会掩盖微弱信号并降低测量精度。因此,深入理解压电MEMS结构中的本征噪声机制至关重要,因为噪声在传感器与执行器发展中起着关键作用。
据麦姆斯咨询报道,近日,维也纳工业大学(TU Wien)和加州理工学院(California Institute of Technology)的研究人员组成的团队采用实验与建模相结合的方法,对氮化铝(AlN)压电MEMS器件的噪声特性进行了系统而全面的研究。通过详细分析,将器件的总噪声分解为多个噪声源,包括压电层中的热噪声、放大器的输入电压噪声、放大器的输入电流噪声,以及放大器中偏置电阻的热噪声。噪声谱密度测量覆盖了从数Hz到1 MHz的频率范围,在低频区域,呈现出显著的1/f特性,此时放大器相关的噪声源占主导地位。研究人员所提出的电噪声建模框架能够准确再现实验测量结果,验证了其在捕获整个工作带宽的噪声贡献方面的有效性。此外,温度依赖的测量结果表明,当器件从300 K冷却至80 K时,AlN压电层的电容降低约3%,损耗角正切(loss tangent)降低约75%,并与器件热噪声的相应减小相一致。
上述研究结果为压电MEMS器件在低噪声应用中的优化提供了重要参考,尤其适用于低温环境,同时也为新一代高灵敏度MEMS/NEMS传感器与执行器的设计提供了有价值的指导。相关论文以“Modeling and Measurement of Noise in Aluminium Nitride Piezoelectric MEMS”为题发表于Advanced Electronic Materials期刊。
图1展示了论文中所研究的压电MEMS结构的主要制备工艺流程。所采用的衬底为绝缘体上硅(SOI)晶圆,其埋氧层(BOX)厚度为500 nm,器件层厚度为2 µm。压电层采用直流磁控溅射沉积而成,使用6英寸铝靶制备厚度为400 nm的AlN薄膜。最终形成的压电薄板结构如图1h所示。
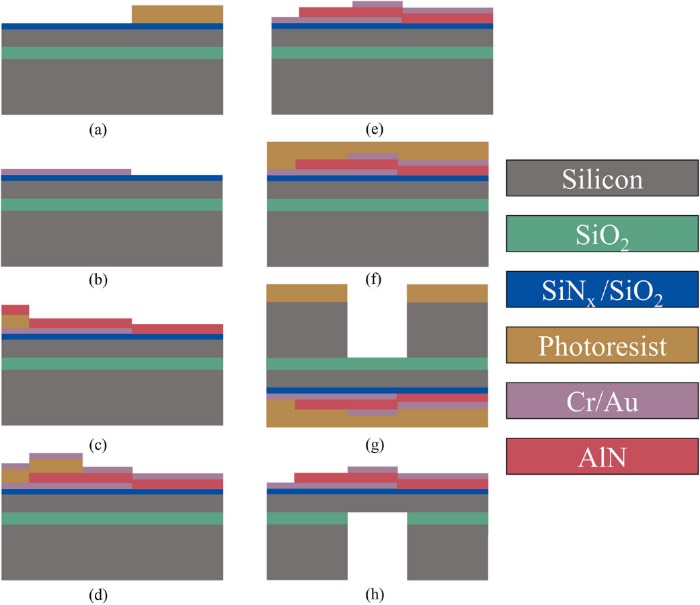
图1 压电MEMS结构的制备工艺流程
该压电MEMS结构由两个电极及其间的压电薄膜材料组成,其阻抗行为与电容器相似。在这一背景下,电阻率(Rp)、电容(Cp)以及介电损耗(tan δ)是噪声分析中特别关注的参数。被测器件(DUT)的电学表征采用阻抗分析仪(Keysight E4990A)完成,其连接方式的示意图如图2a所示。
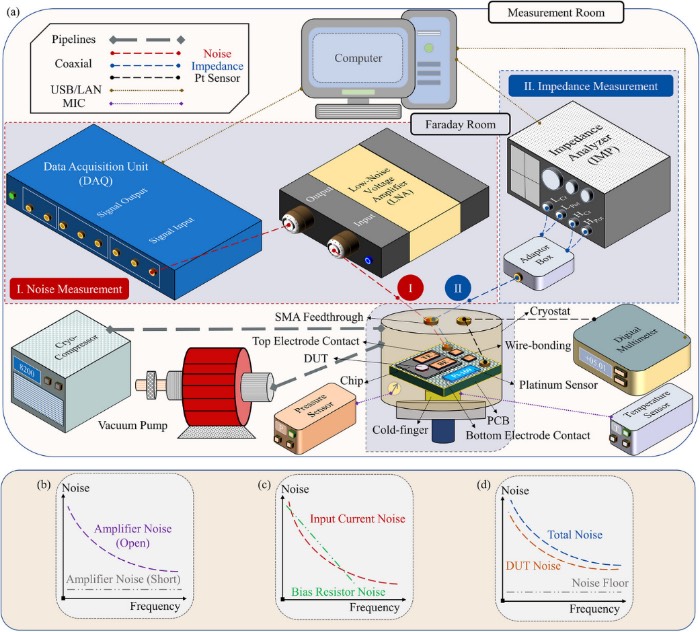
图2 噪声和阻抗测量实验设置的示意图
所研究的压电MEMS结构具有较高的阻抗,并且输出信号较小,因此需要信号调节电路与数据采集(DAQ)单元进行适当的接口连接。鉴于该结构的电容约为数百皮法(pF),实验中采用低噪声放大器(Sierra Amps,SA-1)对噪声信号进行放大。如图3所示,实验设置分布在两个独立的房间内:一间为测量室,放置常规测试仪器;另一间为法拉第室,专门用于抑制外部噪声源。
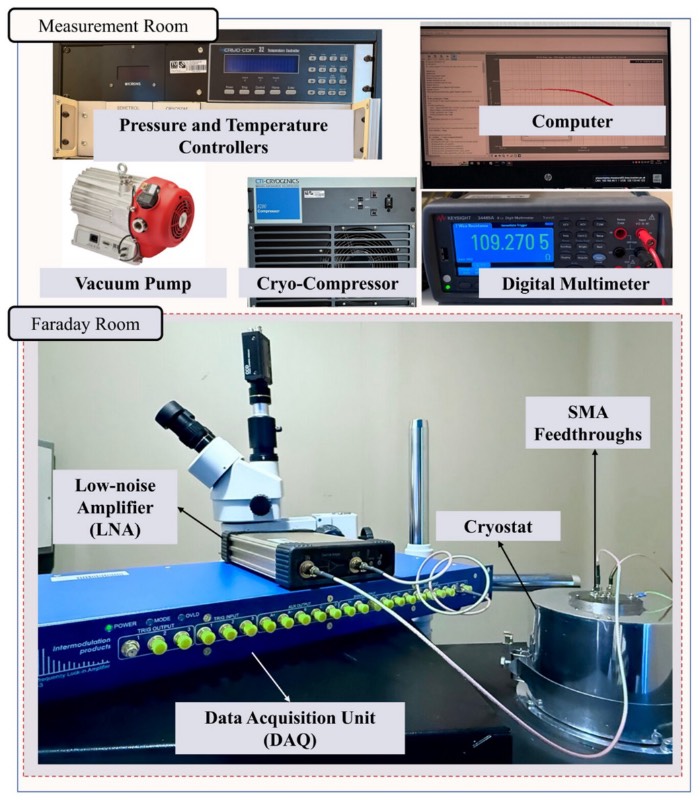
图3 压电MEMS结构噪声测量的实验设置
研究团队对噪声建模进行了系统而全面的分析,以研究压电MEMS器件中与低噪声放大器接口的等效噪声源。为便于深入理解,引入了等效噪声电路,其中包含了实验设置中存在的各类噪声源。随后,基于相应的方程对不同噪声贡献进行分析,具体包括:压电MEMS的热噪声、输入电压噪声、偏置电阻的热噪声,以及输入电流噪声。该建模框架以示意形式呈现了本研究中使用的测量配置相关的噪声源。基于所提出的噪声建模方法可计算系统的总噪声,详细公式推导参考原论文。
研究人员对所制备的压电MEMS结构进行了详细分析,并对用于噪声测量与建模的被测器件开展了机械、结构及电学特性表征。如图4a所示,所制备的压电MEMS芯片尺寸为6 × 6 mm²,采用层叠式结构:在硅衬底上构建绝缘SiNₓ/SiO₂层,其上沉积Cr/Au顶/底电极,中间夹层为压电AlN层。
将压电MEMS芯片置于低温恒温器(cryostat)中,进行温度依赖的阻抗测量。所测得的DUT电学响应如图4b所示,展示了300 K和80 K条件下,频率范围为0.1 kHz至1 MHz的绝对阻抗和相位角,温度通过Pt-100传感器记录。图4c展示了DUT在300 K和80 K下的频率依赖电容和损耗角正切。将样品从300 K冷却至80 K,可使DUT电容下降约3%,损耗角正切下降约75%。

图4 所制备的压电MEMS结构的表征
DUT的噪声测量与建模结果分为两部分进行呈现,分别关注室温条件和低温条件。
图5a展示了各独立噪声源的噪声谱密度,并将测得的系统总噪声与通过建模方法计算的噪声响应进行了对比。系统测得的总噪声呈现出明显的1/f特性。

图5 DUT在(a)室温(T=300 K)和(b)低温(T=80 K)下的实测噪声谱密度和建模噪声谱密度的比较
图5b展示了当DUT冷却至80 K而低噪声放大器保持在室温时,各噪声源的噪声谱密度。结果表明,与300 K条件相比,与低噪声放大器相关的噪声贡献——包括输入电压噪声、输入电流噪声以及偏置电阻的热噪声——保持不变。然而,由于温度下降,DUT的热噪声显著降低。
综上所述,这项研究将室温与低温条件下的低噪声实验测量与噪声建模框架相结合,分析了基于AlN的压电MEMS器件的噪声行为。实验结果表明,在低温环境中,DUT的热噪声可得到显著抑制,从而使整体噪声水平得到可观的改善,尤其是在低频区域。所提出的建模框架能够将实测噪声分解为不同的噪声源,包括偏置电阻的热噪声、放大器的电压噪声与电流噪声,以及DUT的热噪声,从而清晰识别各频段的主导机制。实测总噪声与模型预测结果之间的高度一致性验证了等效电路模型的准确性,同时也凸显了系统阻抗在塑造噪声贡献的频率依赖性方面的关键作用。总体而言,本研究为MEMS低温传感器的优化提供了一条具有实验支撑的可行路径。通过在材料质量、封装寄生效应以及放大器集成等方面的进一步改进,有望在检测灵敏度方面获得更大的提升。
论文链接:https://doi.org/10.1002/aelm.202500476
延伸阅读:
上一篇:基于PMN-PT的柔性超声换能器阵列,用于无袖带血压监测
下一篇:最后一页
