三星叫板台积电,FOPLP对擂FOWLP,扇出型封装平台谁主沉浮?
2018-10-28 14:47:51 来源:麦姆斯咨询 评论:0 点击:
据麦姆斯咨询报道,为降低成本,半导体行业一直致力于开发创新型解决方案。目前领先半导体厂商考虑的方案之一是通过晶圆和条带级向更大尺寸的面板级转换,充分利用规模经济和效率的优势。
从FOWLP(扇出型晶圆级封装)的扇出型封装(fan-out package)向大尺寸的FOPLP(扇出型板级封装)转变,FOPLP成为众多半导体厂商广泛采用的解决方案。预计2018~2023年期间,FOWLP市场以20%的复合年增长率获得显著增长,到2023年其市场规模将达到约23亿美元。不过,经过多年的发展,FOPLP技术已投入商用,可能对FOWLP构成严重威胁。据Yole今年发布的报告《板级封装(PLP)技术及市场趋势-2018版》,FOPLP的许多参与者有望在2018年或2019年实现量产。
其中,SEMCO(三星电机)来势汹汹!这家全球领先公司在过去两年中投资超过4亿美元,并开始为其新款可穿戴产品——集成应用处理器环境(APE)的三星智能手表Galaxy Watch提供封装技术。凭借这一战略性技术选择,SEMCO直接瞄准的是台积电在高密度扇出型封装领域的领导地位,并积极为FOPLP技术制定开发路线图。借高密度FOPLP的首次亮相,SEMCO拉响了扇出型封装平台战斗的号角!
根据《板级封装(PLP)技术及市场趋势-2018版》,FOPLP是增长最快的封装平台之一。预计2017~2023年间,FOPLP市场将呈现出令人瞩目的增长,复合年增长率高达79%,到2023年市场规模将增长到 2.79亿美元。
显然,迎接台积电和三星两大巨人展开战斗的先进扇出型封装竞技场已经准备就绪!

主要厂商对扇出型板级封装的准备情况时间轴
智能手机行业是造成竞争格局的“无情”因素。技术的选择和战略的制定是决定封装行业领导力是否得以延续的关键。
三星正在基于自有封装技术生产自主开发的处理器,该战略允许三星控制着从芯片到终端产品的整条供应链。然而,像苹果这样的竞争对手选择了将处理器的生产全部外包给主要合作伙伴的战略。两年前,苹果决定采用台积电发布的InFO(集成扇出型封装)技术。InFO基于FOWLP技术,将扇出型封装引入消费电子市场,明确宣布了封装行业新时代的开启。

2017年先进封装产品提供方式(按业务模式细分)
数据来源:《先进封装产业现状-2018版》
智能手表市场对尺寸和集成度的要求极为苛刻,需要封装技术提供特殊“服务”。为了获得更大的电池空间,随着对小尺寸和超薄Z轴高度的封装需求增长,SEMCO采用了新开发的基于FOPLP技术的解决方案,与台积电的InFO方案“同台竞技”。时机非常完美——FOPLP技术首次渗透到消费电子市场。
使用这项技术,三星的智能手表Galaxy Watch将PMIC(电源管理集成电路)、移动应用处理器和DRAM封装在一起,称为SiP -ePoP。PMIC和APE并排放置在嵌入式结构中,实现了封装顶部/底部连接。这种方法可以大大降低封装成本。除了成本优势之外,SEMCO将线宽竭力降低到10μm,与台积电的InFO技术相当。
随着FOPLP技术在智能手表中的应用,显然,三星正在消费电子领域充当战略制定者的角色。除了智能手表,移动市场很快就会感受到FOPLP技术带来的好处。这一战略定位是三星与台积电就先进封装领域展开竞争的一部分。根据Yole 发布的《先进封装产业现状-2018版》,这两家公司分别已提供大约1800万片晶圆和2300万片晶圆的封装产品出货。
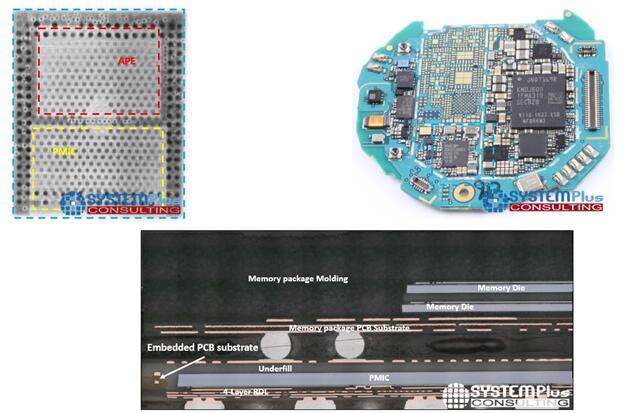
来源:《Exynos 9110:三星第一代扇出型板级封装(FO-PLP)》
或许有人会问在这场战斗中,OSAT能分得多少羹?OSAT将采取什么策略来应对?台湾力成(Power Tech International)最近宣布将在FOPLP领域投资15亿美元,这表明竞争尚未结束,未来几个月里先进封装领域的竞争将继续上演。
延伸阅读:
《先进基板技术及市场现状-2018版:嵌入式芯片和互联、基板式PCB趋势》
《三星Galaxy S9 Plus处理器封装:三星iPoP vs. 高通和新光MCeP》
上一篇:耐威科技:瑞典Silex团队到访北京,交流8寸MEMS代工线情况
下一篇:华天科技加码昆山,投资20亿建高端汽车电子封装线
