300毫米晶圆、1微米间距的晶圆间混合键合首次亮相
2017-11-16 14:31:45 来源:麦姆斯咨询 评论:0 点击:
据麦姆斯咨询报道,EV集团(简称:EVG)与Leti合作率先实现全球300mm晶圆间的混合键合,间距达1µm。这一突破也使得500nm铜垫(Cu Pad)变为现实。EVG为MEMS、纳米技术及半导体市场的晶圆键合和光刻设备的供应商,Leti则为CEA Tech的技术研究所。
此次展示在Leti的洁净室中进行,使用EVG全自动的GEMINI FB XT熔合晶圆键合系统来演示铜/氧化物混合键合的过程,该工艺是3D高密度集成电路(IC)应用成功的关键因素。此成果来自于Leti领导的IRT Nanoelec硅光子项目的技术框架。EVG于2016年2月加入Leti的3D集成联盟。
晶圆键合是3D器件堆叠的关键工艺
半导体器件的垂直堆叠已日益可行成为一种提高器件密度和持续改进性能的方法。晶圆键合是实现3D堆叠器件的关键工艺。然而,实现互连器件间良好的电气接触以及减少键合界面的互连面积,都需要晶圆间的精确对准及套刻精度,以便在晶圆上制造器件留出更多空间。间距的不断缩小有利于元器件按摩尔定律路线图发展,并促进对晶圆键合规范更严苛的新一代产品。
成果展示
在Leti的展示中,上下两片300mm晶圆可在GEMINI FB XT的自动熔合键合系统中直接键合,该系统结合了EVG专利SmartView NT面对面光刻机和对准校验模块,以实现现场键合后的红外定位测量(IR alignment measurement)。该系统实现了195nm(3 sigma)范围内的套刻对位精度,平均对准误差小于±15nm。对300mm键合晶圆堆叠和特定芯片采用后烘工艺,再使用声学扫描显微镜进行检测,确认1µm到4µm的间距为最佳铜密度,其键合界面无缺陷。
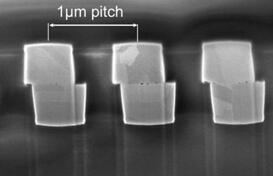
使用EVG的GEMINI® FB XT自动熔合键合系统,对两片300 mm晶圆、Pad间距1µm的晶圆进行键合,图为FIB-SEM下的横切面照片(图片来源:Leti)
Leti键合工艺工程主管Frank Fournel说,“据我们所知,这是小于1.5µm间距的铜混合键合可行性研究的首次报告展示。此次最新展示意味着在实现高密度3D芯片堆叠及最终商业化中真正的突破和重要的进步。”
Leti合著的论文总结了此次展示,标题为《1 µm Pitch Direct Hybrid Bonding with with<300nm Wafer-to-wafer Overlay Accuracy》,同时在2017年IEEE S3S会议上做了报告。
EVG的企业技术开发及知识产权(IP)部门总监Markus Wimplinger声明,“从下一代CMOS图像传感器和MEMS到高性能计算,3D集成有望提高器件的密度和带宽,并降低各类应用的功耗。作为3D集成研究及开发的领军者,Leti一直走在将此关键技术应用于工业及商业化的前列。EVG分享了这一愿景,我们很高兴在实现Leti的3D集成方面最新成果中发挥了重要作用。”
GEMINI FB XT自动熔合键合系统利用了EVG的高产量的XT框架平台和设备前端模块(EFEM),并为超高产量和生产率进行了优化。SmartView NT 光刻机也集成入该系统中,并提供了行业领先的晶圆间套刻对位精度(200nm以下,3 sigma)。此外,GEMINI FB XT还可容纳6个预处理和后处理模块,用于表面处理、调整和测量步骤,例如晶圆清洗、等离子体激活对准校验、剥离(允许预处理晶圆的自动分离并在必要时重新处理)及热压键合。
EVG于11月14日-17日在德国慕尼黑国际展览中心举行的SEMICON Europa上展示GEMINI FB XT。
延伸阅读:
