MEMS封装新趋势概览
2017-06-05 09:48:25 来源:微迷 评论:0 点击:
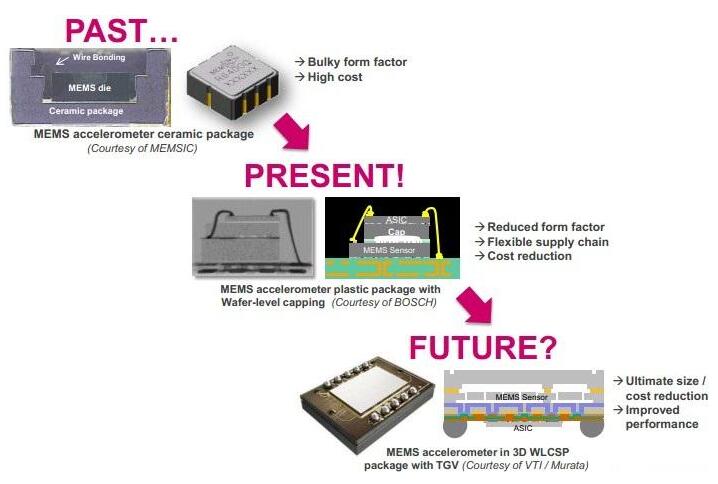
在整个MEMS生态系统中,MEMS封装发展迅速,晶圆级和3D集成越来越重要。这篇文章中,我们分析了MEMS集成和封装的现状和未来发展趋势。主要的趋势是为低温晶圆键合等单芯片集成开发出与CMOS兼容的MEMS制造工艺。另一个新趋势是裸片叠层应用于低成本无铅半导体封装,这种技术可为量产带来更低的成本和更小的引脚封装。此外,3D集成使LCR passives成为可能。LCR passives嵌入封装中使外部passives最小化并且为小引脚应用、晶圆键合、垂直内封装连接层和中介层提供便利。但是,MEMS器件的CMOS和3D集成给建模、测试和可靠性带来挑战。
硅中介层和封装集成
在一个叠层裸片或2.5D/3D封装中硅中介层用来垂直连接两个芯片。在微控制器和FPGA中,通常采用高引脚数量和高密度连接。这项技术以垂直硅通孔(TSV)形式类似地被MEMS采用。
金属基硅中介层通过DRIE刻蚀几十到几百微米的垂直沟槽,然后金属化以制造垂直金属导体。金属和硅的热膨胀系数错配会导致很大的机械应力,应力会导致晶圆弯曲、翘曲,变脆而难于加工。
掺杂多晶硅是金属TSV的替代技术,特别是应用于深度可达几百微米的高深宽比MEMS TSV中。中介层面对的其它挑战包括高器件密度下的热传递,高能耗应用,缺少3D集成模拟建模的EDA仿真工具,组装工艺可靠性以及如何获得失效分析的信号等。
晶圆级封装
MEMS晶圆级封装的最终目的是没有封装。术语“无封装(或者,硅封装)”是指器件在晶圆加工的过程中完成封装,而不必在晶圆切片后再进一步组装。这样做主要的优势是最小化器件尺寸,并且避免了高成本的传统半导体组装。这种封装,器件装有金属衬垫以便后续测试和应用。
利用晶圆级封装和其它微米技术,器件中可以包括带有模拟接口电路的特定功能IC(ASIC),并结合一个或多个MEMS传感器形成一个完整的传感器SOC。ASIC和MEMS可在同一晶圆或分开的晶圆上制造,然后键合在一起形成硅封装。晶圆键合形成了密封保护,并在ASIC和MEMS之间形成电连接。这种形式中,ASIC晶圆可以包括TSV,以使电信号传输到叠层的底部。金属垫因此被置于叠层的底部,做为电探测以及测试和表面封装的媒介。
晶圆键合必须是一个高产工艺,以保证一致的键合质量和每一个独立传感器的密封。甚至最小的裂缝也会改变MEMS的内部环境,这会导致传感器信号的漂移。这些裂缝很难检测,要想发现裂缝就需要破坏性实验。所以,必须使用样品测试和持续性的工艺检测统计来保证键和质量。
在背面,带有衬垫的微小封装需要高密度测试针,甚至需要在自动生产测试中使用MEMS探针。最终,器件尺寸和硅的脆性导致无法应用传统半导体处理方法,例如重力送-吸-放式分类机。
功能的权衡
MEMS产业在过去几年始终朝向一个器件包括10个自由度(DOF)的方向发展,实现完全的个人导航器件。10 DOF器件包括3轴加速度计、3轴陀螺仪、3轴磁力计和1轴气压传感器。虽然把这些功能在一个小引脚封装中实现在技术上是可行的,但由于多种原因导致经济上不可行。
在整合的成本和可制造性上要有权衡。多功能的传感器增加了组装的复杂度,裸片叠层可以实现小引脚封装和薄膜辅助注塑,从而为气压传感创造一个通风孔。一个或两个裸片过度注塑非常常见并且节省成本,结合MEMS具体工艺的多裸片层叠,比如为了机械振动隔离而做的胶分布,会极大地增加封装成本,在开发阶段和单件成本方面都是如此。
一个工艺在小量产时可行,在大规模量产时却可能会很有挑战性,因为产量这时可能会达到几千万乃至几亿,而组装成功率要求达到90%。在过去的时间里,MEMS产品公司看上去已经改变了他们的战略,去集成类似的和互补的功能,而把其它的功能从封装中分开。从应用的角度来看,这很有意义。例如,运动传感器应该置于手持电子器件的中心位置,而磁力计最好和其它元件分开以降低在测量地球磁场时受到的影响。
对于生产测试,运动传感器可在同一个测试仪中测试线加速度和角加速度,但压力传感器需要完全不同的测试设备。到目前为止,多种传感功能在一个封装中整合还是一个复杂问题,许多公司都在努力寻找方法以保持在消费电子和其它应用中的发展潮头地位。
如果您希望学习更多MEMS封装和测试知识,请报名参加由麦姆斯咨询主办的『《MEMS封装和测试培训课程》2017年第二期』,时间:2017年6月30日,地点:无锡。报名请邮件至:GuoLei@MEMSConsulting.com,电话:13914101112
