先进封装产业的临时键合/解键合专家——SUSS MicroTec
2017-11-14 21:57:16 来源:麦姆斯咨询 评论:0 点击:
据麦姆斯咨询报道,近日,半导体行业光刻解决方案和晶圆键合设备全球领先供应商SUSS MicroTec(苏斯贸易)盛大亮相由中国科学院上海微系统与信息技术研究所传感技术联合国家重点实验室、江苏省纳米技术产业创新中心主办的“2017传感器与MEMS技术产业化国际研讨会暨科研成果产品展”,并在研讨会上做了主题为“临时键合工艺及应用”的精彩分享。

SUSS MicroTec公司键合设备专家蔡维伽先生的主题演讲
近年来,随着半导体器件不断响应“更快、更便宜、更小”的需求,三维堆叠型3D集成已经进入了主流半导体制造,以解决“摩尔定律”物理扩展的局限性,同时提供更好的性能和功能。TSV(硅通孔)技术通过垂直的芯片通孔互联,带来了更短的互联长度、更小的封装面积,相应提高了信号传输速度并减少了寄生功耗。为满足TSV制造需求,减薄晶圆已是大势所趋,但超薄器件晶圆具有柔性和易碎性,容易翘曲和起伏,因此需要一种支撑系统来使TSV加工顺利进行。在此背景下,临时键合/解键合技术应运而生。
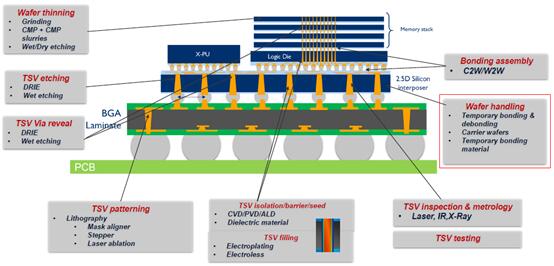
TSV制造流程中不可或缺的临时键合/解键合工艺
不过,制造良率仍在阻碍3D TSV集成的大规模应用,促使厂商去开拓替代解决方案,如TSMC(台积电)的InFO FOWLP(集成扇出型晶圆级封装)解决方案被用于Apple(苹果)iPhone 的A10和A11应用处理器的封装。引起了市场对Fan-out(扇出型)封装的广泛关注。随着扇出型封装正从移动/无线和汽车电子蔓延至MEMS、射频SiP和医疗电子产业,扇出型封装已经成为增长速度最快的先进封装平台,增长速度达到了36%,紧随其后的是2.5D/3D TSV平台,增长速度为28%。
不过,无论制造商选择那种解决方案,都需要利用临时键合/解键合技术来处理薄型、超薄型晶圆甚至柔性衬底,因此,临时键合/解键合市场预计将在未来几年内保持高速增长趋势。
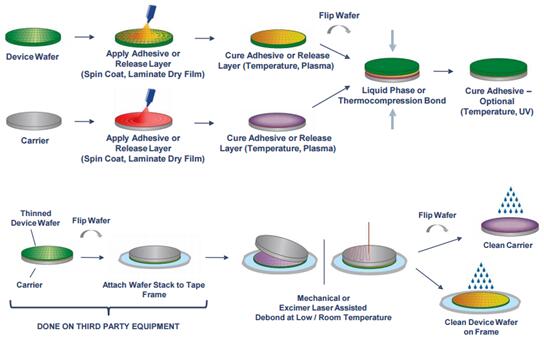
SUSS MicroTec公司申请专利保护的临时键合工艺及室温解键合工艺示意图。工艺流程包括:在上表面完成器件晶圆加工,将承载晶圆和/或器件晶圆旋转涂覆一层键合粘合剂,然后将两块晶圆转移至键合腔进行键合;临时键合后,对该晶圆叠层进行背面加工(减薄、蚀刻、金属化等);然后采用机械剥离和准分子激光工艺在晶圆上以最小力控制载体从承载晶圆上剥离,再执行减薄晶圆和承载晶圆的清洗
SUSS MicroTec是三维硅通孔(3D TSV)、晶圆级先进封装、MEMS以及光电应用市场公认的光刻和晶圆键合设备领导者。近年,SUSS MicroTec的临时键合/解键合设备业务一直处于高速增长期,目前全球的市场占有率已经达到60%。三星(Samsung)、SK海力士(SK Hynix)、安靠科技(Amkor)、台积电(TSMC)等全球几乎所有的大型Foundry都在使用SUSS MicroTec的临时键合/解键合设备进行生产。
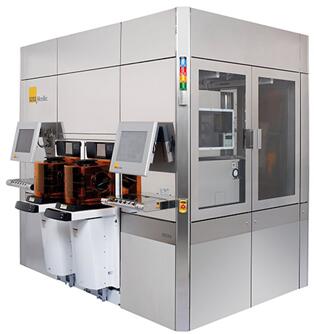
SUSS MicroTec公司XBS300临时键合平台
SUSS MicroTec公司的XBS300临时键合平台是新一代用于大批量生产的临时键合机解决方案。这款支持200/300毫米晶圆的键合平台可以通过多种工艺模块的配置,在一台设备中完成涂覆粘接层、剥离层以及临时键合,同时实现低成本和最大化的工艺灵活性。
此外,与竞争对手一般采用独家设备匹配独家材料的方案不同,SUSS MicroTec 公司的开放临时键合平台兼容所有常见的临时键合材料系统。除了已用于生产的工艺外,SUSS MicroTec公司通过和Thin Materials、brewer science、3M、FUJIFLIM等全球知名材料供应商深入合作,还在不断的鉴定更多材料,以最大范围的支持市场上可供选择的粘材,帮助公司针对不同的客户工艺提供最适合的材料解决方案。
“我们非常乐意与国内的材料供应商合作,开发满足客户需求的键合材料,” SUSS MicroTec公司上海有限公司总经理龚里博士说,“目前几乎所有的半导体相关材料都是依赖国外进口,国内的材料制造商只有通过实际应用,才能了解自己的材料到底能用于哪些半导体工艺,以及如何满足工艺及客户的需求。我们非常愿意利用多年的半导体材料开发经验,帮助国内的材料供应商一起成长,在半导体全产业链的国产化道路上贡献自己的一份力量。”

SUSS MicroTec公司XBC300第二代解键合和清洁平台
XBC300二代解键合和清洁平台专为加工200/300 mm晶圆以及超大载体而设计,通过灵活变换配置,可以用于小批量工艺开发以及大批量制造。其智能过程控制还能够处理装在薄膜上、厚度 50 µm 甚至更薄的晶圆。XBC300 二代提供一系列专为解键合和清洗应用而设计的特殊模块选择,不仅总体工艺成本低,而且拥有高度自动化的工艺灵活性,能够为2.5D和3D先进封装应用提供全面的解决方案。
关于SUSS MicroTec
SUSS MicroTec 集团总部位于德国加尔兴。在亚洲、欧洲和北美设有生产厂以及销售公司。
集团的核心业务是光刻和晶圆键合解决方案。光刻部门主要负责生产高精度光刻设备,其重点业务是光刻机、旋涂机和喷胶机。键合部门专注于生产大规模封装市场用键合机,同时也提供手动设备。光掩模设备部门提供一系列用于光掩模和压印掩模工艺的高端设备及解决方案。此外公司还提供一些专用配件,如纳米压印光刻组件、光学透镜等。
延伸阅读:
上一篇:工艺控制在源头,KLA-Tencor为先进工艺“保驾护航”
下一篇:技术创新引领半导体行业新发展泛林集团亮相SEMICON China 2018
