激光隐形切片机(ML200Plus):全干法无损伤切片
2014-01-27 10:58:42 来源:微迷 评论:0 点击:
纳米加工平台近期引进世界最先进的全干法无损伤切片设备--激光隐形切片机(Mahoh Dicing Machine)。目前已经完成了该设备的安装调试,并开始对外服务。隐形切割采用全干工艺减少了生产过程中的清洗工序,同时解决了传统切割技术在芯片分割过程中带来的不可避免的机械及热损伤问题,为晶圆切割开创了一个新局面。
隐形切割在切割速度,产品性能及良率等诸多优点必将促使其成为芯片切割工艺持续发展的方向。
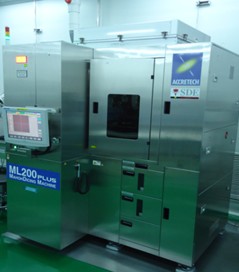
工作原理:
激光隐形切割是将激光光束聚焦在工件内部,形成一个分割用的改质层,再对晶圆片施以外力将其分割成小片芯片的切割技术。
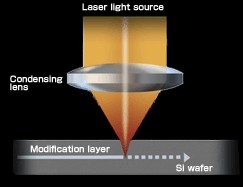
高效率高质量工作:
ML 200 Plus可切割100um~700um厚度硅片,切割速度可达450mm/s,是刀片切割的8-10倍。
ML 200 Plus切割过程中不会有水的参与,完全干燥环境下切割,可保证样品的清洁度。
ML200Plus切割痕迹只有几个微米,切割道最小可留5-10um,而刀片切割痕迹能达到几十微米,可见ML200Plus切割可以大大提高生产效率。

ML200Plus可进行多边形的切割。提高晶片利用率。

主要技术指标:
样品:Si材料
样品表面粗糙度:≤0.08um
可加工样品满足条件:[样品厚度(cm)/电阻率(Ω*cm)]<4.3
样品厚度:100-700um
样品尺寸:圆形 -- 2 inch ~ 8 inch;方形 -- 25 mm ~ 140 mm
样品托盘:6 inch~8 inch
激光:波长:1080 nm
联系人:黄河 先生
电话:13862142608
邮箱:hhuang2014@sinano.ac.cn
上一篇:爱德万测试电子束微影系统获产学界肯定
下一篇:MEMS多传感器自动化测试系统
