恩智浦携手Nepes为物联网推出首款FO PoP SiP封装产品
2017-07-08 20:52:00 来源:麦姆斯咨询 评论:0 点击:
据麦姆斯咨询报道,先进封装作为一种关键的使能技术,不仅为封装服务,还能为最终的产品带来更多的价值和成本上的降低。2016年到2022年期间,先进封装产业的总体营收将以7%的复合年增长率增长。该产业无疑是个充满活力的领域,而创新在其中扮演着关键的角色。恩智浦(NXP)单芯片模块SCM-i.MX6Q采用扇出型/堆叠/系统级封装技术(FO PoP SiP),配置启动存储器和电源管理,是一个很好的先进封装平台演化的范例。因此,恩智浦提出了将SiP和PoP巧妙结合,这种简单且智能的封装方式能得到尺寸很小的产品,非常适用于物联网应用。
Yole的子公司System Plus Consulting技术和市场分析师Jérôme Azémar评论到:“恩智浦的单芯片模块展现了先进封装技术如FO PoP SiP的兴起。有了这项技术,恩智浦得到了区别于其他公司的产品。NXP与长期合作伙伴Nepes,达成专注于多芯片集成以创造高附加值模块的战略。”恩智浦的单芯片模块最初面向物联网应用,将来这种SiP封装方式将有机会面向高端市场,让我们拭目以待……
System Plus Consulting于近期发布了恩智浦单芯片模块SCM-i.MX6Q的逆向拆解报告,对其技术和成本进行了分析,报告名称为《恩智浦单芯片模块:SCM-i.MX 6Quad》。该报告对PoP SiP解决方案进行了全面回顾,包括芯片分析、工艺分析和封装横断面剖析。同时,与其他竞争解决方案进行了对比,如台积电(TSMC)的整合扇出晶圆型封装(inFO)和新光(Shinko)的MCeP堆叠封装,并提供了完整的成本分析和销售价格评估系统。
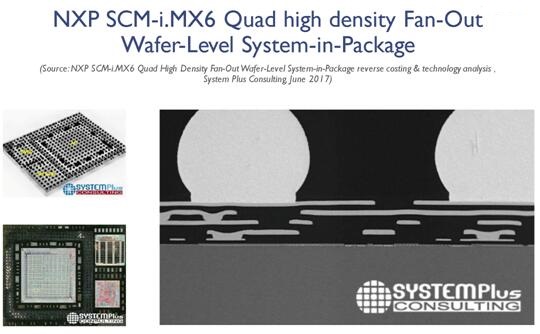
在很多应用中,SiP将多个器件集成在一个尺寸很小的封装体已面临巨大的挑战。新兴市场的出现,如物联网的系统配置需要低功耗、高性能的器件。恩智浦因此推出了一款尺寸小巧的晶圆级SiP封装产品,集成应用处理器、电源管理电路和基于flash技术的启动存储器,并在汽车上得到了验证。相比采用标准PCB进行分立器件的封装方式,尺寸缩小了50%。
恩智浦单芯片模包括块SCM-i.MX6 Quard应用处理器、MMPF0100电源管理系统、16MB闪存和百余件无源系统元件,所有器件封装在一个不到200立方毫米的封装体内。System Plus Consulting的先进封装和射频产品成本部门的工程师Stéphane Elisabeth分析:“这是我们在市场上看到的第一款将多芯片进行扇出型封装的产品,这是扇出SiP封装技术的一个重要里程碑。”
该模块采用Nepes公司开发的非传统晶圆级封装方式,创新的互连方式将美光的SDRAM内存芯片进行PoP封装。Via Frame这种定制化的芯片重新分配技术,允许内存堆叠。这些元器件仅需少量的重布线层(RDL)就可以集成在环氧模塑料封装体(EMC)中。
Stéphane Elisabeth认为:“恩智浦SCM-i.MX6 Quard应用处理器和PoP封装技术,使得SCM-i.MX6Q非常省电。”通过简化高速存储器的设计,大大降低了将处理器、芯片、内存多个子系统进行整体设计的复杂性,缩短了产品的上市周期。归功于SiP封装带来的芯片重新分布封装技术,恩智浦实现了完整的、小尺寸、低功耗和高性能的解决方案。
那么,下一步会是什么呢?根据Yole的分析,扇出型封装将是先进封装平台增速最快的技术,2016年到2022年期间的复合年增长率将达到36%。System Plus Consulting和Yole深信扇出型SiP封装技术在不久的将来会迅速进入市场。苹果iPhone 8的处理器A11就将会成为未来很好的例子!
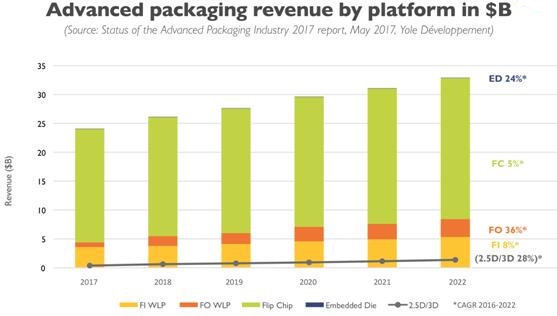
延伸阅读:
