离子束刻蚀碲镉汞的沟槽深宽比改进
2017-07-10 19:31:09 来源:微迷 评论:0 点击:
碲镉汞(Hg1-xCdxTe)材料可以通过组分x值的改变来制备各种波段的红外探测器,在光电器件、传感器和环境检测等领域有着广泛的应用。随着近些年新一代HgCdTe焦平面探测器的崛起,使得碲镉汞探测器逐步向大规模、高集成发展。探测器光敏元尺寸和芯片线宽的日益减小,都需要高深宽比的沟槽隔离技术来实现,这对芯片成型工艺中重要的一环———离子束刻蚀工艺提出了更高的深宽比要求。
为实现这些列阵的有效隔离和达到高的深宽比,中国科学院上海技术物理研究所的贾嘉等研究人员进行了离子束刻蚀碲镉汞沟槽的工艺研究,重点分析了选用不同光刻胶型号、改变刻蚀角度以及使用三栅离子源对刻蚀深宽比的影响。
1、离子束刻蚀简介及评价参数
离子束刻蚀是通过物理溅射功能进行加工的离子铣。国内应用最广泛的双栅考夫曼刻蚀机通常由屏栅和加速栅组成离子光学系统,其工作台可以方便地调整倾角,使碲镉汞基片法线与离子束的入射方向成θ角,并绕自身的法线旋转,如图1所示。评价沟槽轮廓主要的参数有沟槽的开口宽度We、沟槽的刻蚀深度H、台面的坡度角φ和沟槽底部的宽度Wb。我们常用的深宽比(Aspectratio)是指槽深H和槽开口宽度We的比值,本文中用R表示。深宽比是常用来作为衡量刻蚀工艺水平和刻蚀图形好坏的评价参数。本实验中使用的是北京埃德万斯离子束研究所股份有限公司生产的LKJ-1C-100型考夫曼Ar离子束刻蚀机。

图1 离子束刻蚀原理图
北京埃德万斯离子束技术研究所股份有限公司自主研发的Advanced LKJ系列离子束刻蚀系统,为通用离子束刻蚀系统,除了可进行传统微纳结构刻蚀外,还可实现离子束清洗、材料表面抛光和材料减薄等功能,还可实现化学辅助离子束刻蚀(CAIBE)与反应离子束刻蚀(RIBE)。
2、实验及结果
在本实验中设计了四条宽度分别为10um、8um、6um和4um的刻蚀槽,使用光刻胶作掩模,样品经过前烘、曝光、显影、定影和后烘的光刻标准工艺后在碲镉汞基片上形成需要的槽宽,然后在离子束刻蚀机上用常规刻蚀工艺条件(离子能量300eV、离子束流55mA、加速电压200~220V)进行Ar离子束的物理刻蚀,刻蚀时间都为3h。刻蚀结束后将碲镉汞基片取出,去胶后用红外物理国家重点实验室的扫描电子显微镜(SEM)测量这些刻蚀沟槽的参数并计算其深宽比。为了提高离子束刻蚀碲镉汞材料的深宽比,设计并尝试了三种方法,并通过实验验证了其可行性。实验1和实验2中使用的是传统的双栅离子源,实验3中使用的是三栅离子源。

图2 三栅离子束系统结构原理图
实验3中,尝试使用了三栅的考夫曼离子源。三栅的考夫曼离子源在加速栅后面还设置第三个栅极作为减速栅,如图2所示。本实验中的三栅离子源,其在常规刻蚀工艺条件下,与实验1和实验2中使用的双栅离子源对碲镉汞材料有着基本相同的刻蚀速率。图3(a)和(b)还分别给出了用AZ4620光刻胶做掩模的情况下双栅和三栅离子源刻蚀3小时后的SEM图像。
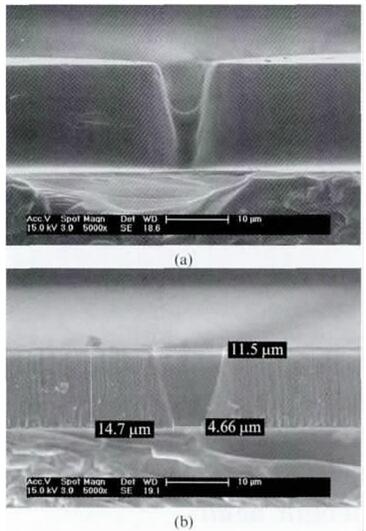
图3 分别用两种离子源刻蚀3小时后的SEM图像(a)双栅离子源刻蚀槽(b)三栅离子源刻蚀槽
从实验结果看出:(1)不论是使用AZ5200还是AZ4620做掩模,三栅离子源几乎都比常规的双栅离子源能获得更大的刻蚀沟槽深宽比;(2)而且随着刻蚀槽宽的减小,三栅离子源对提高刻蚀深宽比的效果越显著;(3)三栅离子源在用AZ5200和AZ4620做掩模,刻蚀设计值为4um的槽宽时,其深宽比都达到了2以上;(4)从SEM图像来看,常规双栅离子源的刻槽轮廓呈U形,槽底部的形状近似半圆,而三栅离子源的刻槽轮廓呈倒梯形。通过测量沟槽的开口宽度We、沟深H和沟底宽度Wb,如图3(b)所示,能计算得到用三栅离子源刻蚀的四种宽度的刻蚀槽台面的坡度角φ都在75°~78°之间,说明虽然刻蚀时间已达到3h,但三栅离子源的刻槽侧壁还是比较陡直的。
三栅离子源相对于常规的双栅(二栅)离子源能获得深度宽比更大的刻蚀槽的主要原理是:二者比较,三栅离子光学结构较二栅结构具有相对小的束散角。增加的第三个栅极电位为零,可以把减速场完全限制在加速栅和减速栅之间的Ld范围内,减速场的长度大大缩减,离子一旦进入减速栅孔即转入直线运动,不再增加束散角,因而三栅离子束准直性优于双栅离子源,从而最终能获得更大的刻蚀深宽比。
3、结论
在Ar离子束考夫曼刻蚀机上,开展了提高碲镉汞刻蚀沟槽深宽比的方法研究。分别进行了选用不同光刻胶、改变刻蚀角度和使用三栅离子源的实验,并通过SEM测量了四条设计宽度依次为10um、8um、6um和4um的刻蚀槽的剖面轮廓,得到了影响刻蚀沟槽深宽比的初步结果。实验结果表明:(1)要选用选择比高的光刻胶做掩模,才能获得相对深宽比高的沟槽,本实验中为AZ4620型光刻胶;(2)在相同的刻蚀条件下,增大刻蚀角度虽能获得较大的刻蚀深度,但由于其开口宽度也相应较大,所以增大刻蚀角度并不能获得深宽比大的沟槽;(3)三栅离子源相对于常规的双栅离子源具有相对小的束散角,因此能获得深度比更大的刻蚀槽,且随着刻蚀槽宽的减小,三栅离子源的效果越显著。
综合以上实验的结果,可以知道三栅离子源在用AZ4620做掩模时对提高碲镉汞刻蚀沟槽深宽比的作用最佳,刻蚀设计值为4um的槽宽时其深宽比达到了2以上,对改进碲镉汞刻蚀沟槽的工艺方法给出了很有意义的指导性结论。
上一篇:恩智浦携手Nepes为物联网推出首款FO PoP SiP封装产品
下一篇:可穿戴产品技术大突破:柔性电容传感器创新工艺
