深入了解“微转印”技术
2016-07-18 20:49:16 来源:麦姆斯咨询 评论:0 点击:
据麦姆斯咨询报道,近期,初创企业X-Celeprint在拉斯维加斯举办的ECTC会议上提交了4篇论文,主题是关于他们的微转印技术(μTP技术)、工艺流程以及该技术的微电子应用。μTP技术作为一项先进的微装配技术,可以使数百个小型(最适宜尺寸为亚毫米级)器件在同一时间内精确移动。
X-Celeprint是XTRION N.V的全资子公司,XTRION N.V旗下还包括著名的X-Fab公司。他们从塞木普锐斯公司(Semprius)获得技术授权,并且在2014年初开始正式运营。微转印技术的最初发明者为伊利诺大学香槟分校的John Rogers教授,随后在塞木普锐斯公司获得进一步发展。
用最简单的语言来描述微转印技术,就是使用弹性印模(stamp)结合高精度运动控制打印头,有选择地拾取(pick-up)微型器件的大阵列,并将其打印(放置)到替换基板上。首先,在“源”晶圆上制作微型器件(芯片),然后通过移除半导体电路下面的牺牲层获得“释放”。随后,一个微结构弹性印模(与“源”晶圆匹配)被用于拾取微型器件,并将这些微型器件打印(放置)在目标基板上。
通过改变打印头的速度,可以选择性地调整弹性印模和被打印器件之间的黏附力,最终控制装配工艺。当印模移动较快时,黏附力变得很大,得以“拾取”被打印元件,让它们脱离基板;相反,当印模远离键合界面且移动较慢时,黏附力变得很小,被打印元件便会“脱离”,然后“打印”在接收面上。
印模通过设计,可以实现单次拾取和打印操作,转移成千上万个分立元器件,因此这项工艺流程可以实现大规模并行处理。例如,240平方微米的芯片被放置在间距为250 um的晶圆上,需要把芯片“打印”(放置)到间距为2 mm的新表面上,印模上的末端(参考下图转印印模)就会被制作成2 mm的间距,然后从晶圆上拾取1、8、16等芯片,一次打印完成后再回来拾取2、9、17等芯片。
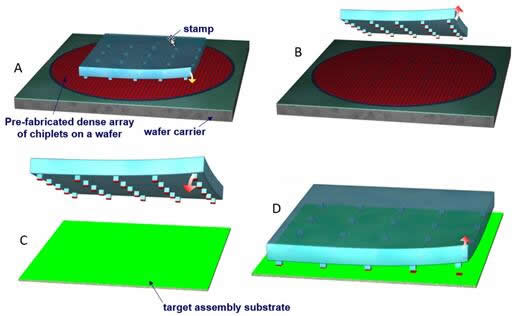
微转印工艺流程:图A:弹性印模接近晶圆;图B:弹性印模拾起芯片;图C:弹性印模接近基板;图D:印模将芯片“印刷”(放置)在基板上
该技术已经在众多“可印刷”微型器件中得到验证,包括激光、LED、太阳能电池和各种IC材料(硅、砷化镓、磷化铟、氮化镓和包括金刚石在内的介电薄膜)的集成电路。
大多数情况下,需要转印的器件首先会从“源”晶圆上得到释放,该方法利用了器件层下方的牺牲释放层。对于硅器件,绝缘体上硅(SOI)晶圆代表方便、随时可用的“源”晶圆。利用商业化的SOI CMOS加工工艺处理5 um器件硅层和1 um埋氧层(BOx)来制作电路。
按照CMOS加工工艺,一段沟槽截至围绕器件周围的器件硅层,封装层被施加在SOI CMOS“源”晶圆上,用来在随后的BOx层刻蚀中,保护ILD和布线层。SOI CMOS晶圆通过刻蚀工艺,用HF(氟化氢)去除器件下方的BOx层,器件最终从晶圆中完全脱离出来,并通过器件层中的“栓绳”来进行位置固定。在转印期间,“栓绳”可以通过可控的方式断裂或切开。牺牲层刻蚀工艺完成后,当IC芯片可以转印时,封装层将会被移除。
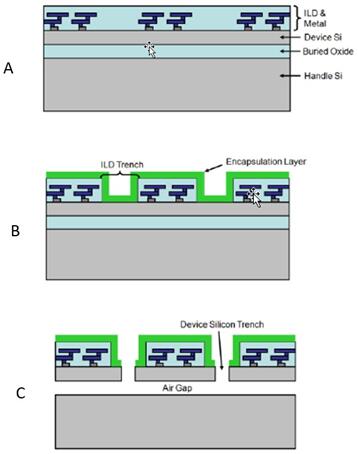
制作转印用器件:图A:晶圆代工所以采用的SOI晶圆;B:沟槽和封装层构造;图C:器件硅层开槽,移除埋氧层
2016年ECTC会议上,论文《微转印技术助力微型氮化镓晶体管的异质整合》的作者,来自X-Fab的Ralf Lerner详细描述了构造GaN芯片的工艺流程。
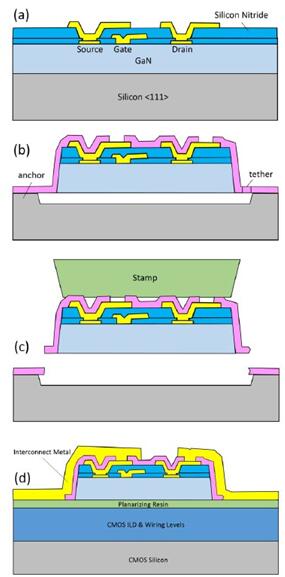
GaN HEMTs异质整合工艺流程:图a:在硅晶圆上制作晶体管;图b:器件被隔离、钝化、切底;图c:器件被抬取黏附在弹性印模上;图d:器件被打印到CMOS晶圆上,并利用薄膜铝迹线与CMOS晶圆连接
氮化镓晶体管在直径为100mm的硅晶圆<111>上制作而成。通过穿过器件层,向下直至硅基板的反应离子刻蚀(RIE),实现单个器件的分离。在该步骤中使用了二氧化硅硬掩膜。通过等离子体增强化学气相沉积法(PECVD)将600 nm的氮化硅层沉积。氮化硅层可以钝化器件侧壁,也可以用于锚定和“栓绳”结构的形成。
氮化镓芯片随后被转移到硅基CMOS晶圆上。印刷前,在CMOS晶圆上施以一层半导体薄膜级平坦化树脂,微转印完成后,底层树脂在175 °C时被固化。接下去进行钨化钛和铝的金属叠层溅射沉积,随后进行减厚湿法刻蚀,最终形成器件的连接。转印的GaN HEMT芯片厚度大约为5μm,溅射沉积铝在器件侧壁的布线中起到了有效作用。

相互连接的GaN HEMT:图A:铝布线分布在转印的GaN HEMT侧壁上;图B:展开图
在论文《微转印技术助力微型器件的扇出型封装》中,来自X-Celeprint和RTI Int的研究员们描述了不需要注模材料,制作亚毫米器件扇出封装的高通量策略。微转印技术被用来组装重新装配的晶圆器件(尺寸80um x 40um,拥有重分布金属和6个触点封装的芯片),面朝上,印刷(放置)在200 mm的晶圆上。装配完成后,晶圆器件将经过标准化晶圆级再分配和凸块工艺处理。最终,200 mm晶圆上的扇出型封装器件的尺寸为1.4mm x 1.0mm,器件上有6个250 μm焊接凸块。最终的扇出型封装将在FR4测试板上组装并回焊。
因为封装中没有使用任何注模材料,因此不需要模压成型器件所使用的芯片模具。
该转印工艺良率预估高达99.7%,每30秒就能转印300个芯片。
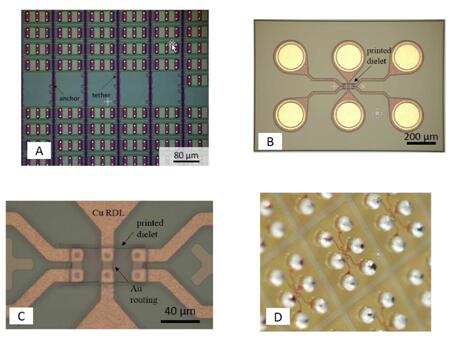
使用微转印技术制作晶圆级封装芯片:图A:部分“拾取”后的芯片“源”晶圆;图B:焊球置放前完整的扇出型封装;图C:特写;图D:最终的扇出型晶圆级封装
两块PCB板上填充了60颗芯片,每颗芯片都经过JESD环境(-40°C 到 125°C)下的热循环测试。没有一颗芯片显现出超过0.2欧姆的平均热阻变化。
上一篇:安靠科技在中国开辟新的MEMS封装线
下一篇:GMEMS推出创新的压电MEMS技术平台,进军压电式MEMS麦克风领域
