多种激光技术助力微电子封装
2018-08-27 15:40:35 来源:麦姆斯咨询 评论:0 点击:

据麦姆斯咨询报道,人们对平板电脑、手机、手表和其他可穿戴设备的需求趋向功能复杂但结构紧凑,因此半导体芯片和封装后器件的尺寸不断缩小对微电子技术发展的重要性不亚于摩尔定律的重要意义。先进封装技术趋势为激光器发展创造了大量机会,因为他们能力非凡,能够在最小热影响区(HAZ)执行各种材料的高精度加工任务。因此,激光器在晶圆切割、封装切割(singulation)、光学剥离,μ-via钻孔、重分布层(RDL)结构化、切割带切割(EMI屏蔽)、焊接、退火和键合等方面使用越来越广泛,在此仅举几例。本文详细阐述了三种截然不同的基于激光的工艺,用于各种充满活力的应用领域。
纳秒和皮秒激光器用于系统级封装(SiP)切割
SiP技术可帮助高端可穿戴设备或便携式设备实现体积微型化、功能高度集中。SiP器件由各种电路组件组成,例如处理器、存储器、通信芯片和传感器等,组装在嵌入式铜线的PCB基板上。所有器件的组装通常被封装在模塑复合材料里,并添加具有电磁屏蔽功能的外部导电涂层。SiP器件厚度约1mm,其中模塑复合材料厚度约占一半。
在制造过程中,一开始多个SiP器件制作在一块大面板上,最后再被分割成单个器件。此外,某些情况下,在器件中,沟槽会直接深入到模塑复合材料,直到连接到铜接地层。该工艺在导电屏蔽层覆盖器件之前完成,导电屏蔽层主要用于完全覆盖SiP区域,使得与其他高频元器件隔离。
对于切割和开槽,切口位置和深度都必须精确,不能有炭化,更不能有碎屑。此外,诸如热损伤、分层或微裂纹等切割过程中产生的问题,都会对电路造成不可挽回的后果。
目前,具有纳秒脉冲宽度的20-40W紫外固态激光器(例如Coherent AVIA)是SiP切割的主要工具。然而,对于纳秒源,需要平衡输出功率和切割质量(特别是边缘质量和碎片形成)。因此,仅通过施加更多激光功率是不能轻易提高处理速度的。
因此,如果对切割质量要求极高,可以选择532 nm(绿色)超短脉冲(ultra-short pulse,简称USP)激光器替代,例如Coherent HyperRapid NX皮秒激光器或Monaco飞秒激光器。与纳秒激光器相比,它们的切口更小,可以减少HAZ和碎片量,在某些情况下甚至可以提高产量。但是,USP源唯一的缺点就是它们的投入成本较高。

图1:用皮秒(上图)与纳秒(下图)切割的1.2mm厚SiP材料的横截面示意图
准分子激光器用于RDL
RDL是实现微电子领域中几乎所有先进封装的关键技术,包括倒装芯片、晶圆级芯片封装、扇出型晶圆级封装、嵌入式IC和2.5D / 3D封装等。RDL是通过图案化金属和介电层对电路进行布线,可以使每颗硅基芯片连接到其他芯片。以这种方式,RDL就可重新规划管芯的输入/输出路线。
目前,大多RDL是用“光刻定义”电介质构造的,其中所需的电路图案先通过光刻印刷,然后再用湿法刻蚀去除曝光或未曝光区域来获得的。但是光刻定义聚合物有几个缺点,比如成本高、加工复杂以及热膨胀系数(CTE)与键合材料不匹配等。此外,由于光刻胶残留引起的电路故障,会存良好管芯失效的风险。
如今,有一种新的解决方案诞生,它可通过使用合适的非光电介质材料,采用308nm准分子激光器进行直接烧蚀构图。这些非光电介质的成本远低于光刻定义的材料,而且其产生的应力更小,CTE匹配更好,机械和电气性能更佳。在这里,激光通过包含所需图案的光刻版投射,然后烧灼衬底(比投影图案大),移动,再烧蚀,直到所有区域都被图案化。准分子激光烧蚀是一种经济的高通量图案化方法,因为它比光刻定义的电介质图案化方法步骤少,无需使用湿法化学品,堪称“绿色”工艺。
基于准分子激光的RDL结构工具已经在基于Coherent LAMBDA SX系列激光器的基础上投入使用。这些准分子激光器的高脉冲能量(> 1 J)和重复频率(300 Hz)可为低至2μm的特征尺寸提供快速产出量。此外,准分子激光烧蚀的优势还表现在对特征深度和“侧壁角”的出色控制上。而后者尤为重要,由于大角度图形两侧的“阴影”会对随后的金属溅射或气相沉积过程产生负面影响。
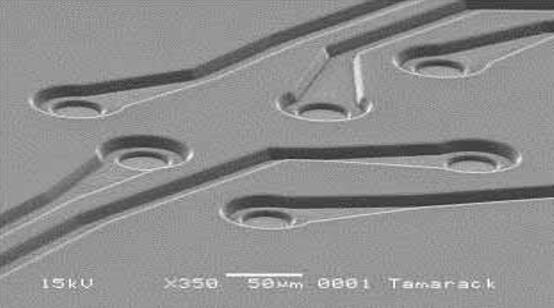
图2:准分子激光烧蚀在聚酰亚胺中制作出无缺陷的微型图形(图片来源:SUSS Microtec)
CO2和CO激光器用于LTCC切割和打孔
如今众多封装应用都涉及低温共烧陶瓷(LTCC),它作为电力或通信器件的微电子基板越来越受欢迎。LTCC被加工成绿色(未烧制)的陶瓷,通常在50μm至250μm范围内,厚度约为40μm至60μm的氯化聚乙烯(PET)磁带层上制造。在LTCC电路制造中,激光器主要用于划片(切割)和钻通孔两种工艺过程。
追溯历史,CO2激光器一直都用于LTCC切割。先用激光产生一排紧密间隔的孔,这些孔穿透到衬底中层(如划片槽),然后再使用机械力沿着该划片槽将材料折断。
如今,CO激光器作为CO2激光器的替代品,吸引了越来越多的关注。几年前由Coherent引入市场的工业CO激光器与CO2技术类似,不同之处在于CO激光器的输出波长约为5μm。该较短波长在LTCC中的吸收明显低于10.6 µm的CO2波长。这使得激光能够进一步渗透到基板中,划片深度更深,这样可使材料更容易断裂(见图3)。而且,较低的吸收也会产生较小的HAZ。
一直以来,LTCC钻通孔也依赖于CO2激光器。但是对于这个技术,绿色波长USP激光器可能会成为CO2的首选替代品。这是因为USP激光器可完美平衡质量和产出率之间的矛盾。具体而言,一台50W绿色USP激光器可以在0.60mm陶瓷中以超过每秒2000个孔的速率生产30μm的通孔。但是,另一方面,CO激光器同样也可以替代USP激光器。CO激光器已被证明可以在0.65mm厚的烧制陶瓷中以高于1000个孔/秒的速率产生大于40μm的通孔。因此,根据陶瓷的厚度和所需的直径,USP和CO激光器都是LTCC钻通孔的最佳选择。
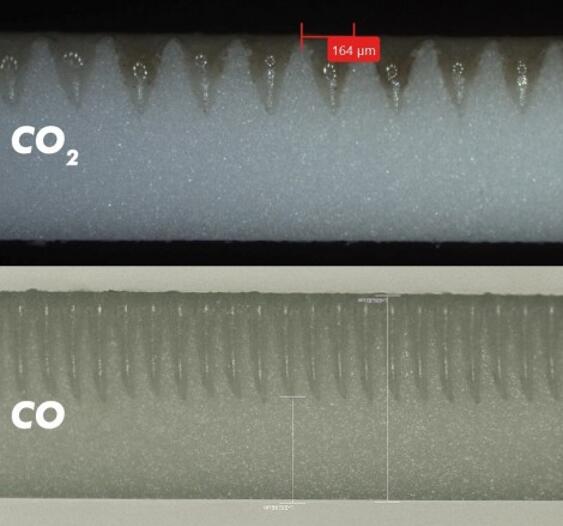
图3:0.6mm厚切割LTCC横截面。比较显示,CO激光器的切割由于其在陶瓷中的吸收较低,能够进一步穿透并产生更高纵横比的通孔。在入口处和直径较大的孔处,CO2工艺也显示出更多的炭化。
基本优势相似
总之,虽然目前半导体封装使用多种激光技术,但它们都具有相似的基本优势。具体而言,这些包含产生高精度特征的非接触式加工,通常对周围材料的影响很小,而且产量较高。此外,激光加工是“绿色”的,因为它无需使用危险或难以处理的化学物质。
延伸阅读:
《先进封装:3D IC和2.5D硅通孔互连技术-2016版》
