未来的封装-多芯片集成
2011-11-28 20:57:16 来源:微迷 评论:0 点击:
虽然最新出现的CSP技术已经让裸芯片尺寸与封装尺寸基本相近,这样在相同封装尺寸时可有更多的I/O引脚数,也使电路组装密度大幅度提高,但是人们在应用中也发现,无论采用何种封装技术,在封装后裸芯片的性能总是比未封装的要差一些。于是人们提出了多芯片组件MCM(Multi Chip Module)概念。 MCM把几块IC/MEMS芯片或CSP组装在一块电路板上,构成功能电路板,就是多芯片组件。 MCM的出现使电子系统实现小型化、模块化、低功耗、高可靠性提供了更有效的技术保障。
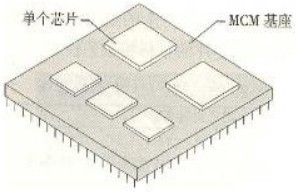
图1 MCM结构示意图
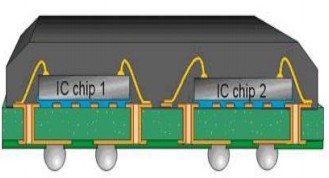
图2 MCM刨面结构图
多芯片集成在MCM技术之后的后续者就是SIP(System in a Package)。 SIP是指把构成一个完成电子系统的多个芯片封装在一起的技术, 例如将移动终端中的存储器、接口电路、传感器,甚至处理器都封装在一个芯片内,以实现电子设计的小型化。 虽然有人认为SIP和MCM是同一个技术, 但是大多数认为SIP 在封装技术上更先进,而把SIP区别开MCM。例如,MCM中芯片是放置在同一层面上IC/MEMS基板上, 而SIP中芯片可以根据一定的配置堆叠放置。
SIP封装技术使设备提供商把MCU、DRAM、FLASH、ASIC和DSP,甚至被动元件压缩进一个单一封装中,可以大大地减小系统的尺寸,也极大地缩短了产品的发布时间和周期,安装和测试也相应地简化了。 采用SIP封装的集成电路, 对印刷电路板的要求也降低了, 因为复杂的系统连线在芯片内部已经实现了。 由于要实现水平和垂直方向芯片的安装和连接, SIP封装技术的难度是相当大的。 一般把封装过程中将多个芯片层叠放置并且互相连接。SIP由于大量使用堆叠技术也被称为3D封装技术。从技术难度和应用速度来看,3D 封装技术在未来10 年内将成为封装技术的突破点和主流路径。
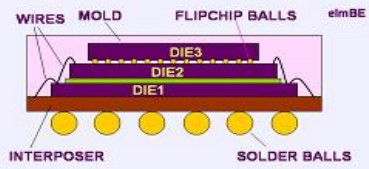
图3 一个采用了引线键合和倒置芯片的3D SIP结构
上一篇:封装浅析:封装形式演进带来工艺流程变革
下一篇:TSV技术是3D SIP的关键
