封装浅析:封装形式演进带来工艺流程变革
2011-11-27 10:32:53 来源:华泰证券报告 评论:0 点击:
根据集成电路的不同需求,可以采取不同的封装形式。目前在市面上存在多种广泛使用的封装形式。而且这个封装模式本身也在随着技术的发展而逐渐演进。
芯片封装技术已经历经了好几代的变迁,代表性的技术指标飞速发展,包括芯片面积与封装面积之比越来越接近,适用频率越来越高,耐温性能越来越好,以及引脚数目增多,引脚间距减小,重量减小,可靠性提高等等。
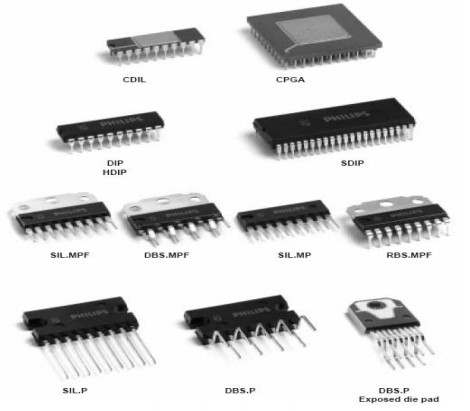
图1 低I/O密度封装形式
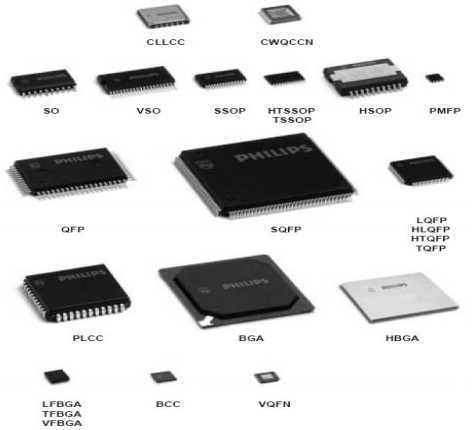
图2 高I/O密度封装形式
这些变化的最根本因素来自于市场需求。从80 年代中后期开始, 电子产品正朝便携式和小型化、网络化和多媒体化发展,这种市场需求对电路组装技术提出了相应的要求:单位体积信息的提高和单位时间信息的提高。为了满足这些要求,势必要提高电路组装的功能密度,这就成为了促进芯片封装技术发展的最重要因素。
从封装技术的发展历程看,半导体封装技术发展包括5个发展阶段,沿3个趋势发展:尺寸缩小、功能转换与性能提高、技术融合。最早出现的封装型态DIP正在快速萎缩,目前,全球半导体封装的主流技术正处在第三阶段的成熟期,以CSP和BGA等主要封装形式进行大规模生产,同时也在向第四、第五阶段发展。
图3 集成电路封装形式演进历程
未来的封装技术发展方向包含以下的一些方式:圆晶级封装(WLCSP),覆晶封装(Flip Chip),系统封装(SiP),硅穿孔(Through-Silicon-Via),射频模组(RF Module),Bumping 技术的印刷(Printing)和电镀(Plating)等。
目前,发达国家在技术水平上占有优势,国际集成电路封装技术以BGA、CSP为主流技术路线,而中国本土封测厂商产品以中、低端为主, 封装形式以DIP、SOP、QFP为主,并在向BGA、CSP发展的道路中。提升内地集成电路企业的实力,促进其技术升级是做强内地集成电路企业的必由之路。
封装形式演进带来工艺流程变革
半导体芯片的封装针对不同的封转方式在工艺流程设计上略有不同,现在普遍采用的DIP、SOP等封装都沿用下图所示的一个工艺流程,主要的工艺包含:贴膜 - 打磨 - 去膜 - 切割 - 粘贴 - 键合 - 压膜 - 烘焙 - 电镀 - 印字 - 引脚成型。
图4 传统半导体封装的工艺流程
其中各个环节的大致功能如下表所述:
表1:传统半导体封装流程介绍
现在一些新的封装形式,如BGA和CSP系列,所采用的工艺流程、具体操作和上图有所不同。而且随着封装技术的不断进步,整个工艺流程以及在某些环节都出现了一些变化。
上一篇:中国半导体封装产业长期看好
下一篇:未来的封装-多芯片集成