MEMS制造和封装的发展趋势
2011-08-30 22:20:37 来源:微迷 评论:0 点击:
尽管MEMS技术还没有IC级别的尺寸需求驱动,但并不意外着MEMS制造技术原地踏步。现在MEMS市场主要由消费电子应用驱动而实现快速增长:
1. 尺寸驱动:满足消费电子应用需求,如智能手机和平板电脑。
2. 性能驱动:高端应用,如航天航空。
3. 成本驱动:大批量应用,如手机、汽车和游戏机。
最新的MEMS制造、封装技术和特殊材料可以解决以上需求问题。MEMS技术已经从体微机械加工、表面微机械加工发展到SOI(Thick SOI、Thin SOI、Cavity SOI),下一步发展是:3D Integration和CMOS MEMS。
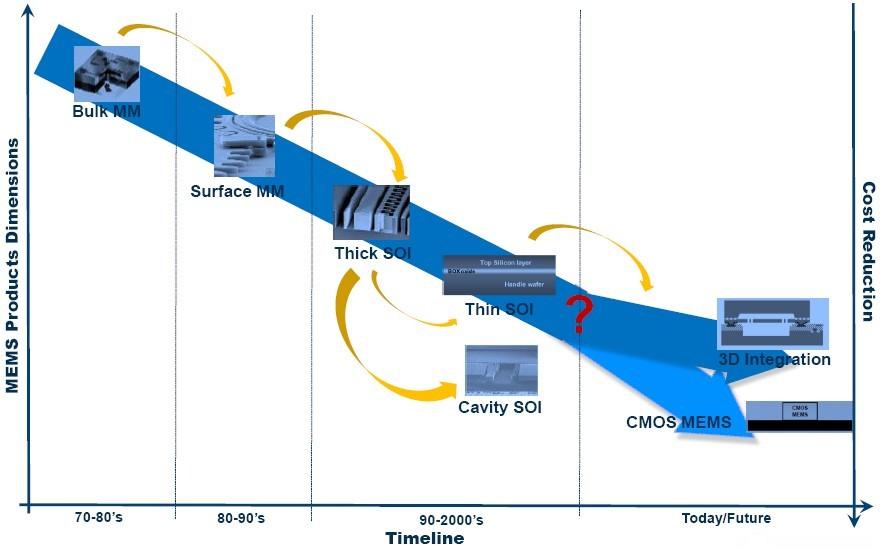
图1 MEMS制造工艺发展路线
DRIE和晶圆键合是技术演变的主要原因:在主流半导体业务中,它们越来越多应用于3D TSV。晶圆键合的直接竞争对手是CMOS MEMS方法。MEMS很少由技术创新推动发展,大多数情况下,要么为了使用微机械加工的MEMS来减少市场上现有的传感器,要么来自系统制造商的推动。使用CMOS工艺有时是历史的选择(CMOS技术比MEMS技术发展更快)。事实上,CMOS MEMS可能被限制在非常特殊的应用领域,如MEMS阵列要求非常密的电子加工技术。对于其它情况,MEMS制造和封装工艺取决于产品周期、灵活性、成本、集成、市场需求和功耗。

图2 MEMS集成技术路线图
通过分析MEMS制造和封装趋势,提出了MEMS传感器芯片在尺寸、功耗、成本及封装等方面预测:
| 2000 | 2010 | 2020 | |
| MEMS die size | 10 mm2 | ~2-3 mm2 | 1-2 mm2 |
| Packaged die size | 2x5x5 mm3 | QFN package (3.0 mm x 3.0 mm, height 0.9 mm) | < 1x2x2 mm3 |
| Power consumption | 0.1 mW | 0.05 mW | < 0.05 mW |
| MEMS ASP ($) | >$3 (3-axis) | $0.7 | <$0.5 |
| Volume (Munits) | 35 | 771 | >2500 |
| Major manufacturing evolution |
• 4” & 6” wafer size • Integrated MEMS from AD • Mostly wire bonding side by side |
• 6” and 8” emerging • SOI wafers and epiPoly Si approaches (3μ thick proof mass) • AD shifts to hybrid • Stacked/side by side wire bonded MEMS & ASIC |
• Mostly 8” wafer size • Capping is removed • ASIC becomes the active capping • 3D TSV implemented |
2011年,简化MEMS制造工艺仍然是一个重要目标。但是“一个产品,一套工艺流程,一种封装形式”的MEMS法则会持续多久?目前的研究工作试图克服MEMS法则,制定标准的流程。到2020年,MEMS代工厂很可能已开发出内部标准工艺模块,届时MEMS成本将大幅下降。
