旭硝子为半导体及MEMS封装推出创新型玻璃基底
2017-01-20 14:48:47 来源:麦姆斯咨询 评论:0 点击:

据麦姆斯咨询报道,玻璃、化合物及高科技材料制造商AGC Asahi Glass(日本旭硝子,简称AGC)公司近日宣布开发出专为半导体封装应用和半导体制造工艺支持设计的新型玻璃基底。AGC 会在2017年1月19日~20日在日本东京Big Sight 国际展示中心举办的日本国际电子元器件、材料及生产设备展览会(NEPCON JAPAN 2017)上展出这款新型玻璃基底。
主要的先进封装技术都将通过AGC的产品获益。在晶圆级封装工艺中,IC在晶圆上直接进行封装,推动了下一代半导体和MEMS器件的巨大进步。同时也推动了玻璃晶圆的需求增长,尤其是那些能匹配硅热膨胀系数(coefficient of thermal expansion, CTE)的玻璃晶圆,消除了当试图直接层压CTE值不同的硅和玻璃晶圆时发生的翘曲现象。
新款玻璃基底的另一个目标应用技术为扇出型晶圆级封装(fan-out wafer-level packaging, FOWLP),该技术强化了标准晶圆级封装技术,能够提供更小的封装尺寸,以及改善的热力学和电学性能,它连接了不同CTE值的材料,包括硅晶圆、再布线层和树脂等。各个器件的组合和图形各不相同,而玻璃基底能够为每个元件提供所需要的最优CTE。而且,普通玻璃中的碱性组份会在制造过程和器件中造成污染,因此,在某些特定应用中非常需要无碱玻璃。
AGC开发的新款玻璃基底专为满足广泛的客户需求而设计,能够提供矩形和方形的玻璃晶圆,当然也包括传统的圆形晶圆,可提供的晶圆厚度范围为0.2 mm ~ 2 mm。新款玻璃基底系列产品包括:
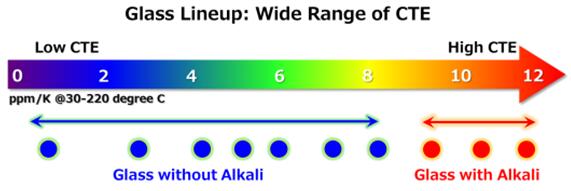
- 无碱玻璃:
* 能够从室温环境至250°C之间保持和硅一样的CTE
* CTE值覆盖宽泛(3 ppm/°C ~ 8 ppm/°C)
- 含碱性成分玻璃:
* CTE值覆盖更高的范围(最大可达12 ppm/°C)
延伸阅读:
上一篇:航空MEMS器件应用的非硅材料
下一篇:2016年全球硅晶圆出货量维持新高纪录
