看好扇出型封装市场,ERS携热剥离和翘曲调整设备大举进入
2019-03-02 11:01:29 来源:麦姆斯咨询 评论:0 点击:
微访谈:ERS首席执行官Laurent Giai-Miniet
据麦姆斯咨询报道,在Yole发布的《扇出型封装技术及市场趋势-2019版》和《面板级封装(PLP)技术及市场趋势-2018版》两份报告中,不同商业模式的主要参与者们都开始涉足扇出型(Fan-Out,FO)封装技术。“核心”扇出型(Core FO)市场也证实了其稳定性,大量新进入者通过扇出型面板级封装(FOPLP)加入市场竞争行列。尽管现有的扇出型晶圆级封装(FOWLP)厂商进入该技术领域已有一段时间了,但中端器件的成本还是过高。
力成科技(PTI)已投入资金开发,并为联发科(MediaTek)的LVM(Logical Volume Manager,逻辑卷管理器)进行FOPLP生产。FOPLP终将成为核心市场上经济高效的选择。在“高密度扇出”(HD FO)市场中,台积电(TSMC)通过推出高性能计算(HPC)应用的inFO-oS(on substrate),进一步扩展并稳固了其领先地位。同时,采用inFO-AiP(antennain package)和inFO-MS(memory-on-substrate)的新应用开发也令人兴奋。台积电同时还在打造名为超高密度扇出型(UDH FO)的新细分市场,具有非常激进的亚微米L/S路线图。三星电机(SEMCO)通过在三星Galaxy智能手表中采用FOPLP技术,用于包含应用处理器引擎(APE)+电源管理集成电路(PMIC)的扇出型封装,实现了新的里程碑。尽管就I/O分布密度而言,该封装技术仍被认为是Core FO,但相信不久之后,三星电机将走向高端,向台积电的苹果APE业务发起挑战。
据麦姆斯咨询介绍,FOWLP是目前增长最快的封装平台,已被应用于各种应用中,从移动设备到汽车再到医疗等,主要用于封装低端(例如音频编解码器)和高端器件(例如APU,加速处理器)。然而,与其它更成熟的封装平台相比,FOWLP的成本仍然是大家最关注的问题。终端客户也一直在致力于降低成本。而降低成本的方法之一是将扇出工艺从晶圆级封装向更大尺寸的面板级封装转移。这将带来大规模的经济效益以及更高的载板利用率,从而提升制造效率并降低整体封装成本。因此,FOPLP吸引了业内的巨大兴趣,不断有不同商业模式的参与者进入该领域,包括外包半导体封测厂(OSAT)、集成器件制造商(IDM)、代工厂、基板制造商和平板显示(Flat Panel Display,FPD)厂商等。他们已强烈感应到通过扇出型技术涉足先进封装领域的机会。经过多年的认证样品开发,FOPLP终于进入量产阶段,目前有三家厂商进入该市场,即PTI、NEPES和SEMCO。FOPLP市场规模预计在2023年将达到约2.8亿美元,2018~2023年复合年增长率高达79%。

2018年和2024年扇出型封装市场预测
图片来源:《扇出型封装技术及市场趋势-2019版》
FOPLP业务涉及不同的设备和材料供应商。其中德国ERS Electronic(以下简称ERS)是为FOWLP和FOPLP封装提供热剥离和翘曲调整设备的主要公司之一。目前ERS已经在FOWLP市场获得了广泛认可,针对不同的客户需求提供并安装了多款设备。对于FOPLP封装,ERS可提供手动、半自动以及即将发布的第一款全自动设备(ADM600SQ),用于最大可达600 x 600mm面板的热剥离和翘曲调整。就FOPLP设备而言,目前自动剥离技术仍然是发展瓶颈之一,ERS发布新设备则旨在解决此问题。
Yole技术与市场分析师Favier Shoo和Yole韩国分部负责人兼首席分析师Santosh Kumar非常荣幸能够有机会与ERS首席执行官兼首席销售营销官Laurent Giai-Miniet就FO和FOPLP技术的最新进展展开讨论,并对行业发展的看法进行了访问:
Yole:您能就ERS的发展历史、产品系列和现有进展简单介绍一下ERS吗?
Laurent Giai–Miniet(以下简称:LGM):在半导体晶圆测试领域,ERS在温度解决方案和热卡盘(thermal chucks)制造等方面拥有50多年的丰富经验。
自70年代初以来,我们向半导体晶圆测试市场提供了超过5000件热卡盘,其中约80%仍在使用中。
自2008年以来,凭借在温度管理领域的专业知识,我们扩展了公司的产品组合,为扇出型晶圆级先进封装市场提供热剥离和翘曲调整解决方案。我们在FOWLP封装涉足最多的领域是热剥离和翘曲设备,这使得ERS成为快速增长的扇出晶圆级封装(FOWLP)市场的主要参与者之一。到目前为止,客户通过使用我们的旗舰设备制造了超过20亿颗嵌入式晶圆级球栅阵列(eWLB)芯片。
经过多年的发展,FOPLP封装技术已成为现实,许多厂商已经在生产或计划在2019年进入大规模制造(High Volume Manufacturing,HVM)。ERS针对FOPLP的设备以及解决方案是什么?现在ERS可提供手动、半自动和不久即将面世的第一款全自动设备(ADM600SQ),用于最大可达600 x 600mm面板的热剥离和翘曲调整。这种用于剥离和翘曲调整的全自动设备的发布是塑封面板FOPLP制造中重要的里程碑。
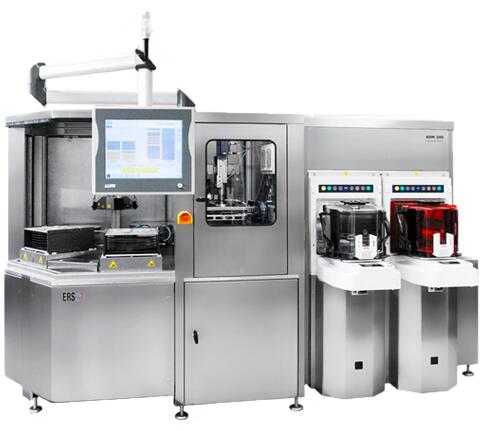
ERS提供的自动剥离机(ADM)
Yole:贵公司是否也积极投身于FOWLP市场?您认为目前的晶圆级封装设备是否可以支持面板级封装?或者您认为PLP设备需要重新设计吗?
LGM:目前我们的大部分业务仍然来自晶圆级封装(FOWLP)、热剥离和翘曲、自动或半自动机械设备。然而,ERS也在寻求大量采用面板级剥离的需求,甚至可为尺寸大至700 x 700mm的面板进行剥离。尽管事实证明这很有挑战性,但是从300mm和330mm的晶圆形式到方形或矩形面板,许多设备和技术仍然适用。
Yole:您如何看待FOPLP市场的演变?影响它被广泛采用的主要障碍是什么?
LGM:设备成本以及将设备从FOWLP升级到FOPLP的难度将是主要的障碍。此外,由于面板尺寸缺乏“统一标准”,因此阻碍了材料制造商对这些技术的快速采用和认可。

ERS提供的手动面板剥离机(MPDM700)
Yole:从经济性的角度来看,业界对面板级扇出封装的可行性仍持怀疑态度。因此,大多数参与者认为该行业还没有准备好,因为市场好未大到全面运作起来的规模。作为设备供应商,您如何回应这一问题?
LGM:也许很快扇出型晶圆级封装(FOWLP)就会出现过剩产能,随着需求的不断增加,我认为这个预测是合理的。考虑到2019年的经济环境,一些人可能会对升级到面板制造变得犹豫不决。与此同时,200mm FOWLP尺寸可能会变得过时,从本质上来说,人们对扇出技术封装的器件,如物联网、智能手机、汽车驾驶辅助设备等中的片上系统芯片(System on Chip,SoC)的需求正在迅速增长。
目前大家所持的怀疑态度主要来自于这样一个事实,即OSAT和其他公司正在为FOWLP封装技术积极部署产能,而对面板级封装的需求却仍在增长,从而导致了行业混乱。然而,eWLB和中小密度FOWLP仍然是重构晶圆最常用的方法。事实上,某些客户仍然对他们的200mm重构晶圆非常满意,eWLB仍然是重构晶圆最具成本效益的技术,无论是何种形式。
设备供应商面临的主要挑战之一是行业中面板尺寸缺乏标准化。事实上,每家公司都有自己的面板尺寸和工艺制程。
Yole:您是如何处理此问题的?
LGM:这无疑是一项重大挑战。在ERS,我们确保尽可能多地与半导体行业成员交流,以开发可扩展至600 x 600mm或710 x 650mm的解决方案。这种策略可防止我们被禁锢在特定面板尺寸。我们竭尽全力保持技术灵活性,并能够适应客户的需求。
Yole:就ERS目前来说,有哪些应用和市场可以改变行业格局以及改变在面板级封装领域领先设备制造商的地位?
LGM:最有可能推动FOWLP变革的应用和市场是片上系统芯片(SOC)、移动设备、汽车雷达和物联网(IoT)连接设备。此外,有竞争力的应用是大型系统级封装(System in Package,SiP),因为使用圆形的晶圆会出现良率问题。而如今,因为面板前道设备已经存在,FOPLP更是处于有利的位置。
Yole:一些FOPLP设备供应商利用了在平板显示器、印刷电路板和太阳能行业的经验。贵司是否也利用了其它行业的经验来设计和开发FOPLP设备?
LGM:目前,ERS在开发FOPLP设备时,利用了处理印刷电路板(PCB)的概念和平板显示(FPD)的经验。
Yole:FOPLP的关键技术挑战是什么?ERS的设备将如何解决这些问题?
LGM:在我看来,芯片偏移、面板翘曲和载板处理仍然是FOPLP的关键技术挑战。
在ERS,根据我们在温度管理方面的经验,以及对芯片偏移影响的透彻理解,能够预测和再现芯片偏移。这种热操作方面的专业知识也使我们能够创造出高水平的专有技术来解决不同FO结构的不同翘曲度。ERS是在高温下处理金属载板的专家。我们可提供自己的真空吸盘,以有效和可靠的方式处理此问题。如果载板处理不当,则会破坏剥离过程。ERS精心处理金属载板的经验使我们的客户能够获得更高的成本效益以及更高的良率。
Yole:您能描述一下贵公司FOPLP产品线的竞争优势吗?
LGM:ERS是为数不多的几家拥有量产经验的公司之一。自2008年年初以来,我们一直致力于温度解决方案的研发,目前该解决方案已经用于超过20亿颗芯片。
ERS在处理eWLB材料的经验无疑是一项巨大优势,因为它与FOPLP使用的材料相同。在慕尼黑eWLB Competency Center,我们已经加工了100块面板(方形或矩形)和其它重构晶圆类型,同时我们也向客户提供免费试用功能。当加工此类先进材料时,会出现多种问题,而我们相信ERS则是处理这些问题的专家。
最后,ERS一直致力于开发半导体行业的温度管理解决方案,拥有近50年的经验。这些经验使我们能够有效地防止和处理翘曲,而翘曲问题则是与温度相关的问题。
Yole:除了目前针对特定FOPLP制造挑战的设备系列外,是否还有其它挑战需要ERS在未来引入新的解决方案或设备?
LGM:我们目前正在开展一系列非常重要的项目,以解决半导体后道行业所面临的新挑战,例如需要高热均匀性(high thermal uniformity,HTU)的传感器晶圆测试。同时,我们还在开发一种专门用于MEMS测试的解决方案,以及用于前端制造中灰化(Ashing)工艺的温度管理解决方案。
Yole:您还有什么想和读者分享的吗?
LGM:当然。ERS目前聘请了一位杰出的行业专家Debbie-Claire Sanchez。她具有七年多的晶圆级封装领域经验,包括扇入型和扇出型领域。在DECA Technologies公司(位于菲律宾)工作五年,主要专注于扇出型晶圆和面板级重建工艺开发。目前她主要负责台湾的客户开发和相关技术转让。
延伸阅读:
《iPhone X中A11处理器的台积电第二代InFO封装》
推荐培训:
《MEMS制造和封测培训课程》将于3月29日至31日在无锡举行,本课程邀请MEMS业内优秀讲师,重点剖析MEMS产业链的重要环节:(1)MEMS制造工艺;(2)典型MEMS器件工艺流程(如MEMS麦克风、压力传感器、非制冷红外探测器、MEMS微镜、喷墨打印头等);(3)MEMS封装技术;(4)MEMS测试技术(如加速度计、陀螺仪、磁传感器、压力传感器、MEMS麦克风等);(5)关键工艺设备和材料等,为大家展现MEMS产业的全貌和重要知识点。如果您有兴趣,请联系:
麦姆斯咨询
联系人:郭蕾
电话:13914101112
E-mail:Guolei@memsconsulting.com
