成本和性能驱动,扇出型板级封装走向量产
2018-07-27 07:58:47 来源:麦姆斯咨询 评论:0 点击:
微访谈:nepes(纳沛斯)市场总监Jason Park
据麦姆斯咨询报道,FOWLP(扇出型晶圆级封装)是目前发展最快的封装平台,广泛应用于从移动应用到汽车再到医疗等各种应用领域的高端及低端器件封装。不过,相比其它成熟的封装平台,成本仍是其需要考量的因素,终端客户总是在不断地推动成本的进一步降低。
为了降成本,其中一种有效途径是将扇出型封装从晶圆级向大尺寸板级迁移。这能带来规模效益和更高的载具利用率,进而实现更高的制造效率,以及更低的单位封装成本。因此,扇出型板级封装(FOPLP)对业内各种不同业务模式的厂商都具有极大的吸引力,例如OSAT(外包半导体组装测试厂商)、IDM(集成器件制造商)、代工厂、基板制造商以及FPD(平板显示器)厂商等,它们都“嗅到了”通过扇出型技术涉足先进封装业务的机遇。

2017~2023年FOPLP市场营收预测
经过多年的开发、验证和出样,FOPLP终于进入规模量产,nepes(纳沛斯)便是最主要的市场进入者之一。nepes一直在为各种广泛应用进行产品开发,其传感器IC产品已经实现小规模量产,大规模量产预计将在2018年第四季度开始,预计将从2019年开始爬升至满产能生产。一旦FOPLP实现全面量产,其市场营收预计将在2023年达到约2.80亿美元,2018~2023年期间的复合年增长率(CAGR)高达79%。

板级封装平台的市场驱动因素
目前,全球仅有三家厂商的FOPLP将在2018年最终进入量产,它们分别是:Powertech Technologies(PTI)、SEMCO以及nepes。而且,nepes已经自2017年开始了小规模量产。nepes具备面板级工艺经验(例如LCD封装),并相信能够将这些经验应用于PLP。Yole韩国分公司封装、组装和基板业务部总监以及《板级封装(PLP)技术及市场趋势-2018版》报告作者Santosh Kumar,近期有幸采访了nepes市场总监Jason Park先生,与其交流了nepes对FOPLP技术及市场的见解,以下为访谈内容。

Santosh Kumar(以下简称SK):请您简要介绍一下nepes及其主要业务。
Jason Park(以下简称JP):nepes是晶圆级封装、板级封装和一站式组装解决方案(包括测试和DPS服务)领先供应商。自2001年起,nepes就已经开始和全球的Fabless和IDM客户合作,为它们提供OSAT服务。nepes提供的封装业务包括:bump、WLP、FOWLP和FOWL-SiP,以及2D和3D模组等。nepes的PLP解决方案革新了先进半导体封装的规模制造,通过利用创新的工艺、广泛的触摸面板(TSP)结构以及LCD制造经验,提供了极具竞争力的成本优势。
SK:nepes是首批开始FOPLP生产的厂商之一,请您介绍一下FOPLP技术。
JP:面板级封装(PLP)是一种芯片在长方形或正方形面板上组装或封装的工艺。FOPLP是扇出型封装向方形面板的迁移。采用创新的工艺和结构,FOPLP提供了一种能够改善生产同时降低制造成本的解决方案。
SK:请您介绍一下nepes的FOPLP生产现状及发展计划。
JP:FOPLP正在持续开发各种应用的相关产品。目前,传感器IC已经处于小规模量产,大规模量产预计将始于2018年第四季度,2019年将实现满产能运行。
SK:nepes是一家成熟的FOWLP厂商(具有RCP再分配芯片封装技术),而且,这是一块快速增长的市场。nepes再投资FOPLP产线的原因是什么?
JP:先进封装解决方案已经广泛应用于各种不同的领域,例如汽车、移动、电视等等,并且它们的尺寸正不断变得更薄、更小,同时性能和集成度更高。然而,先进封装解决方案并不足以实现成本的显著降低。因此,nepes基于我们现有的扇出型技术和LCD制造经验,开发了FOPLP。此外,自2011年开始,nepes就具备了混合封装制造技术,该技术结合了应用于触摸面板的LCD产线。另外,我们的FOWLP大规模制造经验可以追溯到2009年。
SK:从经济性的角度来看,业界对于面板级扇出封装的可行性还存在一些疑虑。大多数厂商认为,相关产业尚未准备好进行面板级扇出,因为还没有足够的市场来支持产线的产能。您对此有何看法?
JP:当前,面板级扇出确实还没有足够的市场来填满FOPLP产能。不过,半导体业务和现在的IT市场,以及未来的5G、自动驾驶汽车和医疗等新市场,都将处于第四次工业革命的中心。此外,堆栈式封装等下一代封装技术和2.5mD封装的协同优势,预计将进一步推动FOPLP应用增长。

SK:就芯片/封装尺寸而言,扇出型板级封装的最佳定位是什么?对于所需要的封装尺寸,转向面板级封装预计能够降低多少成本?
JP:对于现有的6 x 6封装和更大的封装尺寸,客户希望能够降低30%的成本,我们的目标便是满足这个要求。
SK:你们FOPLP的目标应用和目标器件领域是什么?
JP:FOPLP已经用于许多市场应用中的各种传感器。nepes正瞄准智能手机(市场规模大,可以优化产线)传感器件,以及指纹识别传感器,这些可以体现PLP的降成本优势。
SK:平均来看,其成本水平如何?
JP:多芯片封装是主要产品,但是,很难给出平均价格,因为根据芯片/元件的量,成本是变化的。我们的目标是相比现有封装技术,降低20~30%的成本。实现这一目标将有助于我们推动PLP增长。
SK:许多设备供应商已经为板级扇出技术开发了机台。就您看来,相关设备供应链还有哪些问题需要解决?
JP:相比现有300mm FOWLP晶圆尺寸,FOPLP面板由OSAT厂商开发了很多不同的规格。FOPLP具有超出很多标准的最大尺寸(600 x 600mm)。最终,它将需要溅射、光刻、电镀和刻蚀等设备的标准化,以满足各种规格要求,实现基础设施的自动化。
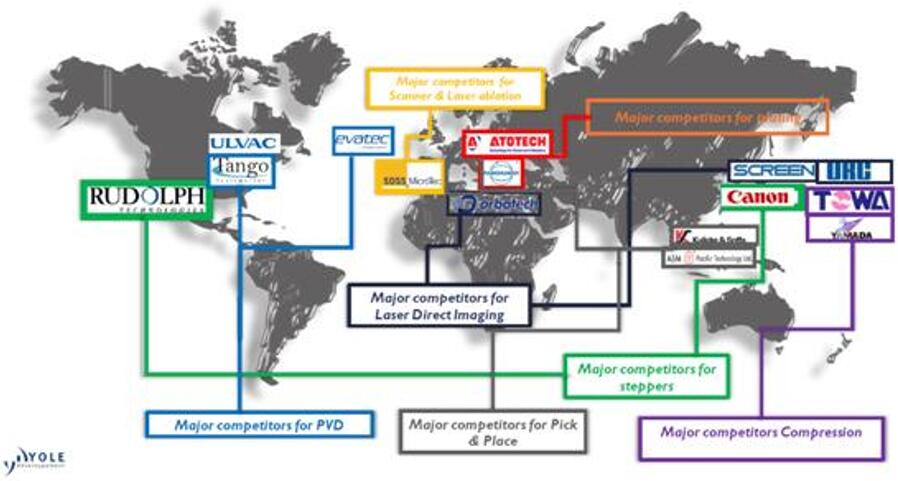
PLP设备供应商概览
SK:FOPLP相对于FOWLP,在注塑化合物材料、介电材料和电镀化合物等材料方面是否有特殊要求?
JP:对于FOPLP,主要的工艺控制问题是芯片漂移和翘曲控制。材料技术的发展可以提高封装性能,同时改善这些问题,因此,对材料的要求是持续不断的。另外,nepes作为一家FOPLP领导者,对于供应商开发的材料的大批量生产评估,能够通过和供应商合作,确保其成熟度和可市场化。
SK:FOPLP主要技术挑战是什么?你们是如何解决的?
JP:如之前所述,对于FOPLP的芯片漂移和翘曲控制,nepes设计了有效的方法来改善这些问题,成功实现了小规模量产。
SK:您认为FOPLP市场将如何发展?阻碍其获得更广泛应用的主要因素有哪些?
JP:目前,核心扇出型产品和高密度扇出型产品共存于扇出型市场。FOPLP旨在成为现有扇出型方案的低成本方案,并将最终提高高密度扇出型产品的开发完成度。不过,在一定时期内,易于应用的核心扇出型产品可能会实现大规模量产。
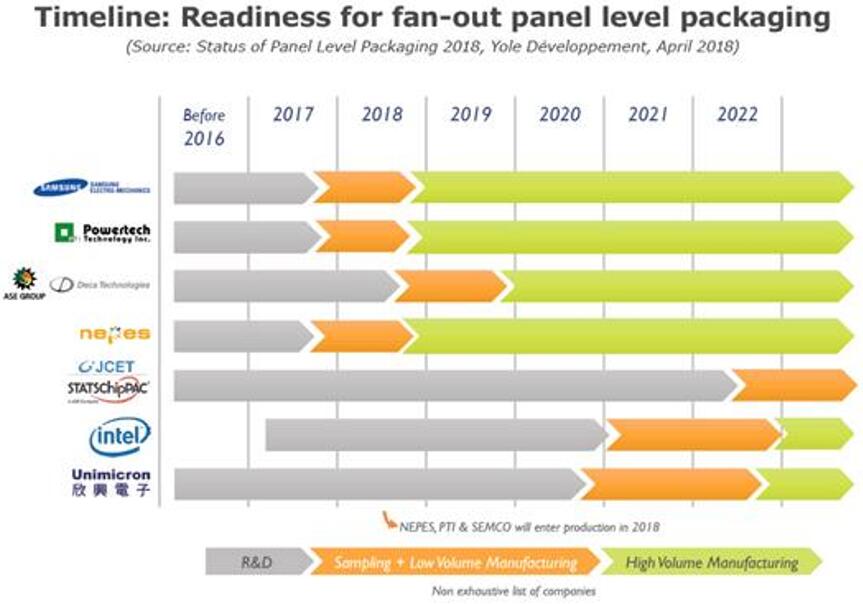
市场主要厂商对扇出型板级封装的准备情况时间轴
SK:未来五年,就RDL和 L/S,以及层数、间距、厚度、尺寸等封装设计参数而言,nepes的FOPLP发展路线图将会如何规划?
JP:上述核心扇出型产品(又称传统扇出型产品)预计将覆盖L/S 10/10和500 I/O。但是,要大规模生产高密度扇出型产品,必须能够实现低于L/S 5/5和超过500 I/O。此外,nepes目前正在开发一种最小化多层结构的封装厚度,并将在2018年第四季度FOPLP大规模量产后,有助于提高TRM市场知名度。
延伸阅读:
上一篇:从MMIC芯片到解决方案,意行半导体打通汽车雷达自主产业链
下一篇:华芯半导体:掌握VCSEL核心制造技术,本土化团队扛3D传感VCSEL国产大旗
