航天771所某款TSV无源硅转接板研制成功
2019-12-04 16:32:40 来源:微迷 评论:0 点击:
当前摩尔定律趋缓,三维封装技术作为新的发展方向,成为半导体行业关注的重点和厂商竞逐的焦点。硅转接板具有超薄厚度、超高互连密度、高深宽比硅通孔(TSV)、细线宽和小线距再布线层(RDL)等特点,航天771所先进封装生产线以项目为牵引,以先进的工艺平台为支撑,通过设计优化、工艺重组、流程再造,成功实现某款基于TSV+RDL无源硅转接板的研制,并完成小批量生产,良率达到业内先进水平。
771所面向TSV系统级封装技术的应用,经过TSV深孔刻蚀、电镀铜填充、多层再布线、晶圆减薄等单项工艺攻关,凭借优质的过程控制,TSV无源硅转接板可减薄至175μm,TSV互连面积密度达40/平方毫米,TSV孔深/孔径达150μm/30μm,多层布线结构为2P3M,RDL线宽/线距达10μm/10μm,大幅度降低了互连长度,提高了集成度。硅基微系统组装前,TSV无源硅转接板主要通过光学方法实现制造过程中的即时监测,电学方法实现成品测试与筛选。其中,TSV无源硅转接板成品通断测试覆盖所有焊盘和网络,满足导通电阻<10Ω,绝缘电阻>10MΩ的通断测试规格,保证了严格的产品品质,并通过三个连续批的验证。
目前,TSV无源硅转接板已成功应用于某组件,如图1所示。该组件实现了存储器芯片+硅转接板+处理器芯片+硅转接板的四层立体堆叠,经过应用验证,满足三维系统级封装使用要求。
此款基于TSV+RDL无源硅转接板的研制成功和小批量生产的实现,标志着771所已具备2.5D/3D TSV Interposer设计、研制及批量制造能力,为771所后续微系统产业发展提供关键技术支撑,也为TSV三维封装产业化的实现奠定坚实基础。
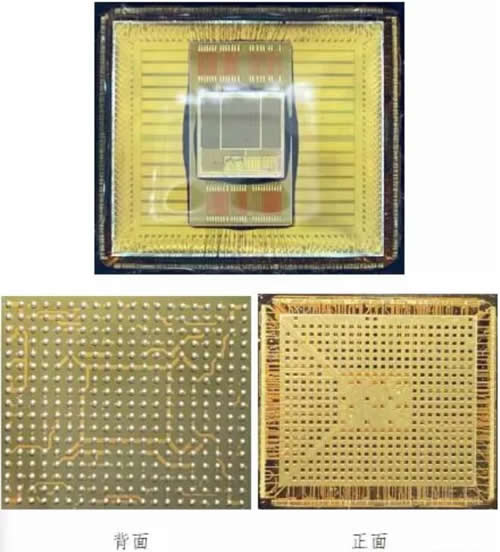
某组件及TSV无源硅转接板
延伸阅读:
上一篇:中南地区最大的微纳器件加工实验室在湖南落成
下一篇:苏州MEMS中试平台名列前茅,积极布局压电MEMS并筹建8寸线
