航天七七一所实现硅通孔(TSV)产品小批量生产
2019-08-31 16:25:47 来源:微迷 评论:0 点击:
近期,航天七七一所通过集智攻关,成功实现了TSV硅转接板、等壁增长TSV、超大面阵凸点三种封装形式产品的研制及小批量风险可控生产,良率达到业内水平,可靠性试验满足客户要求,并通过了国内知名半导体公司二方审核。
基于TSV技术的产品具有全局互连短、延迟小、灵活性高、高密度集成等优点,是先进封装的核心技术,也是实现三维集成的最优途径。近期,航天七七一所通过集智攻关,成功实现了TSV硅转接板、等壁增长TSV、超大面阵凸点三种封装形式产品的研制及小批量风险可控生产,良率达到业内水平,可靠性试验满足客户要求,并通过了国内知名半导体公司二方审核。
据麦姆斯咨询介绍,航天七七一所先进封装生产线通过优化原材料、设备、工艺、流程等,完成了TSV制备及填充、等壁电镀RDL、多层再布线、电镀微凸点、无空洞回流等工艺开发,并实现产品指标:TSV孔径/孔深30μm /150μm、10μm /100μm、5μm /50μm;多层布线层数3P4M;凸点直径/高度70μm/90μm;单片凸点数量≥4000个。完成三种封装形式产品小批量生产,为后续三维微系统集成提供了技术支撑,为产业可持续发展做好了技术保障。
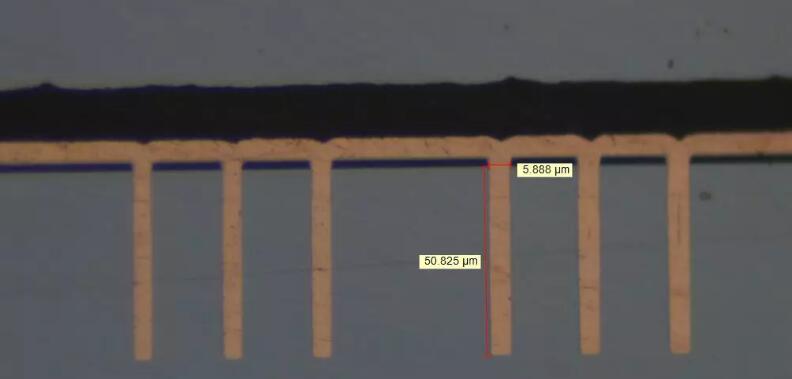
图1 孔径/孔深:5μm /50μm TSV电镀填充结果图
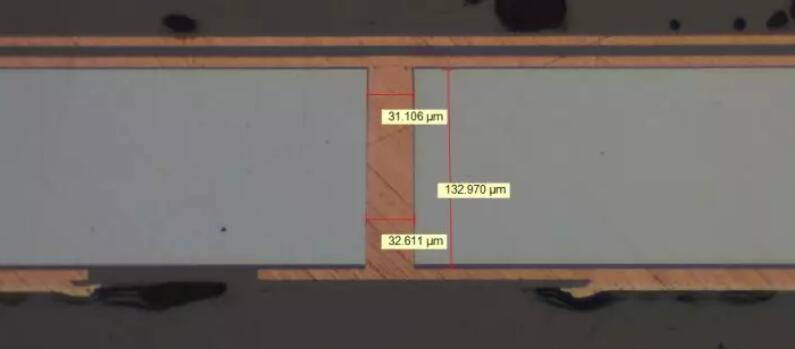
图2 孔径/孔深: 30μm /150μm TSV硅转接板剖面图
上一篇:中科智芯晶圆级扇出型封装即将投产,补强徐州短板
下一篇:柯泰测试田铮:VCSEL测试服务八字口诀“快速、合适、解决方案”
