新加坡A*STAR创新工艺有望使MEMS更小、更可靠、成本更低
2018-03-25 13:28:33 来源:麦姆斯咨询 评论:0 点击:
目前,MEMS(微机电系统)器件已经广泛应用于从安全气囊系统到显示屏再到喷墨打印头等各个领域。它们集成了微型机械和电子元件,整体尺寸也非常微小。不过,现在的MEMS制造技术的成本相对较高,且在微米及亚微米级器件的制造精度方面不够理想,因而,进一步缩小MEMS器件的尺寸挑战很大,这无疑限制了MEMS器件未来的预期潜力。
据麦姆斯咨询报道,新加坡科技研究局A*STAR的Vladimir Bliznetsov等研究人员开发出了一种新的MEMS器件制造方法,能够大幅改善当前微米及亚微米级MEMS器件制造的成本和精度问题,有望显著提高MEMS器件的精度和可靠性,并降低其制造成本。
“MEMS正在紧跟电子产品小型化的大趋势,器件制造尺寸从几十微米逐步缩小到1微米以下,”Bliznetsov说,“但是,目前制造这种尺寸级别器件顶部金属接触的技术,成本很高且可靠性较低。”
目前MEMS器件加工中形成5微米及以下通孔(vias)和锥形侧壁的方法,并不可靠。例如侧壁聚合刻蚀,由于底部宽度显著缩小而并非最优方案;另一种方法,涉及到光刻胶层转移到蚀刻层中,由于光刻胶掩模的过度损失而限制了通孔的最大深度,导致不可接受的粗糙侧壁。
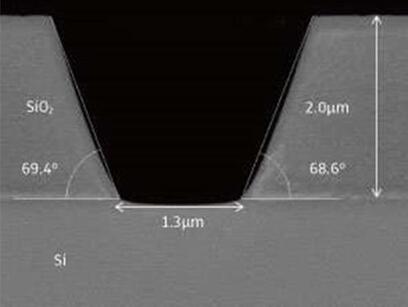
采用新型两步等离子刻蚀工艺制造的锥形开口
为了解决上述缺陷,A*STAR研究人员开发出了一种两步等离子刻蚀工艺。首先进行光刻胶锥型化,将光刻胶由垂直改变为锥形轮廓,然后进行对光刻胶有更好选择性的侧壁聚合氧化物刻蚀。利用这种方法制造的通孔最小尺寸可降低至1.5微米,且能得到约70度角的平滑侧壁。
“我们结合了两种在刻蚀工艺中通常有害的效应——加速的拐角溅射(corner sputtering)和侧壁聚合。”Bliznetsov解释称。
结合这些过程的两步工艺,能够更好的控制刻蚀工艺,制造出具有平滑锥形侧壁的微米级通孔。通过降低通孔的侧壁角度,可以制造出保护更好、具有更可靠金属触点的器件,大幅提升器件性能。
“精确控制侧壁角度已经在许多应用中得到实践,我们正计划制造功能性磁存储单元,该应用需要特定角度侧壁的磁性材料柱体,”Bliznetsov说。
该工艺预计还将在生物技术和医疗领域获得许多应用。
延伸阅读:
上一篇:美国布朗大学开发出新的黏附力测量方法,帮助解决MEMS器件黏附难题
下一篇:GLOBALFOUNDRIES启动射频生态系统计划,加速无线连接、雷达及5G应用的上市
