Teledyne DALSA - MEMS代工领导者
2013-03-09 21:05:52 来源:微迷 评论:0 点击:
提纲:
1.引领未来发展方向
2.我们出色的MEMS工具箱
3.引领集成MEMS的发展方向
4.MEMS设计服务:我们帮助您将设想转化为现实
5.200mm和150mm MEMS生产能力
6.追求卓越的质量和客户服务
1. 引领未来发展方向
Teledyne DALSA 是世界上第一流的MEMS纯代工厂之一。
我们的独特优势是什么?毫无疑问我们的独特优势在于我们拥有广泛和独有的晶圆制造的全部技术。 通过几十年来的研究、创新和工艺开发而积累的丰富经验,使我们深刻理解MEMS的物理和材料学原理。我们的MEMS制程模块组合受到客户的广泛认可,为我们的客户提供真正的竞争优势。 我们的能力体现在:我们能够将客户的设计迅速、顺利地转化为量产。
只要您需要,Teledyne DALSA 就能凭借其丰富的经验将您的突破性设计从概念转化为现实。 我们借助独有的优化架构、性能和可靠性的能力,为各行各业的高量产、关键任务的微系统提供服务。
Teledyne DALSA的另一项独特优势在于我们不仅具有很强的MEMS设计能力,而且具有很强的确保MEMS器件最佳性能所需的高压驱动器的设计能力。Teledyne DALSA无与伦比的定制MEMS和高压ASIC设计服务能提供组件或完整解决方案,让您的MEMS应用发挥最大的潜力。
凭借获得ISO/TS 16949认证的严格质量体系和专业的客户服务,我们为您提供量身定制的成功方案。
2. 我们出色的MEMS工具箱
Teledyne DALSA为客户提供一个真正无可超越的工具箱。该工具箱包括了几十种可靠、荣获专利的制程模块和技术,以及一些卓越的增值服务:包括定制设计、测试开发和先进封装等。
我们提供关键性的表面和体硅微加工技术: 包括高深宽比和高吞吐DRIE、对于1:1深宽比的洞穴、蚀刻深度最高可达875µm、蚀刻速度最高可达35µm/min。 对于穿透硅互连,我们的DRIE能力包括支持23:1宽深比和90-91° 角度,蚀刻速度可达9µm/min,并且支持侧壁粗糙度<90nm、宽深比最高为35:1的精细蚀刻,并可控制垂直角度(89.7-90.3°) 和倾斜度(<0.5°)。我们还支持其他角度,例如60°。为各向异性湿法蚀刻提供另一种备选方案,从而提高产能和设计灵活性。
在低温/高导现场掺杂多晶硅用作结构材料和TSV技术方面,我们处于领先地位。我们的专有无水HF释放配方消除蚀刻后粘滞和衍生残留物。
低应力SiN是我们的另一项专长。它在无水HF释放期间起到保护作用,并且作为结构材料结合其他硅特性平衡应力。我们还提供全面的高宽深比厚牺牲剂或永久性聚合物(光致成像和硬质掩膜)以及获得专利的薄膜沉积技术。
我们独有的制程工具箱还包括凸点制备(包括Ni/Pd UBM)、CMP、背面研磨和切割。 铝薄膜上的无电镀镍和钯镀层支持同一表面上的可焊接和线焊镀层灵活性,并且支持与其他晶圆进行锡基键合。键合是我们的专长领域之一。我们可进行多种技术整合。全面的技术方案包括Si-Si、Si-SiO、SiO-SiO、熔合、焊接、热压缩、玻璃封接、阳极键合、真空、等离子辅助、聚合物和临时键合。
我们对我们的制程工具箱非常自豪,但是对能灵活地这个运用工具箱更为自豪。 对于客户来说,Teledyne DALSA的最大价值在于我们能够利用和 集成各种制造工艺,将您的突破性MEMS设计转化为实际产品。下面将更多地介绍我们的集成MEMS技术。

硅深反应离子蚀刻(DRIE)
* 高蚀刻速度 (40 µm/min)
* 深度高达875 µm, 极高深宽比
* 斜角蚀刻能力 (比如 60°)
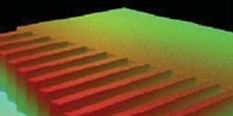
无水HF释放
* 专有配方消除粘滞和残留物

低应力SiN
* 机械应力 = 175 MPa
* 绝缘强度 > 4.8 MV/cma

原位掺杂聚合物ISDP
* 阻抗 0.65 µOhm•cm
* ISDP 应力 = -25 MPa
* 应力梯度 = 3.0 Mpa/µm

厚聚合物
* 涂层厚度: <40 µm
* 开发: 深宽比 5:1, 1 µm 特性
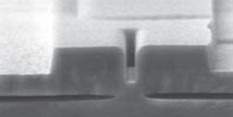
低温 SiO2, PECVD, SOG
* 低温 SiO2: 300 nm – 1 µm
* PECVD: 100 nm – 10 µm
* HF 完全释放
* SOG: 100 nm to 2.0 µm; HF快速释放
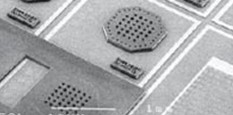
晶圆键合
* Si-Si, Si-SiO2, SiO2-SiO2, 融合, 焊接, 热压缩, 玻璃封接, 阳极键合, 等离子辅助, 聚合物和其他

金属和镀层
* AlCu, AlSiCu, Ti/TiN, Ge, Cu, Ni, Pd, W, 和其他
* 铝基片上的无电镀镍和钯镀层

研磨和切割
* 薄膜可达 30 µm
* 盘曝光梯度
* 机械释放结构的切割, 无需顶盖晶圆
3. 引领集成MEMS的发展方向
Teledyne DALSA 以其丰富的先进制造策略经验而闻名。这些策略包括通过叠加电路减小封装尺寸或 使用逻辑电路组合MEMS和CMOS晶圆以集成传感和执行功能等。利用我们3D的丰富经验和晶圆级 封装技术,包括穿透硅互连和各种键合技术,Teledyne DALSA 可以帮助您超越传统的设计限制。
TSV是3D集成MEMS的关键技术。通常TSV可以分为“Via-First”或者“Via-Last”两类,两者之间主要的区别是“Via-First”TSV是在Bonding之前从而可以承受几百度的高温;而“Via-Last”TSV工序是在Bonding之后,必须在足够低的温度下进行,以防止损坏后端CMOS层。
TSV - Teledyne DALSA 长期致力于提供高深宽比 TSV(深度 > 400 µm)和高压运行、热氧化隔离,并且可以提供镍/钯镀层和深孔和标准切 割,而不需要“盘曝光”工序。 我们在使用性能更高的铜填充工艺(阻抗更低、散热更好,可提高运行频率和功率密度)升级我们现有的先钻孔低阻抗 ISDP 填充工艺(430µm深度典型阻抗 < 1 Ohm、电容 < 10 pF)。 这种新型铜填充工艺十分适合使用高蚀刻速度 Bosch DRIE工艺进行量产,最高可以将 DRIE 工序成本降低50%。
Teledyne DALSA 的Via-First TSV技术可以利用沟槽填充(in-situ doped poly原位掺杂多晶硅)作为导体,或者如果需要较大的通孔,MEMS芯片本身可以作为导电区,这时沟槽仅用于提供电隔离。在150mm和200mm晶圆上我们都可以提供这项技术。
在200mm晶圆的线上Teledyne DALSA 的Via-First TSV技术将采用铜通孔填充,这个技术使用的是Alchimer的低温电化学制程。该技术生产出仅5微米直径,100微米深的完美填充的通孔,利用铜重分布层和Ni / Au UBM作为与外界的导电连接。

平坦化后的100µm 直径的被聚合物填充的环沟
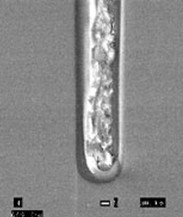
原位掺杂聚合物填充沟槽
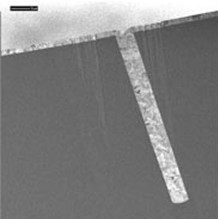
平坦化前的5um铜填充沟
晶圆级封装Wafer Level Packaging (WLP)
实现表面可安装 3D IC,使用晶圆级封装大大减小封装尺寸和外观尺寸,并且降低成本,是移动应用的理想选择。 Teledyne DALSA 的先进I/O 方案包括用于叠晶片的 µBGA、可焊接盘或标准盘和用于振荡器、压力及图像传感器的封联合封装设计,以及用于射频滤波器、微流体和SI 麦克风的非密封联合封装设计。
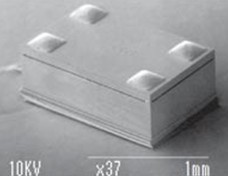
晶圆级封装
从手机使用的射频芯片到电信设备使用的光交叉连接器和烟雾探测器使用的化学和微粒传感器、游戏控制器使用的惯性运动传感器、汽车压力传感器和微型医疗系统使用的微流体装置,集成的MEMS推动着 各种各样的创新。不但降低设备的尺寸和功耗,同时提高它们的性能。
Bio-MEMS:单芯片上的微流体和实验室
在整合MEMS、高压CMOS和影像技术以开发和制造Bio-MEMS和综合性生命科学应用方面,Teledyne DALSA处于领先地位。Teledyne DALSA制程工具箱中的微流体和 高压-CMOS工艺可用于创建革命性的Lab-On-Chip技术平台。我们的优势在于:我们能够满足独立关键性产品的高度集成需求。 我们先进的封装技术和可靠的量产能力使我们成为您理想的能改变未来的Bio-MEMS设计的制造伙伴。
任何的医疗应用中使用的MEMS器件都可以被称为BioMEMS,在这里我们特指带有微流体部分的MEMS器件,比如集成毛细管电泳仪(在下面的图中是该种器件的一部分)。微流体管道是通过在一片使用Teledyne DALSA的高压CMOS/DMOS技术制造的集成电路上形成一层带光致图形的厚聚合物层来形成的。这个器件也同时设有使用我们的CCD制程的彩色滤光片,和耐腐蚀性的化学镀镍/钯层。
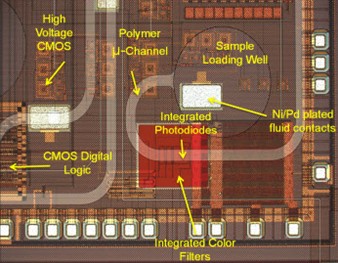
集成MEMS毛细管电泳仪器件
我们的长处是在于我们在设计制造独立的保健产品达到客户和市场需要的高集成度的能力。我们提供的先进的封装策略选择和经受考验的大批量制造能力使我们成为客户理想的Bio-MEMS代工合作伙伴。
运动传感器:加速度计、陀螺仪和惯性测量单元(IMU)
MEMS运动传感器近年来在手持设备和汽车领域具有广泛的应用,而且趋势正在加快,应用越来越广。设计者们和厂商都看到了运动传感器的应用和市场潜力。

在Teledyne DALSA的MEMS工具箱中有一个子集是为加速度计,陀螺仪和惯性测量单元配备的。这其中关键的制程模组包括 深反应离子刻蚀(DRIE), 聚合物硅通孔(poly thru-silicon vias), 和晶圆键合 –包括为实现高Q值陀螺仪的真空下晶圆键合。我们 特有的研磨和CMP技术使得我们不再需要昂贵的SOI晶圆。我们的制程是为完全的晶圆级封装设计的,可以实现晶圆级ASIC和MEMS硅片封装,通过铜填充的硅穿孔(TSV)连接外部I/O接口。
微镜 Micromirror Fabrication

在制造高性能的静电微镜方面,Teledyne DALSA拥有业界无与伦比的经验。静电微镜器件已经广泛地应用于电信和通讯系统的可变光衰减器(VOA)或波长选择开关(WSS)功能,和一些应用例如微型投影仪的激光束控制。微镜的制造需要非常严密的单晶硅层控制来保证微镜本身的高品质金属沉积和多个微镜偏转一致,而关键技术包括SOI器件层转移(SOI device layer transfer )和体微机械加工(bulk micromachining )。
污染的来源也是被严格控制的,在反射镜面的单一颗微粒可以降低整个微镜的光学等级。我们开发了特定的电光测试例程来保证每个晶圆甚至每个器件符合产品规格。
Micromirror 微镜驱动

微镜细节图
我们参与制造的微镜阵列的经验是我们认识到,市场上没有现成的微镜阵列驱动和控制的解决方案可以满足现有不同产品和应用的需求,所以我们自己设计了使用Teledyne DALSA高压CMOS技术生产的驱动和控制ASIC。它们是240V, 96 通道的 DH9685 (数字)和 DH9665 (模拟)。我们的工程师团队也可以为客户设计完全订制的高压ASIC驱动和控制电路,来满足客户在微镜和其他MEMS应用的需求。
4. MEMS设计服务: 我们帮助您将设想转化为现实
如果您知道您的MEMS解决方案需求,但是没有足够的开发和设计能力将它转化为现实,您应该怎么办?答案很简单:您可以将设计和制造任务交给 Teledyne DALSA。 我们与客户进行密切的合作:认真分析客户的构想、草图或CAD,制定详尽的设计方案,从详细规格定制、模拟、3D视图、MEMS 版图、掩模、原型、验证、特性分析和封装直到量产,全程管理您的定制项目。
利用我们深厚的MEMS 技术专长和专业化的工程设计支持 (EDA) 工具,我们将您的要求转化为定制的专用解决方案,为您带来独出一格的性能和真正的竞争优势。凭借我们独特的技术组合,专业的设计人员和丰富的MEMS和控制逻辑和高压执行器集成经验,我们可以最大限度地缩短设计周期和开发时间,确保您的设计概念符合规格要求。 我们的服务包括设计模拟、有限元分析和自动化静电放电分析、帮助发现和避免设计和生产问题以最大限度地提高良品率。凭借丰富的经验和深厚的MEMS制造技术,我们可以轻松地将您的设想转化为现实。
Teledyne DALSA还提供高压ASIC设计服务。许多MEMS(例如喷墨打印机打印头、微镜器件和微流体装置)都需要高压ASIC才能够运行。
MEMS是大型系统中的组件、通信和控制接口对于系统整体性能而言至关重要。若缺乏高压技术,MEMS设计人员将不得不采用现货供应原厂高压驱动器,从而难以进行产品优化和获得差异化竞争优势。 我们的定制高压设计服务可以为您打造全新的面向应用解决方案,性能完全高于任何现货供应产品。
让Teledyne DALSA的定制设计服务帮助您抓住您遇见的MEMS机会,即使您不是MEMS设计人员。

如果性能要求很高,则必须使用定制解决方案。 Teledyne DALSA高度定制化MEMS设计服务让您充分享受我们丰富的MEMS和高压驱动ASIC经验所带来的好处,提供完全合符您的要求的解决方案。
5.200 mm和150 mm MEMS生产能力
200 mm MEMS生产能力
Teledyne DALSA的 8英寸MEMS生产线提供了更高的产能,并且支持8英寸的MEMS晶圆和CMOS晶圆的晶圆级键合。我们的150毫米和200毫米MEMS线之间有一个高度的通用性,如果需要,大多数应用上运行150毫米的可以被转移至200毫米。
Lithography光刻技术
• 5X front to front (ASML) 0.35 µm feature, 0.1 µm 精度
• 5X front to back (ASML) 0.35 µm feature, 0.2 µm 精度
• 1x front to front 3.0 µm feature, 0.5 µm 精度
• 1x front to back 3.0 µm feature, 0.75 µm 精度
Positive and negative resists 正负抗蚀
• Dry film lamination of photo-definable thick polymers
• Spin coating of thin and thick photoresists and photopolymers
Plasma Deposition等离子体沉积
• PECVD TEOS, nitride.
Etching蚀刻
• DRIE (SPTS)
• RIE oxide, nitride , silicon, polysilicon, metals
• Anisotropic silicon wet etch (TMAH, KOH)
• Wet isotropic etch of oxide and aluminum
• Vacuum priming/drying, dry lift-off.
Furnaces: Vertical
• Wet/dry oxidation
• LPCVD Nitride (including low stress)
• LPCVD TEOS
• LPCVD silicon (in-situ doped)
• SAM coating
Metallization金属化
• Sputter: AlCu, Au, Cr
• Electroplated : Cu, Sn, Au, Au-Sn
• Electroless plating NiPd, NiAu
Wafer Bonding晶圆键合
• Si-Si, Si-SiO2, SiO2-SiO2, eutectic, polymer
• Au-Au, Au-Sn, Al-Ge
Wafer Thinning晶圆薄化
• Backgrind, edge grinding
• CMP, oxide CMP, Copper CMP
Metrology (in-line) 计量
• Automated CD & alignment measurement
• White light Interferometer
• Surface profiler
• IR metrology and inspection
• Spectroscopic reflectometer
• 100% Automatic Visual Inspection
Dicing切割
• Automated taping/dicing
• UV backing and cover tapes
Test测试
• Keithley Parametric testers
• Automatic probers
• MEMS electrical, optical and acoustic testing
• Test development service for MEMS
• Customer specific test systems
150 mm MEMS生产能力
Teledyne DALSA 提供了一个无可超越的MEMS工具箱,包含各种经受考验的和具有专利的模块和技术。我们为我们的MEMS工具箱自豪,但我们更加为我们掌握和使用它的能力自豪。 Teledyne DALSA给客户提供的最大价值是在于我们能充分利用和整合各个单独的制程从而把 客户的突破性的MEMS设计带向生产。
Lithography光刻技术
• 5X front to front (ASML) 0.35 µm feature, 0.15 精度
• 5X front to back (ASML) 0.35 µm feature, 0.2 µm精度
• 1X front to back (EVG) 2.5 µm feature, 2 µm精度
• 1X front to front (MPA) 2.5 µm feature, 1.2 µm精度
• Positive and negative resists, DUV bake
• photo-definable thick polymers 可光照定义的厚聚合物
• dryfilm lamination. Dryfilm层压
Plasma Deposition等离子体沉积
• PECVD oxide, TEOS, nitride, carbide
Etching蚀刻
• DRIE (SPTS)
• RIE of oxide, nitride , silicon, polysilicon, metals
• Anisotropic silicon wet etch (TMAH, KOH)
• Wet isotropic etch of oxide and aluminium
• Anhydrous HF oxide etch
Furnaces : Horizontal, Vertical
• Wet/dry oxidation
• POCL doping
• Nitride (including low stress)
• LPCVD oxide (LTO, SG/PSG, TEOS)
• LPCVD silicon (poly, amorphous, in-situ doped)
• SAM coating
Ion Implantation离子注入
• Low Current , High Current
• Species: B, BF2, P, As. Energy : 30 keV to 200 keV
Wafer Bonding晶圆键合
• Si-Si, Si-SiO2, glass frit, anodic, Al-Ge eutectic, polymer
Wafer Thinning晶圆减薄
• Backgrind, CMP, edge grind
Metallization金属化
• Sputter Al, AlCu, AlSiCu, Ti, TiN, Ge, SiCr
• CVD Tungsten
• Electroless Plating Ni/Pd, Ni/Au
Metrology (in-line) 度量
• ACV4, CD-SEM, ellipsometer, interferometer
• Spectroscopic reflectometer, surfscan
• August NSX
Dicing切割
• Automated taping/dicing
• UV backing and cover tapes
Test测试
• Keithley Parametric testers
• MEMS electrical, optical and acoustic testing
• Test development service for MEMS
• Customer specific test systems
6.追求卓越的质量和客户服务
Teledyne DALSA长期为多家无晶圆厂的半导体厂商和整合器件制造商(IDM)提供专业的晶圆和器件代工服务,历史超过25年。
我们拥有全面而灵活的技术组合和生产能力,提供卓越的规划、质量保证和客户服务,为您的成功奠定坚实的基础。 我们的全球声誉源于我们专业的工程师、技术人员、生产操作人员和出色的项目管理、全面的资源规划、严格的质量保证体系和热忱的客户服务。
同样,客户对我们的信任也是关键原因之一。 在保护客户机密和知识产权方面,Teledyne DALSA半导体 同样做得十分出色。
我们的经营理念体现在我们符合最合标准的质量体系之中。 作为一家历史悠久的制造企业(而不是一个实验团体),我们将严格的质量控制烙印在我们的企业文化之中。 重要优势包括:
• ISO/TS 16949 (包括 ISO 9001)和 ISO 14001 认证
• 微污染和 ESD 控制体系
• 实时批次跟终、端到端可追查性
• 逆向工程和故障分析服务
• 实时在线统计流程控制 (SPC)
• RoHS 合规
联系我们
邹阳
销售经理,半导体代工业务
Teledyne DALSA Semiconductor
电话: +1 450-534-2321 分机.1220
邮箱:Yang.Zou@TELEDYNEDALSA.COM
18, boul. de l'Aéroport, Bromont, QC, Canada , J2L 1S7
