晶圆级封装(WLP)优势
2011-12-01 19:26:12 来源:微迷 评论:0 点击:
晶圆级封装(Wafer Level Package,WLP)采用传统的IC工艺一次性完成后道几乎所有的步骤,包括装片、电连接、封装、测试、老化,所有过程均在晶圆加工过程中完成,之后再划片,划完的单个芯片即是已经封装好的成品;然后利用该芯片成品上的焊球阵列,倒装焊到PCB板上实现组装。WLP的封装面积与芯片面积比为1:1,而且标准工艺封装成本低,便于晶圆级测试和老化。
晶圆级封装以BGA技术为基础,是一种经过改进和提高的CSP,充分体现了BGA、CSP的技术优势。它具有许多独特的优点:
(1)封装加工效率高,它以晶圆形式的批量生产工艺进行制造;
(2)具有倒装芯片封装的优点,即轻、薄、短、小;
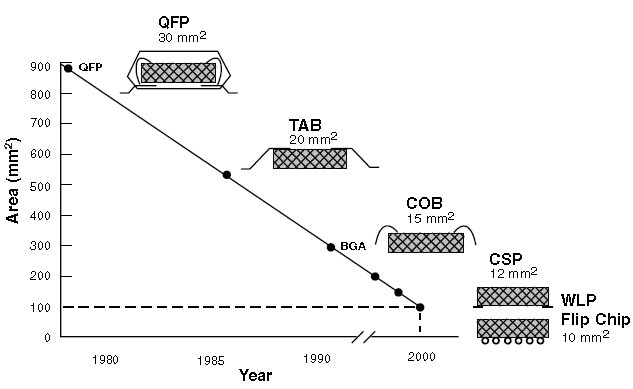
图5 WLP的尺寸优势
(3)晶圆级封装生产设施费用低,可充分利用晶圆的制造设备,无须投资另建封装生产线;
(4)晶圆级封装的芯片设计和封装设计可以统一考虑、同时进行,这将提高设计效率,减少设计费用;
(5)晶圆级封装从芯片制造、封装到产品发往用户的整个过程中,中间环节大大减少,周期缩短很多,这必将导致成本的降低;
(6)晶圆级封装的成本与每个晶圆上的芯片数量密切相关,晶圆上的芯片数越多,晶圆级封装的成本也越低。晶圆级封装是尺寸最小的低成本封装。晶圆级封装技术是真正意义上的批量生产芯片封装技术。
WLP的优势在于它是一种适用于更小型集成电路的芯片级封装(CSP)技术,由于在晶圆级采用并行封装和电子测试技术,在提高产量的同时显著减少芯片面积。由于在晶圆级采用并行操作进行芯片连接,因此可以大大降低每个I/O的成本。此外,采用简化的晶圆级测试程序将会进一步降低成本。利用晶圆级封装可以在晶圆级实现芯片的封装与测试。
上一篇:TSV技术是3D SIP的关键
下一篇:晶圆级封装(WLP)应用
