一种基于硅硅键合工艺的微型麦克风制备方法
2015-01-04 20:44:27 来源:麦姆斯咨询 评论:0 点击:
技术领域
本发明涉及一种微型麦克风制备方法,尤其是一种基于硅硅键合工艺的微型麦克风制备方法。
背景技术
MEMS(Micro-Electro-Mechanical Systems)技术是几年来高速发展的一项高新技术, 与传统对应器件相比,MEMS器件在体积、功耗、重量等方面都具有十分明显的优势,而且其采用先进的半导体制造工艺,可以实现MEMS器件的批量制造,能极好的控制生产成本,提高器件的一致性。对于目前的MEMS产品,加速度计、压力传感器、陀螺仪、微镜、硅麦克风等都已经实现了批量生产,在相应的市场上都占有了一定的份额。
硅麦克风耐高温、耗电量小以及体积小等特点,使得它在移动电话、助听器、笔记本电脑、PDA、摄像机等视听产品以及国防、国家安全等相关领域应用将更加广泛。从麦克风市场的预测和发展来看,硅麦克风成为传统驻极体麦克风的替代产品已经毋庸置疑,它提供了令声学工程师相当满意的相似的甚至更好的声学性能。硅麦克风在几年以后将会成为麦克风市场上的主要产品。
为了开发出高灵敏度和宽带宽的麦克风,高性能振膜的制作至关重要,振膜制作面临的一个主要问题就是振膜应力的控制。现有薄膜的制作主要采用淀积的方法得到,通过淀积得到的振膜会存在较大的残余应力,残余应力对微型硅麦克风的性能有较大影响,大的残余应力能大幅度降低麦克风的灵敏度,压应力还能减小麦克风的耐压能力,严重时能使得麦克风无法正常工作。另外,背极板的制作也至关重要,刚性背极是硅麦克风有良好频率特性和低噪声的前提条件。
目前改善振膜残余应力通常有两种方法,一是通过附加工艺,用退火的方式,这种方式对工艺的控制要求极高,重复性不是很好;另外一种是通过结构调整,如制作自由膜结构,但这种结构的制作会导致工艺复杂度的增加,可能需要添加多步工艺,来控制振膜。而实现刚性背极也是麦克风制作过程中的一大难点,目前也是有两种主要方法来解决,一是制作厚背极,但是通过常规的淀积工艺很难得到需要的厚背极;还有一种方法是通过结构调整来提高背极板的刚性,但也是要增加工艺的复杂度。
发明内容
本发明的目的是克服现有技术中存在的不足,提供一种基于硅硅键合工艺的微型麦克风制备方法,其灵敏度高、噪声低、频带宽、成品率高,制备工艺简单。
按照本发明提供的技术方案,所述基于硅硅键合工艺的微型麦克风制备方法包括如下步骤:
a、提供连接板与背极板,所述连接板与背极板上均生长有氧化层 ;b、将背极板放置在连接板上,所述背极板对应于生长氧化层的表面与连接板上对应于生长有氧化层的表面相接触,背极板与连接板通过对应的氧化层键合固定;c、对上述背极板进行刻蚀,使氧化层上方相对应背极板的厚度为4~10μm;d、在厚度为 4~10 μm的背极板上生长有绝缘键合层;e、提供基板,并在基板上凹设有安装槽;f、在基板对应于设置安装槽的表面及安装槽的内周面上均生长有绝缘支撑层;g、在基板对应于生长有绝缘支撑层的表面上淀积振膜;h、选择性的掩蔽和刻蚀所述振膜,得到位于安装槽内 的振膜;i、 将背极板放置在基板上,背极板上对应于生长有绝缘键合层表面与基板对应于生长有绝缘支撑层的表面相接触,背极板与基板利用绝缘键合层与绝缘支撑层相键合固定;j、刻蚀基板上方的连接板与氧化层,去除背极板上方的连接板与氧化层;k、选择性的掩蔽和刻蚀背极板,在背极板上得到下电极孔,所述下电极孔与安装槽相连通,且对应于振膜的一端;l、在上述背极板上淀积电极层,所述电极层覆盖在背极板的表面,并填充在下电极孔的底部;m、选择性的掩蔽和刻蚀电极层,得到位于背极板与振膜上的电极;n、刻蚀振膜上方的背极板,得到位于背极板上的若干声孔,所述声孔位于振膜上方,并与安装槽相连通;o、刻蚀上述基板对应于设有背极板的另一端,得到位于振膜下方的声腔;p、刻蚀振膜下方的绝缘支撑层,使振膜与声腔相连。
所述氧化层为二氧化硅。所述连接板的材料为单晶硅。所述电极的材料为铝、镉或金。 所述振膜的材料为导电多晶硅或绝缘材料与金属材料的复合层。所述绝缘支撑层为二氧化硅或氮化硅。所述绝缘键合层为二氧化硅。所述声孔形状为圆形、方形或椭圆形。所述振膜、背极板分别与对应的电极电性连接。所述背极板为掺杂的单晶硅。
本发明的优点:所述背极板为掺杂的单晶硅,通过对应的硅片减薄工艺,背极板的厚度可控,能够满足较强的刚性要求。所述电极的材料范围更广,不需要考虑抗氢氟酸腐蚀的问题,去除了材料释放工艺,避免了因释放而产生的粘连问题。成品率高,工艺实现简单,能够满足小尺寸的要求。
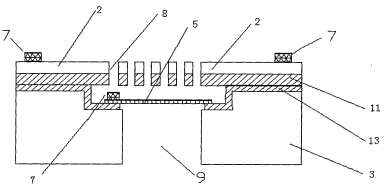
本发明的结构示意图
申请人:无锡芯感智半导体有限公司
地址:江苏省无锡市滨湖区十八湾路288号(梅园基康里)湖景科技园10#225室发明(设计)人:刘同庆 沈绍群
申请号:201010196722.0
授权公告号:CN 101854578 B
合作方式:暂时不交易。
联系方式:
如果您想获取更多信息,请联系:王懿,wangyi@MEMSConsulting.com
上一篇:一种电容式微型硅麦克风及其制备方法
下一篇:感知“利”器|一种晶圆级封装方法
