新型MEMS电场强度传感器,设计新颖无干扰
2018-01-25 14:43:34 来源:麦姆斯咨询 评论:0 点击:
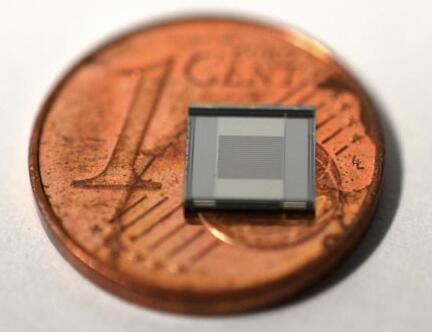
电场的精确测量,对于很多应用都非常重要,例如天气预报、工业设备的过程控制或者是高压电缆工作人员的安全问题等。然而从技术角度来说,精确的电场测量并非易事。
据麦姆斯咨询报道,一支来自维也纳技术大学(TU Wien)的研究团队突破当前其它测量设备所采用的设计原理,开发了一款硅基MEMS电场测量传感器。通过和克雷姆斯多瑙河大学(Danube University Krems)集成传感器系统研究院的合作,这款传感器的主要设计优势是它不会干扰正在测量的电场。该研究成果发表于近期出版的Nature Electronics杂志。
MEMS电场传感器的测量原理
“目前用于测量电场强度的设备具有一些显著的缺陷,” TU Wien传感器和执行器系统研究院的Andreas Kainz解释称,“这些设备均包含带电部件。在测量时,这些导电金属组件会显著影响被测电场;如果设备需要接地以提供测量参考值,那么这种影响会被进一步放大。”因此这种电场测量设备往往相对不太实用,并且运输也较困难。
TU Wien开发的这款MEMS传感器采用硅材料制造,并且基于非常简单的原理:一个微型弹簧,以及固定在该弹簧上用于测量微米量级移动的微型网格状硅结构。当硅结构处于一个电场中时,在硅晶上会产生一定的作用力,使弹簧发生轻微的延展或压缩。
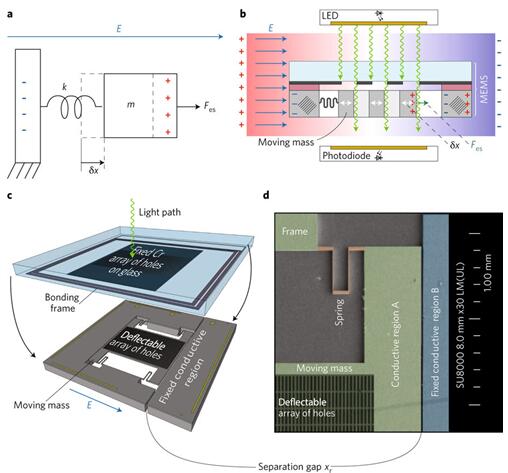
a. 这款MEMS电场传感器的测量原理:一个质量块(m)悬置于一个弹性元件(刚性k)上,而弹性元件固定于一个导电的固定框架上。当置于电场(E)中时,静电感应会在质量块上产生一个作用力(F es)。质量块在这个作用力下会产生一定的位移(δx),再利用光学原理对位移进行测量;b. 该器件的剖视图,展示了LED发射的光,可以穿过网格状硅结构和孔洞之间的间隙,投射到下方的光电二极管上,质量块的移动改变了不透光区域和孔洞之间的间隙,从而改变了LED发射光能够到达光电探测器的进光量;c. 这款MEMS电场传感器的3D视图;d. 这款MEMS电场传感器的扫描电镜图
质量块细微的位移如何测量呢,研究人员设计了一种光学解决方案:在可动网状硅结构的上方再设置一层网状结构,上下两层网状结构的孔洞精准的排列,上层的开孔和下层的不透光区域精确对准,也就是说在下层网状硅结构没有发生位移时,LED光是无法穿透这两层硅结构的。当传感器置于一个电场中时,下层网状硅结构在静电力作用下发生了位移,使上下两层网状结构之间有了缝隙,LED光便能从缝隙中穿过到达下方的光电探测器上。通过测量进光量,利用合适的校准器件便能计算出这个电场的强度。
原型器件的精确度令人振奋
这款MEMS电场传感器不能测量电场的方向,但能够精确测量电场的强度,它可以测量从低频到高达1KHz的电场强度。“利用我们的原型传感器,可以高可靠地测量小于200伏特/米的弱电场,” Andreas Kainz说,“这意味着我们的系统已经与现有产品的性能相当,并且,我们的传感器更小、更简单。此外,这款MEMS传感器还有很大的改进空间。其它的测量方法已经是成熟的方案,我们的这款MEMS电场传感器才刚刚设计成型。未来,它肯定还能改进的更好。”
推荐培训:
2018年3月30日至4月1日,麦姆斯咨询主办的“MEMS制造工艺培训课程”将在无锡举行,培训内容包含:(1)硅基MEMS制造工艺及典型制造工艺流程详解;(2)晶圆级芯片尺寸封装(WLCSP)相关的晶圆级凸点、TSV和临时键合工艺;(3)时下最热门传感器的特殊薄膜材料(AlN、ZnO和PZT压电薄膜)制造工艺及应用,如FBAR滤波器、压电麦克风等;(4)3D传感产业的热点VCSEL激光器重要工艺设备、工艺难点、工艺控制等;(5)非硅基MEMS制造工艺及应用,主要针对塑料基、玻璃基、金属基和纸基微流控器件的制造工艺。
麦姆斯咨询
联系人:郭蕾
电话:13914101112
E-mail:guolei@memsconsulting.com
延伸阅读:
经典文章回顾
- 导远电子推出全新MEMS组合定位系统INS570D,为智能驾驶量产落地保驾护航
- 全球首款单芯片集成ASIC的电容式MEMS超声波换能器(CMUT)
- 豪威科技发布入门级倒车后视SoC图像传感器:OX01E10
- 兵器214所推出12款高性能MEMS惯性传感器
- 矽杰微电子发布24GHz毫米波雷达收发机SOC:SRK1202A
- 青岛芯笙推出多款气体质量流量计和控制器产品
- 解读全球首款MEMS超声波ToF传感器
- TDK推出高性能6轴IMU:ICM-42688-P,适用于机器人、可穿戴及物联网
- 宜普电源(EPC)谈GaN功率器件技术及应用(三):激光雷达
- 灿瑞科技率先推出“ToF光源+驱动IC”整合封装,大力拓展3D传感应用
