工程材料系统公司为MEMS和晶圆级封装推出新型干膜负性光刻胶
2017-01-10 11:55:28 来源:麦姆斯咨询 评论:0 点击:
据麦姆斯咨询报道,MEMS和硅通孔(TSV)钝化 封闭应用的负性光刻胶材料全球领先供应商EMS近日推出了MEMS、晶圆级封装及CMOS应用(TSV封孔)使用的新型干膜负性光刻胶DF-3560,其材料配方为热辊层压和MEMS及IC晶圆处理进行了优化。
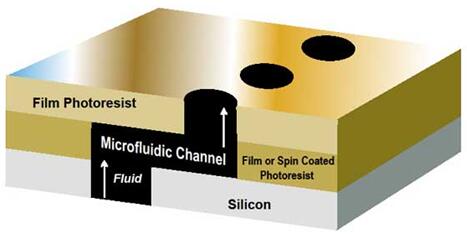
据麦姆斯咨询报道,MEMS和硅通孔(TSV)钝化/封闭应用的负性光刻胶材料全球领先供应商Engineered Material Systems(工程材料系统公司,简称EMS)近日推出了MEMS、晶圆级封装及CMOS应用(TSV封孔)使用的新型干膜负性光刻胶DF-3560,其材料配方为热辊层压和MEMS及IC晶圆处理进行了优化。
DF-3650膜的厚度规格包括5~100 µm(±5%),固化后可耐受极端潮湿环境和腐蚀性化学品等恶劣环境。
DF-3560膜比市场上大部分负性光刻胶更坚固(不易碎),其玻璃态转变温度为154°C(DMA Tan Delta),在25°C具有3.25 GPa的适度模量。
DF-3560是EMS公司薄膜及液态负性光刻胶产品线中的最新产品,为在MEMS器件和集成电路上制作微流体通道进行了优化。
延伸阅读:
上一篇:开辟中国光刻胶自主知识产权之路
下一篇:Brewer Science不断增强能力以大力支持中国不断发展的半导体市场
