晶圆级键合技术的最新发展
2011-11-24 19:37:28 来源:SUSS MicroTec 评论:0 点击:
Shari Farrens 博士
晶圆键合部-首席科学家
SUSS MicroTec
1. 引言
晶圆级MEMS(微电子机械系统)键合技术应用于生产加速度计、压力传感器和陀螺仪等领域已数十年。汽车工业一直以来都是这些MEMS器件的主要最终用户。但近期例如手机和游戏机产业的需求导致MEMS消费类产品市场爆发性增长,使得这一行业发生了巨大变化。最重大的变化可能就是更大的市场和更低的成本要求。同时,集成MEMS器件和CMOS控制器或其它IC部件的需求,使得该技术研究开始转向关注怎样才能制造这些器件。
MEMS的晶圆级键合方式以往主要为阳极键合和玻璃浆料键合。这两种键合方式在产品使用寿命期间,都具有十分良好的气密性,并且对于上游制造方面的严苛要求如颗粒沾污和表层形貌,都具有相对良好的适应性。然而,这些方法并不能解决极限尺寸、集成度和垂直封装的问题。
2. 高级MEMS 键合要求
新型MEMS芯片需要满足更小产品尺寸的要求。实现这一目标最合适的方式应当是金属封装技术。相比其它材料,金属具有更低的透气性,因此可以提供更好的气密等级。金属密封材料在晶圆片上占用更小的面积,晶圆也就可以容纳更多的器件,所以在提高气密性的同时,微机械部件的实际尺寸也减小了。
金属密封技术的另一个特点是,它为芯片提供了电通路。所以在设计芯片时可以引入垂直互联金属层,实现晶圆堆叠和先进封装技术,从而进一步减小芯片尺寸,降低成本。
3. 金属键合技术
金属键合技术大体上可以分为两类:非熔化型扩散法以及自平坦化(熔化)共熔晶反应。在运用这两种技术时,可以根据所希望的技术参数和要求,分别选取适合的金属系。
金属扩散键合,是一种典型的热压力键合。首先,使金或铜沉积到需要连接的部件表面,然后将部件相互对准后置入精密晶圆键合机,如SUSS MicroTec公司的CB200中。键合机控制腔室内气氛,加热加压将部件键合到一起。扩散键合是物质界面间原子相互混合的结果,键合结果气密性极好。
对于表面粗糙度和形貌都符合一定要求的器件,扩散键合是一种很好的选择。键合中,金属层并不熔化,因此必须与需要键合的表面紧密接触,对于粗糙表面、表面有颗粒或其它表面缺陷的情况,这种键合方式就不合适了。
在共熔晶键合过程中,两种金属熔合为合金并固化。可用于共熔晶键合的金属材料有AuSi,、AuSn、AuGe、 CuSn、AlGe,以及其它一些不常用的合金材料。共熔晶键合过程中,基片上的金属层在被称为共熔温度Te的特定温度下相互熔合。合金沉积当量或金属层厚度决定了合金的合金温度Te。金属共熔后发生了数个重要的工艺变化。
首先,金属材料熔化会导致金属层在结合面加速混合和消耗。这提供了一个良好的控制反应,可以形成均匀界面。
其次,金属形成流体状态,这样在界面上,包括任何表面异形区域都可以自平坦化。
最后,共熔晶键合的重点是在重新凝固后使混合物形成晶体结构,从而获得很高的热稳定性。因此在任何时候T>Te 时,晶圆键合中的合金过程并不会由于一定的合金比例成分而结束,而是在界面处形成一个更稳定的熔融金相。
4. 金属键合用于MEMS制造的优势
金属键合在MEMS器件制造时主要用于将器件密封于真空环境以及为装运而将器件封装。
图1显示了不同制造方法和封装方式之间的区别。真空等级不够低或者是随着器件使用时间的增长,真空会降低,传统键合方式的密封环必须很大,芯片尺寸也因此更大。在使用以金属为介质的键合技术后,密封环尺寸可以10倍的量级减小,MEMS器件尺寸也可相应做得更小,一片晶圆片上就可容纳更多芯片。据客户报告,因此在生产制造时总体成本下降达75%。
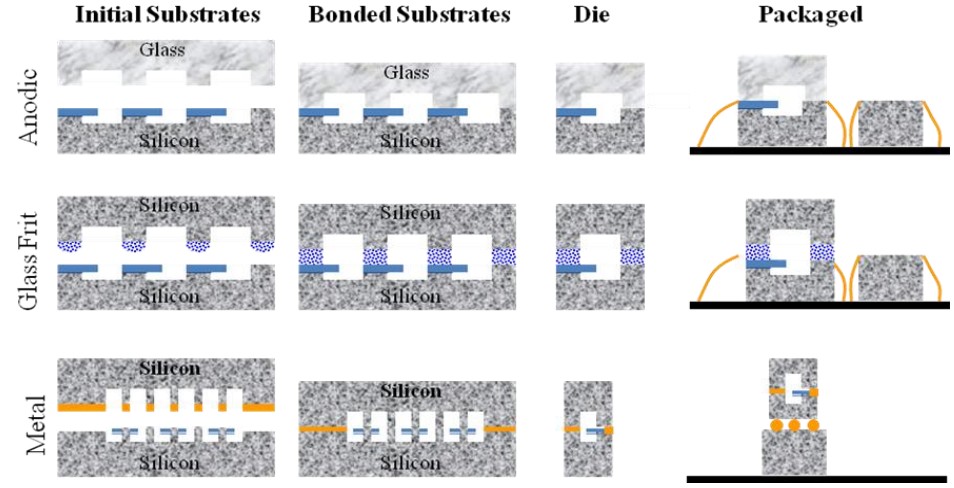
图1 传统的适用于引线键合封装的阳极键合、玻璃浆料键合与金属键合封装的差异对比示意图
切片后器件被封装并装配到控制线路板上,有源器件和无源器件通过线焊相互连接。金属键合时,金属层垂直连接,重新分布,或直接与焊球连接,同时MEMS器件可以被堆叠于其它部件的顶部,这样整体上减小了封装尺寸,降低了复杂程度。
5. 其它注意事项
金属沉积层会影响键合结果的质量。金属沉积层通常厚3-5um。与此相比,玻璃浆料键合时,浆料层厚达30-150um。当覆盖层不合适时,图形化密封环的宽反会达到几十微米以上。沉积层的产生方法包括电镀、化学气相沉积、溅射和蒸发。溅射和蒸发很少使用,因为这两种方式对目前的厚度要求,沉积速率太慢,不够经济。不同的方式导致不同的金属层纯度和颗粒尺寸。在大多数金属键合技术中,可以认为金属层纯度越高,反应速率越快。此外,当温度较低时,晶粒界线对原子运动起到主要作用,较小的晶粒尺寸会更好。
金属的表面氧化作用也会阻碍界面反应,并且导致电特性很差。在对准和键合前进行表面处理能够帮助去除这些反应层。具体方法有几种,例如用等离子干法处理和化学湿法清洗。此外,键合机舱室的质量也会对预防热压键合时粘污层的重新生长造成重大影响。高级金属键合需要精确的对准和键合设备。生产设备解决方案,例如SUSSMicroTec公司的XBC系列中的键合机,键合腔室以电解法抛光,生产型载入窗口,正向压等措施差可以有效避免舱室和样品暴露于外界环境。高精确对准机可以保证微米级别的对准精度,化学方法的使用确保了高电性良率。
6. 金属工艺相关建议
金属系的选择取决于温度的限制,材料的兼容性,以及界面要求:如导电性、光学反射率、厚度均匀性等。建议在惰性气氛中进行金属键合,以便传热和保证热均匀性,抑制氧化并且保持腔室洁净。
表I 列出了晶圆级键合最常用的金属系和典型工艺变量。根据图表显示,基于金材料的金属工艺不适用于CMOS制造,但这不包括传统金线焊在封装步骤的使用。
表I 金属键合选项及结果

另一个建议是用化学机械抛光(CMP)处理金属层。IC工业中用于200mm和300mm晶圆片的镶铜工艺发展已经相当成熟。但用于铜的小尺寸晶圆片CMP工艺却很难找到。所以金更适用于小尺寸MEMS器件制造。因为可以使用CMP技术,故而可以使用扩散键合。扩散键合要求相对光滑的表面(粗糙度<2-5nm RMS)。
7. 薄晶圆片处理
金属键合的最大优势是能够直接转入垂直封装。3D封装可以显著降低生产成本。
减薄晶圆片的通常工艺步骤需要将器件附着于临时性载片上。器件晶圆片正面朝下,附着的粘合层将经历一系列需要在背面进行的工艺:包括研磨,抛光和随后的金属沉积,用以准备永久封装器件。器件晶圆片减薄,以及背面工艺完成后,减薄的晶圆片与载片分离并进行最后的封装。这整个工艺过程被称为临时性键合。
临时粘合的选择可以按照附着和拆分载片,温度稳定性,载具通用性这些工艺种类来分类。表II给出了四种主流供应商产品的数据[4-7]。其它因素还包括产量、COO建模和需要的厚度范围。
表II 临时键合材料供应商及其基本粘合特性

8. 总结
晶圆片键合应用于MEMS工业已达数十年时间,业界有责任建立标准规范,设定气密性、键合强度、缺陷检测、批量生产设备。而高级CMP工艺、硅垂直深孔刻蚀、金属填充互联技术的发展将促使CMOS工业继续进步。MEMS和CMOS生产制造技术的交叉彻底变革了整个市场。
向金属键合技术转变,满足了工业生产和薄晶圆片处理的需要,促进了先进MEMS生产消费市场的快速成长。
参考文献
1. J.E.E. Baglin and J.M. Poate “Chapter 9 “Metal-Metal Interdiffusion” Thin Films Interdiffusion and Reactions (edited by J. M. Poate, K. N. Tu and I. W. Mayer), Wiley (New York, 1978), p.311.
2. D. Gupta, D.R. Campbell, and P.S. “Chapter 7 Grain Boundary Diffusion”, Thin Films Interdiffusion and Reactions(edited by J. M. Poate, K. N. Tu and I. W. Mayer). Wiley (New York, 1978), p.164.
3. A. Rardin, S. Kirk, and M. Zussman, “Enabling Thin Wafer Metal to Metal Bonding through Integration of High Temperature Polyimide Adhesives and Effective Copper Surface Cleans”, presented at 6th International Conference and Exhibition on Device Packaging, Radisson Fort McDowell Resort and Casino Scottsdale/Fountain Hills, Arizona USA, or http://www2.dupont.com/WLP/en_US/assets/downloads/pdf/WP_Cu2Cu_Bonding.pdf.
4. Brewer Science Inc. 2401 Brewer Drive, Rolla, MO 65401 USA, http://www.brewerscience.com/products/waferbond/.
7. Thin Materials AG, Elsterstraße 23, 82223 Eichenau, Germany, http://www.thinmaterials.com/technology.
作者简介:
Shari Farrens 博士-Suss MicroTec 首席科学家,等离子激活晶圆键合的发明者,她拥有该技术的数项专利。
Farrens 博士在麦迪逊市的威斯康星大学获得材料科学物理博士学位,在内布拉斯加州卫斯理大学获得材料科学、核工业硕士学位,以及物理学学士学位。
Farrens博士已经撰写或与人合著了100多篇关于SOI晶圆键合、3D一体化和纳米科技的公开发表论文。她有着相关领域20 年的丰富经验,在全世界学术界和工业界被公认为MEMS、3D 晶圆键合技术方面的专家。作为SUSS MicroTec 公司的首席科学家,Farrens 博士主要负责新一代MEMS 器件制造的工艺研究、关注3D 市场发展、新设备研发,以及客户培训方面工作。
