感知“利”器|一种测试加速度、压力和温度的集成硅芯片
2017-04-10 20:26:43 来源:麦姆斯咨询 评论:0 点击:
工欲善其事,必先利其器。在全球化的今天,专利已不仅仅是创新的一种保护手段,它已成为商业战场中的利器。麦姆斯咨询倾情打造MEMS、传感器以及物联网领域的专利运营平台,整合全产业链知识产权资源,积极推动知识产权保护与有效利用。
据麦姆斯咨询报道,MEMS产业正向多传感器(现有的和新兴的传感器)集成方向前进,形成三大类组合传感器。实际上,这三类集成传感器已有雏形:密闭封装(Closed Package)组合传感器、开放腔体(Open Cavity)组合传感器、光学窗口(Open-eyed)组合传感器。传感器的价值越来越体现在其“功能”,以及实现该功能的软件。

三种MEMS组合传感器封装方式
在航空航天、工业自动化控制、汽车电子、航海以及消费电子等领域中,常常需要同时测量加速度、压力、温度等参数。例如,在汽车轮胎压力检测系统中,利用安装在每一个轮胎里的压力传感器来直接测量轮胎的气压,并对各轮胎气压进行显示及监视,当轮胎气压太低或有渗漏时,系统会自动报警。同时增加加速度传感器,利用其对运动的敏感性,实现汽车移动即时开机,进入系统自检、自动唤醒。汽车高速行驶时按运动速度自动智能确定检测时间周期,用软件设定安全期、敏感期和危险期,以逐渐缩短巡回检测周期和提高预警能力、大大地降低系统功耗。再者,利用芯片上的温度传感器来检测轮胎中温度变化,从而在温度过高时,提供预警信号,防止爆胎等事故的发生。
【推荐发明专利】
《一种测试加速度、压力和温度的集成硅芯片》
【技术背景】
传统的压阻式压力传感器采用扩散或离子注入的方法,掺杂获得4个硅应变电阻,在单晶硅片正面上构成惠斯顿电桥的应力敏感检测模式,电阻和衬底之间一般形成pn结隔离。为了满足测试量程的需要,背面一般采用氢氧化钾腐蚀减薄,常称为体微机械加工。为制作绝对压力传感器,必须先采用两块硅片预加工后,高温键合形成真空腔,然后抛光减薄到所需要的厚度,再在键合体的正面通过体微机械加工,形成所需要的图形,以构成检测电路。基于体微机械加工的绝对压力传感器芯片制作上初始成本高、工序繁多、硅片利用率低,最为重要的是,体微机械加工的压力传感器的工艺与现有的集成电路工艺不兼容。
硅微机械加速度计常用的有压阻式和电容式两种,压阻式加速度计有温度漂移的缺点,而电容式加速度计极板间存在粘附等失效问题。采用基于热电堆的加速度计,取消了质量块,代之是热对流的小气团,使得体积大为缩小,同时能抵抗50000g 以上的冲击,而且微加工工艺与IC兼容,使得可以大批量制作,成本低廉。
【发明内容】
基于上面所述的基于体微机械加工的集成硅芯片制作上的缺点,本发明提供提供一种测试加速度,压力和温度的集成硅芯片及制作方法。

本发明特征在于所述的集成硅芯片上包括基于热电堆加速度传感器、绝对压力传感器和温度传感器,采用LPCVD沉积的低应力氮化硅薄膜同时作为压力传感器的结构层、热电堆加速度传感器和温度传感器的支撑层,其中的热电堆的加速度传感器,采用热对流式,用多晶硅电阻作为加热器,悬于密封腔的中间,通电后电阻自身发热,在加速度为零时,在腔内形成等温的对流场;在有加速度计时,引起小气流团自由对流,在腔体内形成温度梯度场。两对金属(铝或钛钨金等)和P型多晶硅和N型多晶硅组成的热电堆等距离对称地放置在加热器的两侧,由于两侧热电堆的温度不同,使得热电堆有电压输出,从而可以检测两侧的温度差。由于温度差和加速度成正比,因此通过检测两点的温度差,就可以测量加速度。
其中,绝对压力传感器的设计由低应力的氮化硅(LS SiN)薄膜作为压力传感器芯片的核心结构层,多晶硅薄膜淀积在LS SiN薄膜上,通过结构和位置的优化设计,干法腐蚀制作形成力敏电阻条。用氢氟酸腐蚀牺牲层,后在低压化学汽相淀积(LPCVD)炉中密封腔,形成真空参考腔。
温度传感器采用掺杂的多晶硅电阻自身的热敏效应,即受温度变化的影响,在一定的温度范围内,电阻线性的变化值来检测温度变化值。
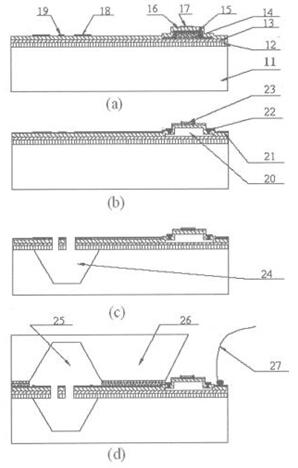
此三种传感器集成在一个芯片上,用同一套微加工工艺在一个硅片上,通过8次光刻工艺完成,可以同时检测加速度、压力和温度三个参数,而且灵敏度高,稳定性好,精度佳。其制作方法与IC工艺兼容,可以和信号调节电路,微处理器,以及其他测试功能集成在一起,大批量低成本、微型化制作。
【其它相关专利】
《加速度和压力传感器单硅片集成芯片及制作方法》
【延伸阅读】
专利购买或技术合作请联系:
麦姆斯咨询 殷飞
电子邮箱:yinfei@memsconsulting.com
若需要更多可交易专利,敬请访问:www.mems.me/mems/patent/
