液态合金可控微切割成型的通孔互联(TSV)制造技术及设备
2015-11-19 13:46:56 来源:麦姆斯咨询 评论:0 点击:
TSV(硅通孔互联)是一种穿透基板的垂直电互联技术。作为一种先进的电互联技术,TSV有着极其广泛的应用领域,可以说几乎所有类型电子器件及模块的封装都有TSV的应用需求。TSV的普及应用将是先进封装的必经之路。
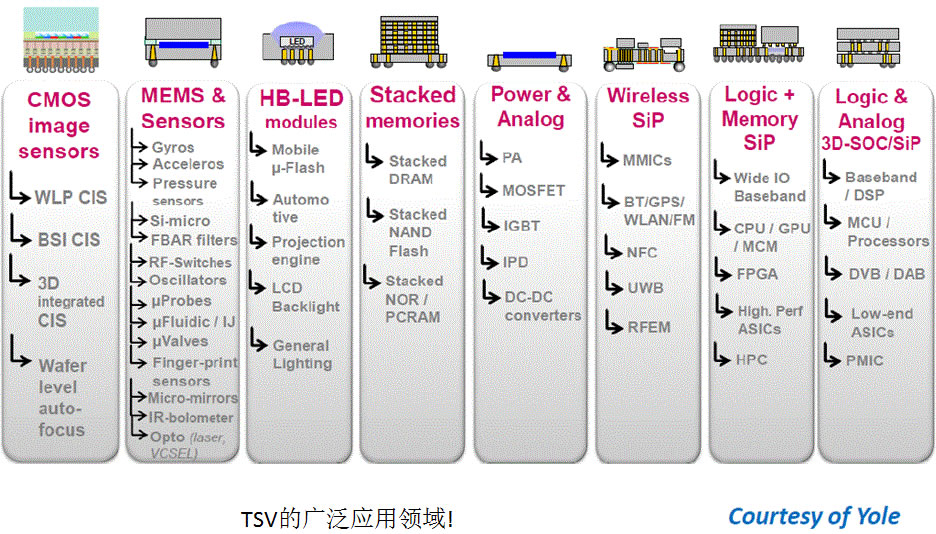
铜电镀是一种常用的TSV填充方法。但电镀本质上是一种原子级的沉淀方式,因而填充速度很慢。 而且作为一种复杂电化学反应,除非使用极其昂贵的工业生产用的电镀设备, 对于实验以及小批量的TSV应用, 数十个小时的电镀时间以及不高的成品率都极大阻碍了TSV的应用研究。TSV可能只是器件研制或者封装的一环,却需要花上非常多的时间和精力去调整各项电镀参数以达到可以满足要求的填充结果。 此外,电镀对于同时存在不同孔径的TSV填充显得加困难。
一般TSV的尺寸在几十到几百微米之间。在这个尺寸范围内,表面张力是决定液体形态的主导力。上海微系统所已经成功研制出基于表面张力的液态合金TSV填充技术以及相应的设备(如下图所示),并且这项技术具有一些优势。
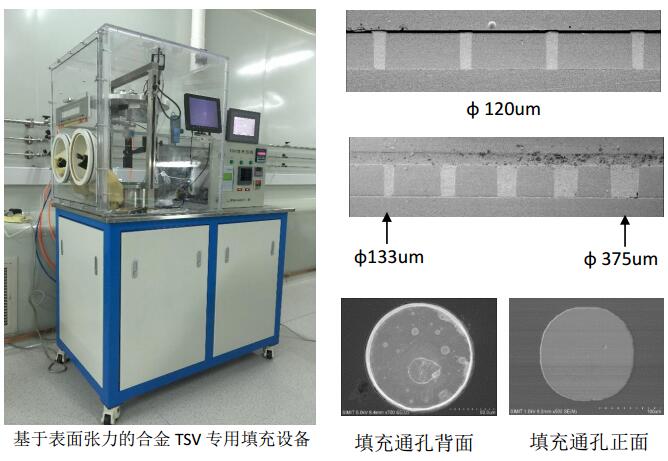
技术优势:
1、快速填充,只需几分钟。
2、可同时填充不同孔径的通孔和盲孔。
3、可填充孔径:几十微米至几百微米;无高宽比要求;对通孔密度无限制。
4、通孔侧壁无需金属层。
5、填充后表面与基板面齐平,无需CMP(化学机械抛光)。
6、可扩展至任意尺寸圆片。
7、适用基板类型:硅,玻璃,陶瓷等。
8、过程清洁,无污染。
应用领域和前景:
1、硅转接板
2、MEMS晶圆级封装
3、RF微波陶瓷三维堆叠模块
4、LED基板
5、其它水溶液或有机溶液的微孔填充(无损耗)
6、更多应用探讨……
合作方式:
1、TSV填充及相关服务:包括TSV(特别是尺寸相对较大以及同时存在不同孔径的情况)的填充及完整的TSV制造。可免费试制样品。
2、小批量硅转接板制造,包括微波转接板等。
3、基于具体应用的联合项目申请。
4、接受风投以及其他形式的技术开发合作。
联系方式:
中国科学院上海微系统与信息技术研究所
顾杰斌 博士
电话: (+86) 18602171012
邮件: j.gu@mail.sim.ac.cn
上一篇:国际顶尖的森林火灾防护预警系统
下一篇:【并购】国内传感器和安防产品的领先者
