MEMS压阻式压力传感器倒装焊封装的研究现状和发展趋势
2017-06-17 13:07:37 来源:中北大学 张迪雅 评论:0 点击:
引言
微机电系统(Micro-electro-mechanical Systems,MEMS)压力敏感芯片经过几十年的发展已经相当成熟,但是很多芯片却没有作为产品得到实际应用,主要原因是没有解决了封装问题,所以必须重视和积极发展MEMS封装技术。MEMS的封装既能保护芯片又可以实现芯片与载体基板的机械连接和电气连接。可以看出封装对传感器的应用是相当重要的一步。

图1 传统的MEMS压阻式压力传感器引线键合示意图
传统压力传感器的封装方式主要是充油隔离式胶粘引丝和裸露式胶粘引丝,如图1所示。倒装焊技术源于IBM的C4技术(Controlled Collapse Chip Connection),是一种将晶片直接与基板相互连接的先进封装技术。在封装过程中,芯片以正面朝下的方式,让芯片上的结合点透过金属导体与基板的结合点相互连接的封装技术,如图2所示。两种方式相比,虽然传统引线键合方式的应用已经成熟,但无法实现传感器的小型化封装,而倒装焊接具有短互联、小面积、立体通道、安装密度高等许多优异的封装特性,可以实现小型化封装。无论从节省工艺成本还是提高系统性能的角度,倒装芯片技术都大有前途。

图2 MEMS压阻式压力传感器倒装凸点互连技术示意图
压力传感器在现代工业生产过程中经常用来检测设备和产品的性能及参数等,其广泛应用于各种工业生产、航空航天等各行业。目前国内外在MEMS压力传感器的产品主要还是引线键合,对倒装焊的应用还很少。近年来各个国家都在积极研制不同结构设计的倒装焊,以满足市场的需求。在不同环境下使用的MEMS压力传感器工作要求不同,以至于基板材料和倒装焊工艺的选择也不同。
1 倒装焊封装的关键技术
倒装焊封装工艺的基本步骤:首先在压力敏感芯片焊盘上制作多层金属膜(Under Bump Metallurgy,UBM),然后在UBM上进行焊接凸点制作,最后将芯片倒装焊接在基板上,底部填充固化。下面介绍了其中几个具体步骤。
1.1 UBM制备
多层金属膜是在芯片上焊盘与凸点之间的一层金属化层,淀积在芯片焊盘的顶层。由于铝焊盘不能直接与焊料等材料直接连接,所以制备UBM作为过渡层,使芯片与基板互连工艺更容易实现、互连可靠性更高。只有UBM与芯片焊盘及凸焊点间形成良好的欧姆接触,才能确保优良的电性能和导热性能。
UBM通常由黏附层、扩散阻挡层和浸润层等多层金属膜组成。目前,采用的沉积方式有溅射、蒸发、电镀三种基本方法。2004年华中科技大学成功在铝焊盘上通过溅射方法制备了厚度为0.2/0.3μm的Ti/Cu,其中Ti为粘附、扩散阻挡层,Cu为浸润焊接层。选择合适的材料才能确保连接有良好的黏附性能和机械性能,在进行焊料回流或焊点退火等高温处理时,能够保证凸焊点材料不会穿透UBM而进入芯片的焊盘中。UBM材料的选择见表1。
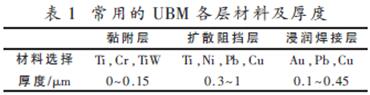
1.2 焊接凸点
在制作完成UMB后,要在其上面制备出一定厚度的球形或方形凸点,然后再将倒装芯片连接到基板上。芯片凸点的高度一般为几十微米到几百微米不等,凸点的尺寸小且芯片脆弱易损伤,要保证凸点的一致性有一定的难度。倒装芯片中凸点不仅可以实现芯片与基板互联,还提供了芯片的散热途径,且对芯片形成了保护。凸点的制作方法有很多种,包括蒸发、溅射、电镀、化学镀、钉头法等不同方法。其中电镀法较为常用。
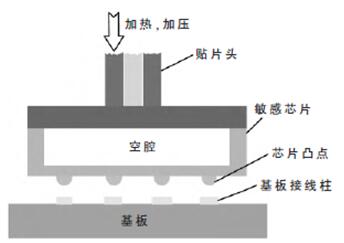
图3 热压超声焊接示意图
倒装焊接有焊料和导电胶两种互连方式,无论哪种互连方式都与凸点的制备有关。焊料互连一般采用回流焊、热压焊和热超声焊,如图3所示。其中回流焊一般在制备了软凸点(焊料金属)时采用,热压焊和热超声焊在制备了硬凸点(Au/Cu)时采用。台湾半导体制造有限公司在硅片的铜焊盘上制备了Ti/Cu/Ni的UBM层,应用电镀法分别使用不同焊料Sn-Ag凸点和Sn-Pb(含铅)凸点,通过分析测试发现Sn-Ag凸点更具有优越性。导电胶粘接分为各项异性导电胶和各项同性导电胶。各向异性导电胶施加在整个空隙之间,只在垂直方向导电,可以实现小节距工艺(Fine pitch)。各向同性导电胶只加在接触点空隙之间,一般采用含银颗粒的环氧树脂浆液。
最后,再进行底部填充。底部填充可以提供芯片与基板的良好粘接,保护芯片表面不受污染,匹配焊点、基板材料和芯片的热膨胀系数。但对于MEMS压力传感器来说,填满间隙会影响活动部件的运动,从一定程度上限制了其在MEMS中的应用。
1.3 基板材料选择
影响MEMS压力传感器倒装焊还有一个重要因素:热膨胀系数(Coefficient of Thermal Expansion, CTE)。芯片和基板的热膨胀系数是不同的,芯片倒装焊在基板上,通过焊接凸点使得芯片上产生一定的应力,所以基板外壳材料的选择直接关系着倒装焊接的残余应力大小。
倒装焊的封装外壳材料分为有机和无机两种。有机材料主要是印制电路(PCB)板;无机材料主要是陶瓷,有低温共烧陶瓷(LTCC)、高温共烧陶瓷(HTCC)、氮化铝陶瓷(ALN)等。陶瓷材料的杨氏模量高不易变形,与硅的热膨胀系数相近且高频有效,属于高强度材料,无论在怎样的环境下都可以获得稳定的性能。与有机材料相比,陶瓷材料的特性更为优越。德国慕尼黑大学成功将芯片倒装焊在HTCC基板上制作了微型麦克风。一些常用材料特性表如表2所示。
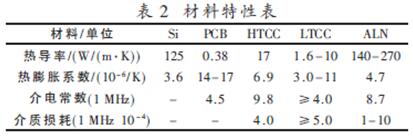
2 国内外的研究现状
传统的压力传感器的封装结构,采用引线键合结构,随着市场需求的不断提高,该结构已经无法满足压力传感器的小型化封装。倒装焊接具有高密度,无引线和可靠的优点,为实现传感器的小型化封装开辟了一条新路。MEMS压力传感器的封装技术都是由集成电路封装技术发展和演变而来的,目前集成电路的封装已经相当成熟,但对于一个压力传感器必须始终保持与外界连通,但又要保护器件使之并不暴露给压力媒介中的某些有害物质外壳材料,立体结构,可靠性的要求决定了MEMS封装的难点所在。目前对于压力传感器的倒装焊封装的研究很少,各国都在积极寻找可行有效的解决办法,努力提升传感器封装的稳定性。为了满足市场不断更新的需求,相关研究集中在压力传感器封装的材料选择和结构设计。
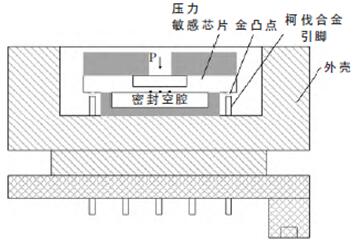
图4 倒装焊接后的示意图
中国电子科技集团公司第48研究所提出了一种压力敏感芯片的倒装焊接封装,将背面感压绝压型敏感芯片使用纯金凸点和柯伐合金引脚,采用超声热压焊与基座形成刚性连接,如图4所示,该倒装焊结构是在焊接前进行点胶,靠胶粘剂来固定敏感芯片,抗振动和冲击,这样焊点仅起导电作用,不是受力部位。试验证明了此种封装的可靠性,实现了对绝压压力传感器的无引线封装,大大缩小了传感器的体积,为压力传感器的小型化开辟了道路。但这种结构中胶粘剂压力强度有限,无法实现大压力差压传感器的封装。
随着电子技术的发展,国外对压力传感器的倒装焊封装已经有了一定的成果,提出了不同的结构设计,使用不同的基板材料,应用在不同场合和温度下。在2006年Francesca Campabadal等人设计的压阻式压力传感器,解决了小尺寸和高的互联线封装密度的问题,如可以满足手机的一些微型部件的要求。该设计为正面感压型倒装焊封装结构如图5所示,采用一个FR-4型的PCB板并在其中间钻孔,芯片的背面深刻蚀与Pyrex玻璃键合。采用回流焊工艺制备Sn/Pb(63/37)焊接凸点,把芯片正面朝下与PCB板上的金焊盘连接起来厚度为100μm,并用环氧树脂(OG147-7)密封,另一面的PCB孔上是使用了一个传感器的盖子(polyurethane),使气体压力通过管子直接到达PCB的钻孔,对芯片薄膜形成压力。该传感器结构具有高灵敏度和稳定的输出,在结构上实现了小型化。但并不适用于高温环境下。
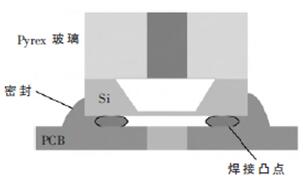
图5 压阻式压力传感器芯片倒装截面图
虽然国内外的科研工作者在压力传感器的倒装焊封装结构的设计方面已经取得了很大的进步,但大部分设计都是将芯片与基板之间粘接或焊接在一起,由于两者的热膨胀系数不同,大部分设计都采用热膨胀系数与芯片相似的基板材料,但并不是完全相同,会产生相应的残余应力,使结构的稳定性受到影响。
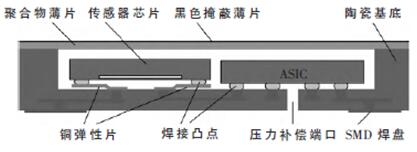
图6 传感器芯片和ASIC倒装焊接封装
(传感器芯片安装在铜弹性片上减小了机械应力)
2013年德国慕尼黑应用科技大学的T. Waber等人设计出一种压力传感器新型的倒装焊结构,具有低残余压力,进一步解决了芯片和基板热膨胀系数不同的问题。新设计的原理图如图6所示。将一硅片深腔刻蚀与另一硅片进行键合后进行减薄,形成薄膜,薄膜的正面是一个标准的惠斯通电桥,四个电阻条在薄膜的边缘有最大的应力以便获得最大的灵敏度,芯片上的焊盘为铝焊盘,UBM是由Ti,Ni,Cu,Au形成,其实的凸点由SnAgCu焊料制作。这种新的封装技术是将芯片倒装焊在一个铜弹片上。铜弹片通过表面贴装元件(SMD)安装在陶瓷(HTCC)腔室的底部。压力敏感芯片通过无铅焊料倒装焊在铜弹性片上,通过这个弹性片可以减小由于芯片和基板热膨胀系数不匹配所产生的应力。同时,该设计将ASIC(专用集成电路)和芯片封装在同一个管壳里,实现了小型化。
3 MEMS压力传感器封装的发展方向
近年来,国内外的封装技术飞速发展,封装的结构形式也更加多样化。MEMS压力传感器都是尺寸极小的精密元件,其封装尺寸也在不断趋于小型化,对其封装的难度也随之增大。对于MEMS压力传感器的封装要解决的问题有很多,比如寄生应力、芯片隔离、气密性、芯片保护等,都需要不断进行研究以期更好的解决。近年来MEMS传感器的气密性封装成为国内外的研究热点,特别是对于MEMS压阻式压力传感器中的可动部件,对其进行气密封装,可以隔离大气、灰尘、水汽等污染物,可见密封对提高传感器的可靠性和使用寿命有帮助。另一方面,MEMS压力传感器的封装,可以在芯片设计阶段就运用数学模型对各个封装步骤和影响因素进行模拟,然后选出最合适的封装材料并且制定最佳的工艺方案。
4 结束语
目前,MEMS压力传感器的封装结构不断趋于小型化,引线键合的传统方式已经不能满足应用需求,因此人们必然会加快对倒装焊封装结构的研究。
本文总结了MEMS压力传感器的基本工艺步骤,分析了国内外几种最新的MEMS压力传感器的倒装焊封装结构,这几种结构各具特点,可用于不同的环境下。与国外相比,国内在这方面的研究还有一定的差距,已经有很多大学和研究所在加快开展这方面的研究工作。
通过调研发现,与传感器本身相比,传感器的封装成本约占到60%,甚至80%,必须进一步解决传感器封装成本高和稳定性的问题以期实现倒装焊封装传感器的产品化。
如果您希望学习更多MEMS封装和测试知识,请报名参加由麦姆斯咨询主办的:『《MEMS封装和测试培训课程》2017年第二期』
时间:2017年6月30日~7月2日
地点:无锡
报名请邮件至:GuoLei@MEMSConsulting.com,电话:13914101112
延伸阅读:
上一篇:研究人员开发出3D打印在人手上的硅胶压力传感器
下一篇:弗劳恩霍夫研究所开发出400°C正常运行的SOI高压传感器
