超越摩尔领域的永久键合,持续创新是保持领先地位的关键
2018-12-26 17:15:07 来源:麦姆斯咨询 评论:0 点击:
微访谈:EV Group业务发展总监Thomas Uhrmann和执行技术总监Paul Lindner
据麦姆斯咨询介绍,在进一步微型化和增强功能性的推动下,人工智能(AI)、5G、增强现实/虚拟现实(AR/VR)以及自动驾驶等大趋势应用,正在创造巨大的市场机遇,促进超越摩尔(More than Moore, MtM)器件的大幅增长。
制造要求更严格的下一代MtM器件,需要技术规格强化的制造系统。
在此背景下,永久键合、光刻、临时键合和解键合工艺的整体设备市场营收在2017年超过了4.5亿美元,预计到2023年将增长到8.5亿美元以上,在此期间的复合年增长率(CAGR)可达10%。
永久键合已经在广泛MtM器件的大批量生产中应用,包括CMOS图像传感器(CIS)、MEMS器件、SOI制造以及LED器件。晶圆到晶圆(W2W)永久键合市场目前主要由CMOS图像传感器应用驱动,全局快门和飞行时间(Time-of-Flight, ToF)等新兴CIS产品预计将助推其进一步增长。与此同时,3D NAND和3D SoC等新型主流半导体应用,可能会在未来五年内大力推动W2W键合市场的增长,从而改变该领域的市场格局。
为此,麦姆斯咨询合作伙伴——Yole近期发布了一份市场和技术研究报告:《超越摩尔领域的键合和光刻设备市场-2018版》。本报告的作者Amandine Pizzagalli是专注于半导体制造的技术和市场分析师。她最近有幸采访了W2W永久键合市场领导者EV Group(EVG)业务发展总监Thomas Uhrmann和执行技术总监Paul Lindner,以了解他们对未来永久键合市场趋势的愿景和观点。

2017年W2W永久键合市场份额
Amandine Pizzagalli(以下简称AP):请两位简要介绍一下EVG的历史和当前业务。
Paul Lindner(以下简称PL)和Thomas Uhrmann(以下简称TU):EV Group是面向3D/先进封装、MEMS和半导体市场的晶圆键合、光刻和纳米压印设备领先供应商。近40年来,EVG一直处于工艺和解决方案开发的最前沿,使我们的客户能够在微电子和纳米电子领域成功地商业化它们的新产品创意。
在晶圆键合方面,我们最近向市场推出了新一代键合对准系统——全新的SmartView NT3。该对准系统适用于本公司专为大批量制造应用打造的行业基准GEMINI FB XT集成式熔融键合系统。相比上一代平台,专为熔融和混合晶圆键合而开发的SmartView NT3对准系统,可提供低于50纳米的W2W对准精度(2~3倍的精度提升),并大幅提高了产能(每小时多达20片晶圆)。这使我们的客户能够生产存储堆叠、3D SoC、背照式CMOS图像传感器堆叠和芯片分区所需要的具有最高互连密度的下一代3D集成器件。
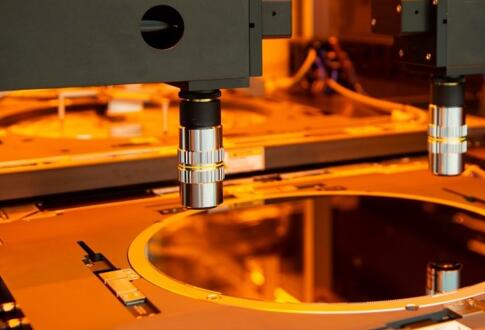
新型SmartView NT3对准系统使W2W对准精度比EVG的上一代对准系统提高了2~3倍
AP:目前,哪些主要市场在推动EVG的营收增长?
PL和TU:EVG一直是MEMS和3D/先进封装设备和工艺解决方案的先驱公司。这两个市场也是EVG目前的主要营收来源。实际上,MtM应用初期的产品已经上市,在过去几年中取得了巨幅增长。未来几年,我们预计该市场将实现强劲的两位数增长。此外,我们还将看到多种新器件和集成工艺,在不同领域实现MtM应用。
AP:EVG已经针对MtM器件开发了广泛的键合产品组合,请介绍一下EVG在MtM器件永久键合市场的业务情况?
PL和TU:根据集成密度和应用,MtM市场可划分为3D SIP(系统级封装)、3D SIC(堆叠式IC)、3D SoC以及3D IC,其中互连密度分别从几十微米间距到几纳米间距。随着这些要求的差异,相应的键合技术也不同。
对于3D SIP和3D SIC,键合技术包括用于薄芯片、硅通孔(TSV)和中介层的临时键合和解键合,然后采用芯片到晶圆(C2W)键合在芯片级集成。另一方面,对于3D SoC,需要晶圆级熔融和混合键合,同时对两个晶圆的紧密对准精度有很高的要求。

GEMINIFB XT
AP:EVG 在MtM器件领域的现状如何?您对未来的变化有何期待?
PL和TU:我们还处在MtM初级阶段。实际上只有少数制造商能够继续遵循“延续摩尔”(More Moore, MM),并始终以光刻方式向更小的工艺节点迈进。此外,也不是IC的所有部分都可以通过缩小工艺节点来获得性能提升。例如,低金属层布线的损耗正变得越来越突出。
MtM已经证明了其提高性能的能力,提高了产业对集成、堆叠和封装的关注。功能模块的分区、系统甚至封装中的重新整合,将增加产品开发周期,从而使它们更具竞争力。因此,永久键合等单元处理是否为集成做好准备,将成为未来成功不可或缺的因素。
AP:您如何看待你们整个键合设备业务的未来?EVG将如何保持领导地位并与主要竞争者竞争?
PL和TU:事实上,持续的发明和创新是保持竞争优势的关键。总体来说,我们每年会将大约20%的营收再投资于研发。通过对新技术的投资,我们能够尽早开发并改进新设备和工艺。这为我们的客户提供了以多元化应对竞争的理想环境。
因此,我们为客户提供了世界一流的信息安全环境,它们的新器件可以在我们位于奥地利总部的洁净室和测试车间,以及美国亚利桑那州坦佩和日本横滨的Demo实验室生产。我们的信息安全管理系统在几年前就已经通过了ISO27001认证。
EVG的另一个重要财富是我们“我能”的态度。我们随时准备满足客户的设备需求,通过新的设备技术支持他们的研发规划。除了发明新技术外,我们还拥有为客户大批量生产实施这些工艺流程的专业技术和人才。EVG的这种理念也反映在我们“发明(Invent)、创新(Innovate)、实施(Implement)”的3I公司使命中。
AP:您认为未来几年键合业务的发展会有哪些主要趋势?
PL和TU:前几年我们就看到了受产业趋势推动的晶圆键合的许多应用周期。MEMS是一个巨大的增长动力,用于惯性测量的消费类产品引发了键合技术的一次大变革。从2010年开始,智能手机和消费类设备中的图像传感器采用熔融键合技术进行背照式图像传感器制造,这引发了另一次重大变革。
今天,我们为全球大多数集成器件制造商(IDM)和代工厂提供了熔融和混合键合能力。随着当前MtM和MM市场的发展,我们在下一轮晶圆键合应用周期中占据了主动优势。
延伸阅读:
《Exynos 9110:三星第一代扇出型面板级封装(FO-PLP)》
