MEMS产业出路在哪里?优化成本、提高良率
2017-03-14 22:33:18 来源:麦姆斯咨询 评论:0 点击:
新的封装选择可以帮助提高利润,但是测试和热管理仍是问题。
MEMS器件在设计端总能令人惊叹,而在测试和制造端,则激起完全不同的反应。
归根结底,MEMS技术是机械和电子工程的交叉学科,是两个微观世界的交汇,这两个学科可以说是这个星球上那些最复杂技术的基础。但是,充分提高这些器件的产能,了解哪些能够正常运行,并搞清楚如何通过规模经济使半导体器件变得更加经济,是MEMS产业所要面临的巨大挑战。
原因主要包括:
- MEMS芯片就像黑盒子。事实上,它们通常都是密封的,因为许多器件需要在真空环节下工作。这使得测试变得更加困难;
- 除了MEMS器件本身,良率还依赖其它因素。很多情况下,这些MEMS芯片会和其它芯片封装在一起。某些器件对热或压力很敏感,由于很难测试这些器件,所以没有简单的方法来确定其可靠性;
- 对于许多MEMS器件来说竞争太激烈了,以至于无法保证获得进一步的投入,而制造这些芯片的工艺往往进展较慢且成本高昂。这会打击工艺和器件原本已经有限的创新。
加速度计、陀螺仪、压力传感器、MEMS麦克风等传感器占据着MEMS较大的市场份额,它们的工艺开发已经很成熟。但是这也带来了局限的一面。考虑到投资回报,一旦工艺成熟了,制造商往往不愿意再去投入改变。即使其工艺已经很成熟,也不能保证这些器件和其它传感器集成在一个封装内,能够正常工作。

MEMS芯片(来源:Applied Materials 公司)
“良率很重要,尤其在刚开始的时候,” STATS ChipPAC(星科金朋)产品技术市场执行总监Babak Jamshidi说,“我们需要为一种封装类型建立一条工艺及一系列规程。而小规模客户可能会开发一些全新的东西,这或许便会造成一些良率损失。”
在一些MEMS新应用领域,情况确实如此,量少但利润率高。MEMS市场由此可以分为高度商业化的惯性传感器和其它依赖各种先进材料的其它器件,例如压电基底和RF-SOI(射频绝缘体上硅)(参见《MEMS市场量增价跌,敢问路在何方?》)。
“MEMS市场非常碎片化,” Jamshidi说,“但是现在我们来到了物联网时代,每个人都需要各种大量的传感器。对MEMS器件的需求量将爆发式增长,将达到产能投入的数倍。而且,新的趋势是设计将源于无晶圆厂(Fablesss)厂商,而并非IDM厂商。IDM厂商将继续开发芯片,但是市场已经发展到即使是成熟的厂商也开始进行部分技术的外包,为利润更高的芯片开放产能。”
封装经济
为提高利润率,新兴的解决方案之一便是采用新的封装形式。如今,多数MEMS传感器都是封装在聚合物模塑材料中,利用这种封装材料来保护芯片。也有其它一些选择,包括预制模和低成本矩形平面无引脚(quad flat no-lead, QFN)封装,能够提高MEMS器件的经济性,不过也会有一些限制。
“现在的准入门槛变得越来越低,我们可以利用现有的设备应对测试市场,” ASE(日月光)高级应用工程经理Christophe Zinck说,“我们看到芯片的功能越来越多,但是预制模会限制组件的功能增加。但是利用QFN封装,就可以保持相同的尺寸,加入更多的功能,并且不会缩小器件尺寸。”
扇出型晶圆级封装(Fan-out wafer-level packaging, FO-WLP)是另一种在给定尺寸下增加器件功能,而又不会显著提高成本的封装形式。“现在它的成本较高是因为它现在还是一个利基市场,” Zinck说,“但是对于惯性传感器,你无法把MEMS芯片做的想多薄就多薄。把整个封装做到0.6mm以下是非常困难的。”
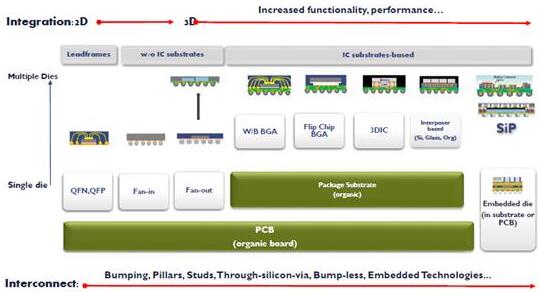
先进封装技术
不同的封装可以应对不同的应用,但是由于MEMS市场过于碎片化,因此,无法确定哪种封装将成为市场主流或如何定价。
“扇出型晶圆级封装或倒装芯片因为凸点(bumping)而被置之一边,但是你可以取代凸点并获得更薄的器件,”星科金朋的Jamshidi说,“你不会看到所有的器件都转用扇出型封装。对于MEMS麦克风来说,其振膜需要定制化很高的封装。但是对于惯性传感器,则可以使用已经适合扇出型晶圆级封装的工艺。”
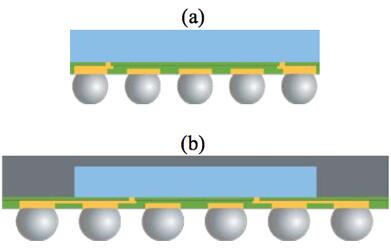
扇入型(a)和扇出型(b)晶圆级封装
扇出型晶圆级封装由于可以使多个器件像LEGO(乐高玩具)积木一样在基底上互联堆叠,因此将在传感器融合方面扮演重要角色。

扇出型封装技术的发展历史
据麦姆斯咨询分析,2016年是扇出型封装市场的转折点,苹果和台积电的加入改变了该技术的应用状况,可能将使市场开始逐渐接受扇出型封装技术。扇出型封装市场将分化发展成两种类型:
- 扇出型封装“核心”市场,包括基带、电源管理及射频收发器等单芯片应用。该市场是扇出型晶圆级封装解决方案的主要应用领域,并将保持稳定的增长趋势。
- 扇出型封装“高密度”市场,始于苹果公司APE,包括处理器、存储器等输入输出数据量更大的应用。该市场具有较大的不确定性,需要新的集成解决方案和高性能扇出型封装解决方案。但是,该市场具有很大的市场潜力。
测试策略
确保MEMS芯片能够正常运行并不简单,采用新的封装方法会使之变得更加困难。
“测试通常在传感器开发的两个阶段进行,即密封前和晶圆级测试,” National Instruments(美国国家仪器有限公司)主要市场开发经理Joey Tun说,“因此,如果MEMS器件是可变电容,那便会测量其电容。亦或是包括所有元件的封装,例如包括信号调节单元和MCU(微控制单元)等。”
扇出型晶圆级封装要求对MEMS芯片进行测试,以确保在封装前能够正常运行。此外,晶圆也需要在“重构”前后进行测试。这很关键,因为在某些情况下,会由不同的供应商供应晶圆和MEMS器件。
挑战在于确保测试过程不会产生其它问题。太多的测试,可能会损伤敏感元件。测试不够,尤其对于偏置温度不稳定性(bias temperature instability, BTI)等效应,可能会使不可靠的器件流入市场。BTI特别成问题,而负性BTI则更严重。随着器件的尺寸缩小,阈值电压会在施加应力下发生漂移。对于汽车应用,这种应力会通过测试施加,并有可能会在高达300度的高温下进行测试。
“对于汽车应用,40%的MEMS器件大多应用于此,其测试要求的温度会更高,”Tun说,“对于MEMS器件,汽车是最恶劣的应用环境之一,其测试需要更加严格。测试通常是在给定的过程节点,在正常运行条件下的假定寿命内测试CMOS的可靠性。但是随着器件尺寸的缩小,其寿命不可避免的需要接近终端设备的使用寿命。”
测试对于封闭器件和开放器件也完全不同。例如在晶圆级,主要考量的是良率。
“在Foundry利用晶圆级电学测试来评估MEMS器件的品质和良率,” GlobalFoundry(格罗方德)新加坡工厂 MEMS产品经理Jin Siew Lim说,“尽管利用晶圆级测试来预测已封装器件的良率挑战很大,但是晶圆级测试已经通过不断开发,获得了非常高的可信度。可靠性评估则测试封装阶段MEMS器件的气密密封性。”
这些是测试很重要的一环,当然,还有其它步骤。在设计端还会使用预测分析,而当器件完成封装后,则会使用输出测试。
“你可以预测响应温度波动的热行为,”美国 Coventor公司工程副总裁Stephen Breit说,“因此,对于不同的封装,其热膨胀系数也可能并不相同。封装会产生翘曲,而这会影响MEMS器件的输出。你可以通过测量传感器的输出来感知这些变化。如果设计和仿真工作做的好,甚至可以无需拿到实物芯片就能测量其输出。这对于那些没有封装就无法工作的器件尤为重要。”
而有时,也会出现封装以后器件无法运行的状况。Applied Materials公司技术营销总监Mike Rosa介绍了一个案例,有家公司在CMOS上沉积铝来制作接触垫,然后将锗沉积在MEMS器件上,然后再把它们键合在一起。
“在键合过程中他们采用了真空封接,也做了MEMS和CMOS之间的电接触,” Rosa说,“问题在于他们在8英寸晶圆上加热至410度,并施加了超过60千牛顿的力。在芯片端,他们得到了悬浮MEMS结构。但如果施加了额外的机械应力,会改变MEMS器件的可动范围。这引起了大问题。这不是封装本身的问题,而是他们键合晶圆的方法问题。”
制造考量
MEMS芯片制造本身也为自己带来了一系列问题。由于MEMS器件平均销售价格的下行压力,许多MEMS代工厂倾向采用较老的技术,因为其前期资本投入较低。但是,真实的规模经济往往来自新制造工艺和产能。代工厂通常会衡量它们的投入能获得多少回报,恰如它们如何应对其它CMOS芯片。
“相同的观点也适用于是否值得投入300mm产线,” UMC(台湾联华电子)高级区域营销经理Yan Qu说,“据IHS数据显示,惯性传感器、MEMS麦克风和体声波器件占整个MEMS市场的营收超过了10亿美元,但是,在你决定投入巨资之前,先要弄清楚自己能拿到多少潜在订单。”
目前,大多数MEMS芯片是利用扇入型封装技术在200mm产线上制造的,主要因为MEMS器件的I/O连接数量还没有那么大。采用扇入型封装方法,凸点在器件正下方。这和DSP(数字信号处理)具有显著差异,后者则有数百个I/O连接,Applied Materials公司的Rosa说。
当器件需要进一步缩小尺寸时,这种封装形式才会产生问题,例如更薄的手机,需要尺寸更小的器件来适应新的手机外形。
“过去,你会在一块晶圆上制作你的芯片,以及另一块有空腔盖帽的晶圆,然后你会用它来封盖另一块晶圆获得三明治结构,然后切割就完成了芯片制造,” Rosa说,“当智能手机或其它设备要求缩小芯片尺寸时,原来的标准封装方法便开始需要逐渐变得‘先进’起来。然后开始从原本1mm厚的硅晶圆逐渐降低至200~250um,不断减薄晶圆。对于MEMS,可以取巧的是,你可以减小CMOS尺寸,而无需缩小MEMS尺寸。对于陀螺仪等其它传感器,需要一定的质量块来感知运动。目前有许多‘先进封装方法’,包含在一块晶圆上制作的CMOS芯片,和另一块晶圆上制作的MEMS芯片,再利用晶圆键合将两者完美的键合集成在一起。然后,根据复杂程度,你还可以使用TSV(硅通孔技术)。”
总结
未来数年,预计MEMS器件的需求将显著增长,尤其是那些运动或用于感知运动的设备,包括从汽车到机器人,再到电子嗅探器及超声波指纹传感器的所有的一切。
部分MEMS器件会实现大规模生产,而另一些则是定制化生产,当然还有一些则是两者皆有。但是制造和测试挑战并不会变得简单,尤其是对于那些要求更高可靠性、更小封装以及更低成本的系统级供应商。MEMS市场仍将竞争激烈,而且只会变得更加残酷,因为满足制造和测试目标所需的创新需要成本,无论是在前期投资还是设备方面。
无论最终结果是更多的外包,更加标准化,或是两者择一,感知物理世界的低成本方法还有待观察。市场正在变革,但是将变成什么样,什么时候改变,以及谁将最终获益,目前还不得而知。
推荐培训课程:
延伸阅读:
上一篇:国内外传感器企业纷纷进军环保领域,千亿级市场即将全面爆发
下一篇:中科院电子所邹旭东:于微细处见神奇,MEMS技术引领新变革
