微流控赋能芯片冷却,解决数据中心散热问题
2024-01-14 15:32:02 来源:麦姆斯咨询 评论:0 点击:
如果人们认为浸入式水箱是液体冷却的最终选择,那还需要再认真考虑一下。因为,工程师们希望冷却剂在芯片内部流动。
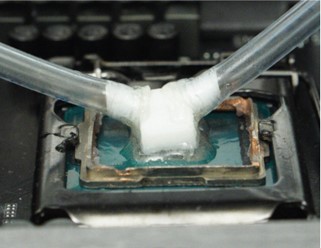
人们都知道,液体冷却是数据中心的未来。空气冷却根本无法处理到达数据中心的功率密度,因此利用具有高热容量的稠密液体替换空气进行冷却是一项可行的措施。随着IT设备热密度的增加,液体冷却越来越接近实际应用阶段。
通过数据中心机柜后门运行循环水系统的冷却方法已被广泛接受。接着,系统将水循环到特别热的组件(例如GPU或CPU)的冷却板上。除此之外,浸入式冷却系统将整个机架沉入介电液体罐中,因此冷却剂可以接触系统的每个部分。目前,主要供应商提供优化浸入式环境的服务器。但还可以更进一步。如果液体能被带到离热源更近的地方——硅芯片内部的晶体管,会怎么样呢?如果冷却剂流入处理器内部怎么办?
微软(Microsoft)系统技术总监Husam Alissa认为这是一个令人兴奋的潜在选项:“在微流控领域中,冷却系统被称为嵌入式冷却、3D异构或集成冷却,我们将该冷却技术‘带到’硅芯片内部,非常接近运行工作的有源核心。”
这不仅仅是一个更好的冷却系统,Husam Alissa说道:“当进入微流控领域,解决的不再只是一个‘热’问题。”拥有自己冷却系统的硅芯片可以从硬件源头上解决问题。
微流控的诞生
据麦姆斯咨询介绍,1981年,美国斯坦福大学(Stanford University)的研究人员David Tuckerman和R F Pease建议,使用与硅片代工厂类似的技术,在散热器中蚀刻微小的“微通道”,可以更有效地散热。
微通道具有更大的表面积并且能够更有效地散热。斯坦福大学研究人员建议,散热器可以成为超大规模集成电路(VLSI)芯片的一个组成部分,他们的演示证明,在当时,微通道散热器可以支持令人惊奇的每平方米800 W的热通量。从那时起,这个设想就一直在斯坦福大学流传,但对数据中心中运行的芯片并未产生多大影响。
2002年,斯坦福大学教授Ken Goodson、Tom Kenny和Juan Santiago成立了Cooligy公司,这是一家初创公司,其令人印象深刻的设计是在芯片上直接集成一个散热器。该散热器采用“有源微通道”设计,以及一个巧妙的静音固态电动泵来循环水。
Cooligy公司的理念已经被部分主流观点认可。该公司于2005年被艾默生网络能源公司(Emerson Network Power,后来更名为:维谛技术有限公司)收购。它的技术和一些员工仍然在维谛技术有限公司(Vertiv)存续。
随着硅片制造的发展和三维化,集成冷却与处理的理念变得更加实用。从20世纪80年代开始,制造商尝试在硅芯片上构建多个组件。在多层硅芯片的上层制作微通道可能是冷却的捷径,因为它可以简单地通过实现类似于散热器的微小凹槽实施。
但这个设想并没有得到太多的关注,因为硅芯片供应商希望使用3D技术来堆叠有源组件。这种方法现在被高密度存储器芯片所接受,相关专利表明英伟达(Nvidia)可能有意堆叠GPU。
在微处理器行业,冷却和处理被视为两个独立的学科。芯片必须被设计成能散热,一般使用导热材料将热量吸到表面的大铜散热器上,这是通过相对简单的方式实现的。
散热器可以通过蚀刻更小的微通道来改善,但它是一个单独的项目,热量必须穿过粘合剂的屏障才能到达指定位置。
但一些研究人员可以看到这种可能性。2020年,比利时鲁汶大学(KU Leuven)和校际微电子中心(Interuniversity Microelectronics Centre,IMEC)的研究人员Tiwei Wei将冷却和处理集成在一颗芯片中。
Tiwei Wei的成果于2020年发表在Nature期刊上,他认为这一理念不会在微处理器中流行,他说微冷却通道在电力电子领域更有用,在电力电子领域中,由氮化镓(GaN)等半导体制成的大尺寸芯片实际管理和转换电路中的电力。
这可能解释了艾默生网络能源公司/维谛技术有限公司想要收购Cooligy公司的原因,但Tiwei Wei没有料想到这项技术会走得更远,他在IEEE Spectrum期刊的文章中表示:“这种嵌入式冷却解决方案不适用于CPU等现代处理器和芯片”。
挖掘芯片新技术
在那时,研究人员已经在硅芯片表面蚀刻微流控通道数年了。2015年,美国佐治亚理工学院(Georgia Institute of Technology,Georgia Tech)与英特尔(Intel)合作的一个研究小组可能是第一个在硅片上制造出具有集成微流控冷却层的FPGA芯片的团队,该冷却层“距离晶体管运行处只有几百微米”。

佐治亚理工学院团队负责人Muhannad Bakir教授在佐治亚理工学院的新闻稿中表示:“我们通过将液体冷却装置移动到距离晶体管仅几百微米的地方,不再需要硅芯片顶部的散热器。我们相信,将微流控冷却装置直接可靠地集成于硅片内部,将是新一代电子产品的颠覆性技术。”
2020年,瑞士洛桑联邦理工学院(École Polytechnique Fédérale deLausanne,EPFL)的研究人员有了新的跨越,他们在发热晶体管下方的微通道中利用液体进行冷却。
Elison Matioli教授看到了将各项技术更加紧密地结合在一起的机会,他们团队的相关论文发表在Nature期刊上,他在2020年说:“我们从一开始就将电子装置和冷却装置设计在一起。”
Elison Matioli的团队成功地在芯片内部设计了一个微流控冷却通道的3D网络,设置在每个晶体管装置的有源部分正下方,距离产生热量的地方只有几微米。他说,这种方法可以将冷却性能提高50倍。
Elison Matioli在硅衬底上的氮化镓层中蚀刻了微米宽的狭缝,然后加宽了硅衬底中的狭缝,形成了足够大的通道,可以泵送液体冷却剂通过。
接下来,用铜密封氮化镓层中的微小开口,并在顶部形成一个规则的硅器件。他当时说:“我们只在与每个晶体管接触的硅片的微小区域上蚀刻有微通道。这使该微流控冷却技术变得更加高效。”
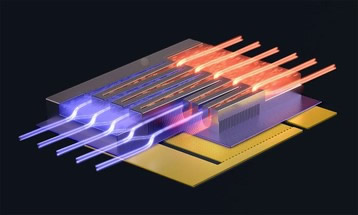
Elison Matioli成功地制造出了像12 kV交流到直流整流电路这样的耗电器件,但它不需要外部散热器。该器件内部的微通道将液体直接输送到热点区域,并处理每平方厘米1.7 kW的不可思议的功率密度,这相当于每平方米17 MW,是当今GPU热通量的数倍。
与标准硅芯片集成
与此同时,通过在现有微处理器的背面创建微流控结构,将微流控技术添加到标准硅芯片中的工作仍在继续。
2021年,包括Husam Alissa在内的微软领导的团队在标准的现有英特尔酷睿i7-8700K CPU的背面直接蚀刻了“微针(micropins)”鳍。
Husam Alissa说:“我们实际上采用了一款拆除机箱的现成的桌面级处理器。在没有散热罩和热界面材料(TIM)的情况下,芯片就暴露出来了。”
他继续说道:“当芯片暴露出来时,我们采用蚀刻方法制造出我们想要的通道。”芯片的背面被选择性地蚀刻掉,深度为200微米,然后留下100微米厚的棒状残茬区域图案——这些“微针”构成了直接集成到芯片冷却系统的基础。
Husam Alissa提醒说,这是一项精细的任务:“我们必须考虑蚀刻的深度,这样就不会影响硅芯片的有源区域。”
最后,CPU芯片的背面被密封在3D打印的歧管中,该歧管将冷却剂输送到“微针”之间。然后,该芯片经过超频,功耗达到215 W——是其热设计功率(TDP)的两倍多,该能量被设计为在不过热的情况下安全处理。
令人惊讶的是,该芯片仅通过歧管输送室温的水就能达到这一水平。该实验显示,与传统的冷却板相比,接头到入口的热阻降低了44%,每瓦使用的冷却剂体积减少了三十分之一。他们使用标准的基准程序对性能进行了评估。
这是首次在标准消费级CPU上直接创建微流控通道,并在有源CMOS器件上实现了微流控冷却的最高功率密度。该小组在IEEE Xplore期刊上发表了该项研究成果,表明在不需要能源密集型制冷系统的情况下,数据中心有可能更高效地运行。
芯片制造商所需要做的就是批量生产带有蚀刻“微针”的处理器,并在出售时附带一个歧管,以代替常规散热帽。
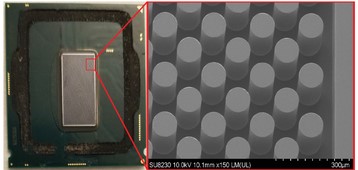
如果像台湾积体电路制造股份有限公司(TSMC)这样的硅片代工厂能够为他们的芯片提供内置的液体冷却,这将改变对这项技术的采用。Husam Alissa说,这也将使这项技术得到进一步的突破。
他说:“使用冷却板可能会得到40°C(104°F)的水,但使用微流控技术,这些芯片可能会产生80°C(176°F)甚至更高温度的水,因为冷却剂离有源核心太近了。这明显提高了效率和热回收效益,同时降低了对流速的要求。”
微流控的未来
Husam Alissa说:“微流控主要有两种类型。其中的‘轻触’选项能够在几年内部署实施。”这是他的团队展示的在商业芯片中蚀刻微通道的方法:“买芯片,蚀刻,然后就完成了。”
这种方法的一个更全面的可能是由硅片代工厂在芯片到达消费者手中之前进行蚀刻,因为并不是每个人都想把处理器的背面撬下来,然后用酸液腐蚀它。
除此之外,还有Husam Alissa所说的“重触”选项。在这种情况下,人们可以“在硅片代工厂早期‘拦截’并开始构建3D微结构。”他指的是多孔芯片,将组件堆叠在一起,中间有冷却剂通道。
这是Elison Matioli在瑞士洛桑联邦理工学院使用的方法的延伸。正如Husam Alissa所说:“这意味更多的期望,但显然也有更多的工作要做。”
Elison Matioli有一个目标:“我们想要达到的目标是,通过将多个芯片堆叠在一起,并在两者之间的微通道进行蚀刻,这样我们能够同时在冷却和电气方面共同优化芯片。”
冷却将允许多个组件通过“芯片通孔(TCV)”堆叠和连接,芯片通孔是通过穿过硅芯片的铜连接。这些塔式芯片可能需要更好的散热,工作速度更快,因为组件之间的距离更近,Elison Matioli表示:“总体来说,由于距离较近,性能、冷却能力都提高了,而且延迟也缩短了。”
还有另一个好处。如果微流控技术允许芯片达到更高的热设计点(TDP),这可能会消除硅芯片设计者目前面临的障碍。
散热的困难意味着当今最大的芯片不能同时使用所有晶体管,否则会过热产生问题。芯片有“暗硅”区域,采用微流控技术可以让设计者“点亮”这些区域,提高芯片性能。
但不能指望微流控技术能解决所有问题。早在2012年,Nikos Hardavellas教授就预测了接下来的问题:“即使采用了奇特的冷却技术,例如液体冷却与微流控技术相结合,但是向芯片输送电功率也可能会带来新的限制。”
延伸阅读:
相关热词搜索:微流控
