CMOS图像传感器可靠性:背照式(BSI)败给前照式(FSI)的原因探究
2020-07-04 07:52:56 来源:麦姆斯咨询 评论:0 点击:
据麦姆斯咨询报道,CMOS图像传感器技术演进路线从前照式(FSI)、背照式(BSI)到堆栈式,背照式技术正逐渐成为中高端CMOS图像传感器主流技术。
背照式CMOS图像传感器是把光电二极管放到微透镜、彩色滤波片下面,而原先的金属布线层则放到了光电二极管之后。相比前照式CMOS图像传感器,这种结构不仅增加了单位像素获得的光量,还有效抑制了光线入射角变化引起的感光度下降。但是,背照式CMOS图像传感器的制造工艺涉及晶圆的正面和背面,比前照式CMOS图像传感器复杂,带来的可靠性退化问题一直无法完全避免。
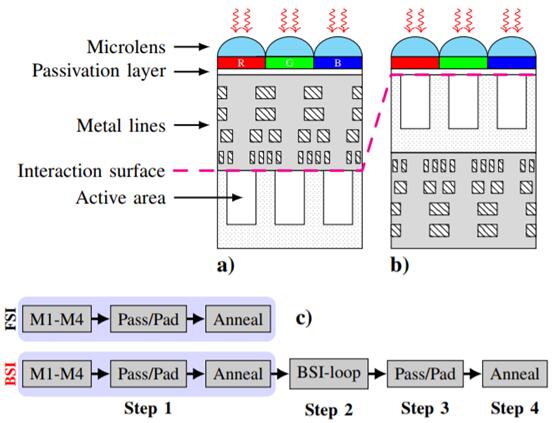
图(a)和图(b):分别为前照式CMOS图像传感器和背照式CMOS图像传感器结构;图(c):前照式和背照式CMOS图像传感器制造工艺流程对比
近期,意大利晶圆代工厂LFoundry和意大利罗马大学(Sapienza University of Rome)在IEEE Journal of the Electron Devices Society期刊上发表一篇论文《背照式CMOS图像传感器性能和可靠性退化》(Performance and reliability degradation of CMOS Image Sensors in Back-Side Illuminated configuration)指出,在特定的失效模式下,前照式CMOS图像传感器的寿命是背照式CMOS图像传感器的150~1000倍。当然,可能还有许多其它失效因素掩盖了这一巨大差异。
文中介绍了背照式CMOS图像传感器晶圆级可靠性专用测试结构(设计在管芯划片槽内)的系统特性。在工艺流程的不同步骤进行噪声和电学测量,结果明确表明背照式CMOS图像传感器制造工艺的晶圆倒装、键合、减薄和通孔(VIA)开孔等步骤会导致类似氧化物供体的边界陷阱的形成。相对于传统的前照式CMOS图像传感器,这些陷阱的存在会导致晶体管电性能下降,改变氧化层电场和平带电压,对可靠性产生严重影响。TDDB(时间相关介质击穿)和NBTI(负压偏置下的温度不稳定性)测量结果证明了边界陷阱对寿命的影响。
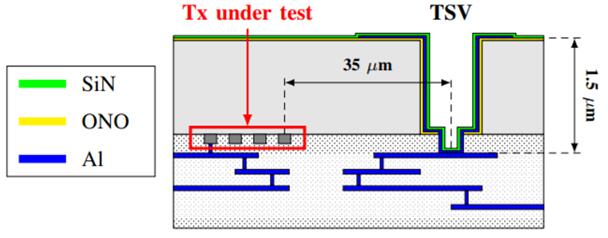
在背照式CMOS图像传感器划片槽内设计的晶体管(Tx)位置示意图
TDDB测试温度为125℃,在N沟道晶体管栅极施加+7V ~ +7.6V的应力电压Vstress。在每个Vstress条件下均测试了多个样本,依据标准JEDEC JESD92定义的三个标准测得时变击穿(the time-to-breakdown)数值。对于每种应力条件,时变击穿数值的韦伯分布给出了相应的失效时间(TTF),失效时间与应力电压分布采用对数-对数标度,在栅极工作电压下的寿命用幂律模型(E模型)推断。
NBTI测量温度为125℃,在P沟道晶体管栅极施加的Vstress为-3V ~ -4V,并测试了几个晶体管。依据标准JEDEC JESD90,寿命定义为使额定阈值电压VT改变10%所需的应力时间。VT变化值与应力时间的关系遵循幂律模型,可以推断出栅极工作电压下的寿命。

噪声和电荷泵浦测量结果表明,在背照式CMOS图像传感器栅极氧化层中存在类似供体的边界陷阱,不会出现在前照式传感器中。陷阱密度随着与界面的距离呈指数变化,当距离为1.8 nm时陷阱密度达2 x 10¹⁷ cm⁻³。通过在不同制造工艺步骤进行电学参数测量,可以发现,边界陷阱产生于晶圆背面工艺中,包括晶圆倒装、键合、减薄和通孔(VIA)开孔。

图a):在背照式CMOS图像传感器工艺流程不同站点测量的ID-VG曲线,背面工艺后(红色曲线)和背面工艺前(黑色曲线);图b):用TCAD软件模拟氧化层中分布有正电荷时的ID-VG曲线(红色)和无正电荷时的ID-VG曲线(黑色)。

图a):在背照式CMOS图像传感器工艺流程不同站点测量的IG-VG曲线,背面工艺后(红色曲线)和背面工艺前(黑色曲线);图b):在VG为+ 1V时,电荷质心位于距离硅/二氧化硅界面1.7 nm处的栅极能带图(红线),无电荷时的栅极能带图(黑色)。
陷阱会改变背照式CMOS图像传感器的氧化层电场和平带电压,这个效果与在距离界面1.7 nm处施加了1.6 x 10⁻⁸ C/cm²的正电荷一样,从而改变了漏极和栅极电流曲线。
作者在论文中提到,类似供体的边界陷阱也会影响背照式CMOS图像传感器的长期性能。TDDB和NBTI是对器件寿命的评估方式。与预期相同,边界陷阱对两种评估方式的作用不同,但是无论如何,相对前照式CMOS图像传感器,背照式CMOS图像传感器可靠性都会下降。
论文链接:https://ieeexplore.ieee.org/document/9060926
