《MEMS封装和测试培训课程》课前预习:器件级封装技术
2017-06-16 09:21:00 来源:麦姆斯咨询 评论:0 点击:
器件级封装技术介绍
器件级封装也称单芯片封装(Single Chip Package),是对单个的电路或元器件芯片进行封装,以提供芯片必要的电气连接、机械支撑、热管理、隔离有害环境、以及后续的应用接口。对两个或两个以上的芯片进行封装称为多芯片封装(Multi-chip Package),或多芯片模组(Multi-chip Module)。
器件级封装是MEMS封装技术中非常重要的环节,其种类繁多,基本功能包括以下几个方面:
1. 可靠的电信号输入/输出传输,稳定的供电保障;
2. 满足模组构建和系统封装时对器件的要求,在二级封装后发挥有效的信号传输和供电保障作用;
3. 通过插装、SMT等互连方案,使器件在下一级封装时被实装到基板上能正常工作;
4. 提供有效的机械支撑和隔离保护,防止外界环境对器件可靠性的影响;
5. 提供物理空间的过渡,使芯片可以应用到各种不同尺度的基板上;
6. 满足器件的散热要求。
器件级封装的主流技术有引线键合、金属封装、塑料封装和陶瓷封装。下面对这四种封装技术进行介绍。
引线键合
目前广泛使用的互连技术有引线键合(Wire Bonding,WB)、载带自动焊技术(Tape Automated Bonding,TAB)和倒装焊技术(Flip Chip Bonding,FCB)。引线键合技术,又称作线焊技术和引线连接,其技术成熟、工艺简单、成本低廉,因此是目前大部分MEMS器件采用的封装方式。
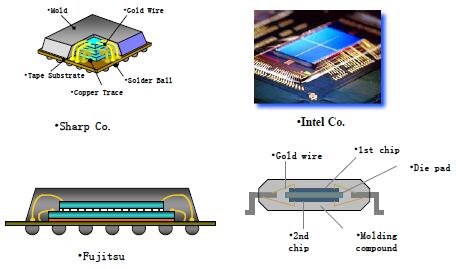
引线键合器件示意图
按键合工艺特点分为超声键合、热压键合和热超声键合,适合不同的引线材料。如金丝主要应用于热压键合和热超声键合,铝丝和铝合金丝适合超声键合。
工艺控制的关键点有温度控制、精确定位控制和工作参数设定等。温度过高,会产生过多的氧化物,影响键合质量;温度过低将无法去除金属表面氧化膜,无法促进金属原子间的接触。精确定位控制一般通过精密导轨控制、精密模具控制及精密光电控制相结合的方式实现。工作参数设定包括电子打火的电压、电流、频率、振幅、键合压力、时间等参数来保证焊接点的精度、焊接质量和器件可靠性。
塑料封装
塑料封装一般指传递模注封装,是一种非气密性封装。主要工艺流程包括硅片减薄、切片、芯片贴装、引线键合、转移成型、后固化、去飞边毛刺、上焊锡、切筋打弯、打码等多道工序。按封装工序也可以分为前后道工序,即用塑封料塑封前的工艺步骤称为装配或前段工艺,其后的工艺步骤称为后段工艺。
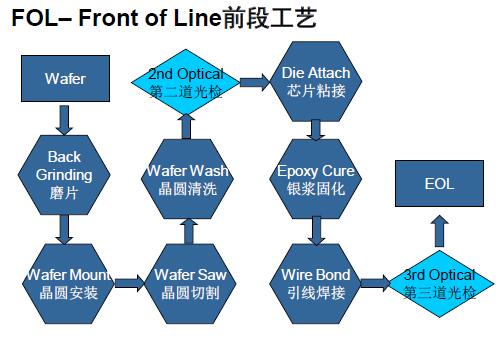
塑料封装的前段工艺流程示意图
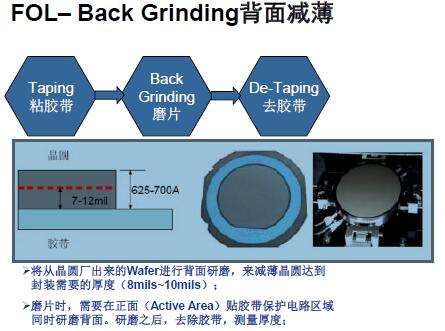
塑料封装的后段工艺流程示意图
塑料封装材料是以环氧树脂为基础成分,添加了各种添加剂的混合物。常见的塑封材料分为四种类型:环氧类、氰酸酯类、聚硅酮类和氨基甲酸乙酯类。
作为一种非气密封装,塑料封装最主要的缺点就是对潮气比较敏感,因此对芯片工艺设计有一定的要求,如改进芯片钝化层,提高工艺质量,优化封装工艺等来加以解决,但难以根除。因此不适用于对气密性要求高的器件。
陶瓷封装
封装体所使用的主体材料为陶瓷的封装技术称为陶瓷封装。虽然塑料封装方式在尺寸、质量、成本和实用性等方面都优于陶瓷封装,但陶瓷封装最大的优势——气密性,带来的优良的防潮防湿性能和高可靠性,恰恰是塑料封装的“软肋”。除此以外,陶瓷封装还具有高频绝缘性能良好,在电、热、机械方面极其稳定的特点。
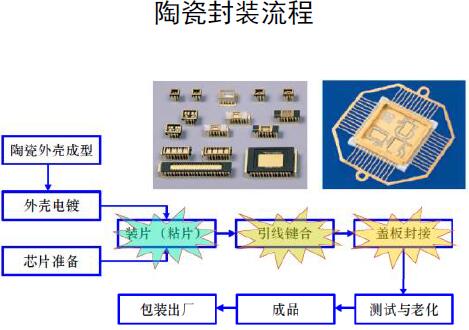
陶瓷封装流程
金属封装
金属封装是采用金属作为壳底,芯片直接或通过基板安装在外壳或底座上的一种封装形式。其具有良好的散热能力和电磁场屏蔽,用于高可靠性要求和定制的专用性气密封装,适用于射频、微波、光电、SAW等MEMS器件。
金属封装的工艺流程包括金属封装盖板制作、金属封装壳体制作、金属引腿制作、玻璃绝缘子制作、封装模具制作、绝缘子/引腿组装、组装到壳体上、高温烧结、芯片减薄/划片、粘片/键合、封盖。封盖工艺是金属封装比较特殊的一道工艺,需要注意的是封装盖板和壳体的封接面上不可以出现任何空隙或者没有精准对准。为了减少水汽等有害成分,封盖工艺一般在氮气等干燥保护气氛下进行。
如果你要获取更多器件级封装和测试方面的详细知识,可报名参加由麦姆斯咨询主办的『《MEMS封装和测试培训课程》2017年第二期』。培训内容还涉及气体传感器、SAW滤波器的封装知识,MEMS器件封装,系统级封装(SiP)在MEMS领域中的应用,MEMS晶圆级封装,真空封装技术在MEMS封装中的应用等知识。
『《MEMS封装和测试培训课程》2017年第二期』
时间:2017年6月30日~7月2日
地点:无锡
报名方式:请邮件至:GuoLei@MEMSConsulting.com,电话:13914101112
延伸阅读:
相关热词搜索:器件级封装
